Поиск по сайту Новости Галогенным лампам снова нашли замену | ГЛАВНАЯ » ТРАНЗИСТОРЫ » КП350 Транзистор КП350 — полевой, с двумя изолированными затворами и каналом n-типа, диффузионно-планарный, кремниевый. Применяется в генераторах, усилителях и преобразователях сверхвысокой частоты (до 700 МГц). Корпус металлостеклянный, выводы гибкие. На корпусе наносится тип транзистора. Дополнительно КП350А, КП350Б и КП350В маркируются двумя чёрными точками на торце корпуса. Весит не более 0.7 г. КП350 цоколевкаЦоколевка КП350 показана на рисунке. Электрические параметры транзистора КП350
Предельные эксплуатационные характеристики транзисторов КП350
| |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Транзисторы КТ350, КТ351, КТ352 — DataSheet
Перейти к содержимому
Цоколевка транзисторов КТ350, КТ351, КТ352
| Параметр | Обозначение | Маркировка | Условия | Значение | Ед. изм. |
| Аналог | КТ350А | MPS6563, 2N2279 *1, 2N5221 *2, 2N995 *3 | |||
| КТ351А | ВС216, BFX12 *3, CD9011D *2 | ||||
| КТ351Б | ВС192, MPSH81, РМВТН81 *2, 2N3576 *3, BFX13 *3, 2SB542 *2 | ||||
| КТ352А | ВС355А, 2N869 | ||||
| КТ352Б | ВС355 | ||||
| Структура | — | p-n-p | |||
| Максимально допустимая постоянная рассеиваемая мощность коллектора | PK max,P*K, τ max,P**K, и max | КТ350А | 30 °C | 300 | мВт |
| КТ351А | 30 °C | 300 | |||
| КТ351Б | 30 °C | 300 | |||
| КТ352А | 30 °C | 300 | |||
| КТ352Б | 30 °C | 300 | |||
| Граничная частота коэффициента передачи тока транзистора для схемы с общим эмиттером | fгр, f*h31б, f**h31э, f***max | КТ350А | — | ≥100 | МГц |
| КТ351А | — | ≥200 | |||
| КТ351Б | — | ≥200 | |||
| КТ352А | — | ≥200 | |||
| КТ352Б | — | ≥200 | |||
| Пробивное напряжение коллектор-база при заданном обратном токе коллектора и разомкнутой цепи эмиттера | UКБО проб. , U*КЭR проб., U**КЭО проб. , U*КЭR проб., U**КЭО проб. | КТ350А | — | 20 | В |
| КТ351А | 10к | 15* | |||
| КТ351Б | 10к | 15* | |||
| КТ352А | — | 20 | |||
| КТ352Б | — | 20 | |||
| Пробивное напряжение эмиттер-база при заданном обратном токе эмиттера и разомкнутой цепи коллектора | UЭБО проб., | КТ350А | — | 5 | В |
| КТ351А | — | 5 | |||
| КТ351Б | — | 5 | |||
| КТ352А | — | 5 | |||
| КТ352Б | — | 5 | |||
| Максимально допустимый постоянный ток коллектора | IK max, I*К , и max | КТ350А | — | 600* | мА |
| КТ351А | — | 400* | |||
| КТ351Б | — | 400* | |||
| КТ352А | — | 200* | |||
| КТ352Б | — | 200* | |||
| Обратный ток коллектора — ток через коллекторный переход при заданном обратном напряжении коллектор-база и разомкнутом выводе эмиттера | IКБО, I*КЭR, I**КЭO | КТ350А | 10 В | ≤1 | мкА |
| КТ351А | 10 В | ≤1 | |||
| КТ351Б | 10 В | ≤1 | |||
| КТ352А | 10 В | ≤1 | |||
| КТ352Б | 10 В | ≤1 | |||
| Статический коэффициент передачи тока транзистора в режиме малого сигнала для схем с общим эмиттером | h21э, h*21Э | КТ350А | 1 В; 0. 5 А 5 А | 20…200* | |
| КТ351А | 1 В; 0.5 А | 20…80* | |||
| КТ351Б | 1 В; 0.3 А | 50…200* | |||
| КТ352А | 1 В; 0.2 А | 25…125* | |||
| КТ352Б | 1 В; 0.2 А | 70…300* | |||
| Емкость коллекторного перехода | cк, с*12э | КТ350А | 5 В | ≤70 | пФ |
| КТ351А | 5 В | ≤20 | |||
| КТ351Б | 5 В | ≤20 | |||
| КТ352А | 5 В | ≤15 | |||
| КТ352Б | 5 В | ≤15 | |||
| Сопротивление насыщения между коллектором и эмиттером | rКЭ нас, r*БЭ нас, К**у. р. р. | КТ350А | — | ≤2 | Ом, дБ |
| КТ351А | — | ≤1.5 | |||
| КТ351Б | — | ≤2.25 | |||
| КТ352А | — | ≤3 | |||
| КТ352Б | — | ≤3 | |||
| Коэффициент шума транзистора | Кш, r*b, P**вых | КТ350А | — | — | Дб, Ом, Вт |
| КТ351А | — | — | |||
| КТ351Б | — | — | |||
| КТ352А | — | — | |||
| КТ352Б | — | — | |||
| Постоянная времени цепи обратной связи на высокой частоте | τк, t*рас, t**выкл, t***пк(нс) | КТ350А | — | — | пс |
| КТ351А | — | — | |||
| КТ351Б | — | — | |||
| КТ352А | — | — | |||
| КТ352Б | — | ≤150* |
Описание значений со звездочками(*,**,***) смотрите в таблице параметров биполярных транзисторов.
*1 — аналог по электрическим параметрам, тип корпуса отличается.
*2 — функциональная замена, тип корпуса аналогичен.
*3 — функциональная замена, тип корпуса отличается.
Если вы нашли ошибку, пожалуйста, выделите фрагмент текста и нажмите Ctrl+Enter.
Транзистор КТ827 характеристики (datasheet)
Кремниевый составной транзистор КТ827 (n-p-n)
Составной транзистор КТ827 аналог, графики входных и выходных характеристик. Подробные параметры, размеры и цоколевка транзисторов КТ827А, КТ827Б, КТ827В.
Цоколевка и размеры корпуса
Технические характеристики
Основные технические характеристики транзисторов КТ827:
| Прибор | Предельные параметры | Параметры при T = 25°C | RТ п-к, °C/Вт | ||||||||||||||||||
| при T = 25°C | |||||||||||||||||||||
| IК, max, А | IК и, max, А | UКЭ0 гр, В | UКБ0 max, В | UЭБ0 max, В | PК max, Вт | TК, °C | Tп max, °C | TК max, °C | h21Э | UКЭ, В | IК, А | UКЭ нас, В | IКЭR, мА | fгр, МГц | Кш, дБ | CК, пФ | CЭ, пФ | tвкл, мкс | tвыкл, мкс | ||
| КТ827А | 20 | 40 | 100 | 100 | 5 | 125 | 25 | 200 | 100 | 750. ..18000 ..18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4…10,9 | |
| КТ827Б | 20 | 40 | 80 | 80 | 5 | 125 | 25 | 200 | 100 | 750…18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4…10,9 | |
| КТ827В | 20 | 40 | 60 | 60 | 5 | 125 | 25 | 200 | 100 | 750…18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4…10,9 | |
| 2Т827А | 20 | 40 | 100 | 100 | 5 | 125 | 25 | 200 | 125 | 750. ..18000 ..18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4…10,9 | |
| 2Т827А2 | 20 | 40 | 100 | 100 | 5 | 125 | 25 | 200 | 125 | 750…18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4…19,4 | |
| 2Т827А5 | 20 | 40 | 100 | 100 | 5 | 125 | 25 | 200 | 125 | 750…18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4… 19,4 19,4 | |
| 2Т827Б | 20 | 40 | 80 | 80 | 5 | 125 | 25 | 200 | 125 | 750…18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4…10,9 | |
| 2Т827Б2 | 20 | 40 | 80 | 80 | 5 | 125 | 25 | 200 | 125 | 750…18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4…19,4 | |
| 2Т872В | 20 | 40 | 60 | 60 | 5 | 125 | 25 | 200 | 125 | 750. ..18000 ..18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4…10,9 | |
| 2Т872В2 | 20 | 40 | 60 | 60 | 5 | 125 | 25 | 200 | 125 | 750…18000 | 3 | 10 | 2 | 3 | 4 | 400 | 350 | 1 | 6 | 1,4…19,4 | |
Аналоги и замена
Зарубежные аналоги транзистора КТ827: 2N6057, BDX87.
Список возможных замен на зарубежные транзисторы:
| КТ827А | КТ827Б | КТ827В |
| BDX65A BDX67 BDX87C MJ3521 MJ4035 | 2N6058 2N6283 BDX63 BDX65 BDX67 BDX85B BDX87B MJ3001 MJ4034 | 2N6057 2N6282 BDX85 BDX85A BDX87 BDX87A MJ3000 MJ3520 MJ4033 |
Эквивалентная схема составного транзистора КТ827:
Поведение высоковольтных MOSFET транзисторов в преобразователях с мягким переключением: анализ и повышение надежности
В данной статье анализируется поведение MOSFET-транзистора при высоком напряжении питания в мощном конверторе с преобразованием при нулевом напряжении, и выдвигается оригинальная теория причины пробоя MOSFET-транзистора. Здесь также предложены новые технические решения по повышению устойчивости транзистора и, следовательно, надежности всего оборудования.
Здесь также предложены новые технические решения по повышению устойчивости транзистора и, следовательно, надежности всего оборудования.
Преимущества схем конверторов с мягким переключением и, в частности, с переключением при нулевом напряжении (ПНН, также называемое переходом при нуле напряжения или резонансным переходом), известны большинству специалистов. Высокочастотные конверторы, запитываемые от источника высоковольтного напряжения, демонстрируют значительно улучшенные характеристики при использовании топологии с мягким переключением. К данным улучшениям можно отнести:
- уменьшенные потери на переключение, которые позволяют повысить частоту преобразования и устанавливать реактивные компоненты меньших размеров;
- уменьшенные электромагнитные и радиопомехи;
- отсутствие потребности в сложных и дорогостоящих снабберных схемах;
- использование паразитных элементов схемы для организации резонансного перехода.
Благодаря перечисленным преимуществам топологию с переключением при нулевом напряжении в настоящее время широко используют в силовой электронике и особенно в телекоммуникационных системах электропитания.
MOSFET-транзистор наиболее часто используется в качестве управляемого транзисторного ключа в мостовом преобразователе с переключением при нулевом напряжении. MOSFET-транзистор способен работать на высоких частотах переключения, и его внутренний паразитный диод экономит дополнительный внешний компонент, который необходим в преобразователе для фиксирования напряжения переключения на уровне напряжения источника питания. И внутренний паразитный диод и выходная емкость транзистора являются существенными компонентами для организации резонансного перехода.
Хотя в мостовом преобразователе с переключением при нулевом напряжении MOSFET-транзистор устойчиво работает внутри своей области безопасной работы, и его внутренний паразитный диод никогда не подвергается жесткому выключению, на практике случаются некоторые «необъяснимые» отказы из-за неизбежного использования внутреннего паразитного диода.
В данной статье анализируется поведение MOSFET-транзистора при высоком напряжении питания в мощном конверторе с преобразованием при нулевом напряжении, и выдвигается оригинальная теория причины пробоя MOSFET-транзистора.
Предложены новые технические решения по повышению устойчивости транзистора и, следовательно, надежности всего оборудования. Эффективность этих решений подтверждена работой телекоммуникационного источника электропитания мощностью 6000 Вт и выходного тока 100 А.
Введение
Выпрямитель с выходными параметрами 60 В, 100 А для применения в телекоммуникационных устройствах был разработан с использованием силовых MOSFET-транзисторов на 1000 В в узле DC/DC-конвертора с ПНН. Первоначально использовались компоненты со стандартным восстановлением, поскольку считалось, что внутренние паразитные диоды никогда не подвергаются жесткому выключению, то есть к диодам никогда не прикладывается обратное напряжение, пока по ним протекает прямой ток.
На этапе серийного производства мы фиксировали множество отказов MOSFET-транзисторов в преобразователе с ПНН. Последующее исследование определенно доказало, что транзистор надежно работал в пределах своей области безопасной работы (SOA). Фактически, мы могли продемонстрировать, что при всех возможных нормальных и критических условиях все статические и переходные электрические параметры MOSFET-транзистора оставались в пределах максимально допустимых значений.
Фактически, мы могли продемонстрировать, что при всех возможных нормальных и критических условиях все статические и переходные электрические параметры MOSFET-транзистора оставались в пределах максимально допустимых значений.
В результате анализа отказов, выполненного на статистически значимом количестве компонентов, была получена следующая информация:
- Наименьшее значение времени обратного восстановления внутреннего паразитного диода уменьшало число отказов. Обратите внимание на то, что мы могли контролировать, устанавливая схему обнаружения и регистрации во всех источниках питания, что внутренний диод MOSFET-транзистора работал без жесткого выключения.
- Все отказы случались, когда выходная нагрузка снижалась до уровня менее 25% от ее максимальной величины, несмотря на тот факт, что в этом случае MOSFET-транзисторы менее нагружены (то есть работают с более низким значением тока, мощности рассеяния, dv/dt, перенапряжения и т. д.), чем в том случае, когда нагрузка увеличена.

- Оборудование, которое работало ниже критического значения недонагруженности в течение достаточно длительного промежутка времени, продолжало и дальше работать, практически без отказов MOSFET-транзисторов.
- Обычно, если в оборудовании происходил отказ MOSFET-транзистора, то после замены неисправного компонента оно работало без аналогичного отказа.
В данной статье делается попытка дать объяснение вышеупомянутой информации, а также предлагаются способы устранения отказов MOSFET-транзистора.
Основные режимы работы мостового преобразователя с использованием фазосдвигающей ШИМ с переключением при нулевом напряжении
Типовая схема (рис. 1) [1–4, 7] включает 4 транзисторных ключа S1–S4, каждый из которых зашунтирован антипараллельным диодом и выходной емкостью. Дополнительная индуктивность и два небольших фиксирующих диода [1] задействованы в первичной обмотке трансформатора для поддержания режима мягкого переключения при уменьшенной нагрузке и ограничения перенапряжения на выходных выпрямительных диодах.
Рис. 1. Мостовой преобразователь с переключением при нулевом напряжении
Преобразователь работает с фиксированной частотой переключения 50 кГц и с регулируемым напряжением питания 800 В. Выходной выпрямитель представляет собой удвоитель тока. Эффективное значение коэффициента заполнения (установленного для напряжения на входе трансформатора) определяется периодом между коммутациями двух плеч моста. В данном преобразователе вместо модуляции фактической ширины импульса драйверов затворов мы поддерживаем коэффициенты заполнения затвора (и транзисторного ключа соответственно) на фиксированном уровне 50% и изменяем момент переключения плеча S3–S4.
Транзисторные ключи в преобразователе работают с отсутствием потерь при включении и с уменьшенными потерями при выключении. Из-за индуктивной нагрузки плеча моста и тока, текущего в нагрузке, будет естественная замена тока транзисторного ключа током антипараллельного диода другого транзисторного ключа в том же самом плече, которая приведет к фактически нулевому напряжению на транзисторном ключе к моменту включения. Это, в свою очередь, исключает потери мощности, вызванные, вопервых, одновременным наличием тока и напряжения в транзисторном ключе при каждом переключении и, во-вторых, разрядом выходной емкости транзисторного ключа. Выходная емкость работает как емкостной снаббер, уменьшая потери на выключение, вызванные конечным временем выключения транзисторного ключа. Паразитные элементы схемы (выходная емкость, индуктивность намагничивания и рассеяния, антипараллельный диод) преимущественно используются для содействия резонансному переключению с низкими потерями.
Это, в свою очередь, исключает потери мощности, вызванные, вопервых, одновременным наличием тока и напряжения в транзисторном ключе при каждом переключении и, во-вторых, разрядом выходной емкости транзисторного ключа. Выходная емкость работает как емкостной снаббер, уменьшая потери на выключение, вызванные конечным временем выключения транзисторного ключа. Паразитные элементы схемы (выходная емкость, индуктивность намагничивания и рассеяния, антипараллельный диод) преимущественно используются для содействия резонансному переключению с низкими потерями.
Транзисторные ключи в данном преобразователе используются иначе, чем в стандартном преобразователе с жестким переключением, так как внутренний антипараллельный диод MOSFET-транзистора и выходная емкость становятся существенными компонентами в резонансном переходе. Временная диаграмма (рис. 2) демонстрирует работу преобразователя.
Рис. 2. Временная диаграмма работы мостового преобразователя с переключением при нулевом напряжении
Полный цикл переключения состоит из семи стадий.
Стадия 1. Передача мощности
Диагональные транзисторные ключи S1 и S4 находятся в открытом состоянии. VA = 800 В, так как ключ S1 открыт; VB = 0 В, поскольку ключ S4 тоже открыт; VP равно полному напряжению питания 800 В. На этой стадии первичный ток трансформатора IP увеличивается из-за вклада тока намагничивания и особенно из-за тока в выходных катушках индуктивности. Антипараллельные диоды транзисторных ключей не участвуют в работе схемы и ток не проводят. Мощность передается с входа на выход. Эта часть цикла характеризуется открытым состоянием схемы.
Стадия 2. Резонансный переход: от передачи мощности к свободной циркуляции тока
В конце стадии передачи мощности транзисторный ключ S4 переходит в выключенное состояние. Так как ток катушки индуктивности не может резко меняться, он продолжает течь, перезаряжая выходные емкости транзисторных ключей S3, S4 и, таким образом, уровень напряжения в точке VB поднимается до значения напряжения источника питания 800 В.
Стадия 3. Свободная циркуляция тока (антипараллельный диод)
Когда напряжение в точке VB достигает напряжения источника питания, антипараллельный диод транзисторного ключа S3 начинает проводить ток, фиксируя напряжение VB на уровне 800 В. Полный ток первичной обмотки IP теперь течет через антипараллельный диод.
Стадия 4. Свободная циркуляция тока (антипараллельный диод + переход «сток–исток» транзистора)
Через несколько сотен наносекунд после того, как антипараллельный диод транзистора S3 начал проводить ток, включается транзистор S3 с целью снижения потерь проводимости за счет совмещения открытого перехода «сток–исток» MOSFET-транзистора с открытым состоянием антипараллельного диода. Обратите внимание, что включение транзистора S3 имеет место при нулевом напряжении «сток–исток» транзистора, поэтому включение транзистора происходит без потерь.
Часть (отрицательного) первичного тока IP теперь течет через переход «сток–исток» транзистора S3; остающийся ток течет в антипараллельном диоде. Весь ток транзистора S1 положителен и течет в переходе «сток–исток» транзистора. VA = 800 В, так как транзистор S1 открыт; VB = 800 В, так как транзистор S3 тоже открыт, и VP = 0 В.
Весь ток транзистора S1 положителен и течет в переходе «сток–исток» транзистора. VA = 800 В, так как транзистор S1 открыт; VB = 800 В, так как транзистор S3 тоже открыт, и VP = 0 В.
Рассмотренная часть цикла характеризуется свободной циркуляцией тока. Это позволяет фиксировать частоту преобразования; фактически, данная ситуация сохраняется до начала включения другой диагонали (прохождение тока через транзисторы S2 и S3). Эта часть цикла обычно длится несколько микросекунд.
Стадия 5. Резонансный переход: от свободной циркуляции тока к передаче мощности
Транзисторный ключ S1 выключен, и ток в нем отклонен от перехода «сток–исток» транзистора к выходной емкости. Если ток перехода «сток–исток» транзистора спадает к нулю прежде, чем существенно повысилось напряжение VDS, мы получаем выключение без потерь. Ток теперь перезаряжает выходные емкости S1 и S2, устанавливая напряжение VA от 800 к 0 В.
Стадия 6. Резонансный переход: от свободной циркуляции тока к передаче мощности (антипараллельный диод)
Резонансный переход: от свободной циркуляции тока к передаче мощности (антипараллельный диод)
Когда точка VA достигает нулевого напряжения, антипараллельный диод S2 начинает проводить ток, фиксируя напряжение в точке VA на нулевом уровне. Весь первичный ток IP теперь течет в антипараллельном диоде транзистора S2, а также в антипараллельном диоде и переходе «сток–исток» транзистора S3. Напряжение в точке VA = 0 В, так как S2 открыт; напряжение в точке VB = 800 В, поскольку S3 открыт, и VP = –800 В. Ток IP быстро уменьшается, так как токи в трансформаторе и во внешних катушках индуктивности теперь текут в разных направлениях.
Стадия 7. Передача мощности
Стадия 6 длится несколько сотен наносекунд, пока не откроется транзистор S2. Далее он опять включается без потерь при отсутствии напряжения на переходе «сток–исток». Ток через антипараллельные диоды транзисторов S2 и S3 быстро спадает к нулю, потому что переход «сток–исток» транзистора MOSFET отводит от них часть тока, в основном потому, что полярность напряжения на первичной обмотке трансформатора меняет направление тока IP на противоположное.
К моменту завершения процесса накопления заряда в катушках индуктивности мощность передана на выход, и преобразователь находится в состоянии, подобном стадии 1. Согласно параметрам нашей схемы, цикл длится приблизительно 7 мкс. Теперь преобразователь готов повторить следующий цикл, сходный с вышеупомянутым, на сей раз с диагональной парой S2–S3.
Как мы можем видеть, транзистор MOSFET всегда выключается только после того, как ток в его антипараллельном диоде полностью изменил направление и в течение нескольких микросекунд протекал непосредственно в переходе «сток–исток» транзистора MOSFET; следовательно, после того, как антипараллельный диод прекращает проводить ток, он несколько микросекунд подвергается воздействию высокого значения dv/dt.
Описание антипараллельного диода
Все мощные MOSFET-транзисторы имеют паразитный биполярный транзистор в своей структуре. Вертикальная ДМОП-структура, как показано на рис. 3, имеет переход «база–эмиттер» биполярного транзистора, закороченный металлизацией истока, и формирует таким образом «антипараллельный диод».
Рис. 3. Вертикальное поперечное сечение ДМОП-структуры
Если этот паразитный биполярный транзистор становится активным, может произойти классический случай вторичного пробоя с перераспределением тока. Этот механизм достаточно хорошо описан в литературе, а также в статьях по применению MOSFET-транзистора [5, 6].
Захват тока приводит к локальному нагреву, увеличивая тем самым усиление биполярного транзистора, от этого сокращается значение тока, и, в конечном счете, транзистор отказывает. При прямом смещении антипараллельного диода неосновные носители, остающиеся в области базы в течение времени восстановления диода, могут вызвать разрушение транзистора.
Теория механизма разрушения
Согласно общим представлениям о топологии переключения при нулевом напряжении (ПНН), где MOSFET-транзистор находится в открытом состоянии, в то время как внутренний паразитный диод проводит ток, этот диод не будет подвержен вторичному пробою, поскольку ток полностью протекает в обратном направлении в течение достаточно продолжительного для восстановления диода промежутка времени.
В действительности заряд останется запасенным во внутреннем паразитном диоде на более длительное время, чем величина времени обратного восстановления, указанная в документации, либо до тех пор, пока не будет приложено высокое напряжение, которое приведет к рассасыванию неосновных носителей в переходе. Поэтому, когда к внутреннему паразитному диоду прикладывается высокое обратное напряжение, все еще есть вероятность вторичного пробоя (даже по прошествии относительно большого промежутка времени).
В типичной топологии ПНН прямой ток через внутренний паразитный диод фиксирует выходное напряжение к положительной или к отрицательной шине. Этот прямой ток приводит к генерации неосновных носителей и в слое p-типа, и в эпитаксиальных n-слоях (рис. 4).
Рис. 4. Протекание прямого тока во внутреннем паразитном диоде
Затем переход MOSFET-транзистора открывается и отбирает часть тока, протекающего через канал внутреннего паразитного диода. Переход «сток–исток» MOSFET-транзистора может проводить ток в обоих направлениях. Отклонение тока от внутреннего паразитного диода уменьшит генерацию неосновных носителей, но не остановит ее (рис. 5).
Отклонение тока от внутреннего паразитного диода уменьшит генерацию неосновных носителей, но не остановит ее (рис. 5).
Рис. 5. Протекание прямого тока во внутреннем паразитном диоде и переходе MOSFET;транзистора
Затем внешняя схема полностью изменяет направление тока через транзистор. Это приводит к появлению небольшого обратного тока во внутреннем паразитном диоде. Обратный ток невелик из-за незначительного электрического поля, созданного низким напряжением, произведенным текущим током в переходе с низким сопротивлением. В результате некоторые неосновные носители будут охвачены полем и удалены из перехода (рис. 6).
Рис. 6. Обратное протекание тока во внутреннем паразитном диоде и переходе транзистора
После короткого промежутка времени достаточное количество носителей будет удалено, что позволит переходу поддерживать небольшое значение напряжения. В это время большая часть тока отведена в резистивный канал и развивает положительное напряжение через RDS(on), что, в свою очередь, слегка смещает диодный переход в обратном направлении. Некоторые носители будут продолжать устраняться в результате нормального процесса рекомбинации, а некоторые — в результате принудительного процесса, который зависит от напряжения, приложенного к диоду (рис. 7).
Некоторые носители будут продолжать устраняться в результате нормального процесса рекомбинации, а некоторые — в результате принудительного процесса, который зависит от напряжения, приложенного к диоду (рис. 7).
Рис. 7. Обратное протекание тока только в переходе транзистора
Величина этого напряжения зависит от тока первичной обмотки и, следовательно, от выходной нагрузки. Если это напряжение маленькое, большое количество неосновных носителей остается в переходе в течение значительного времени. Когда переход будет в закрытом состоянии, MOSFET-транзистор начнет поддерживать напряжение, создающее более высокое обратное напряжение на внутреннем паразитном диоде. Приложенное высокое обратное напряжение на внутреннем паразитном диоде охватит остающиеся в переходе носители (рис. 8). Если обратный ток приблизится к величине, достаточной для активизации паразитного биполярного транзистора, может произойти вторичный пробой, разрушающий MOSFET-транзистор.
Рис. 8. Обратное протекание тока только во внутреннем паразитном диоде
При маленькой нагрузке (то есть при низком значении тока в MOSFET-транзисторе) низкого положительного падения напряжения на сопротивлении канала недостаточно, чтобы провести полную рекомбинацию неосновных зарядов к моменту окончания времени открытого состояния транзистора. Это особенно справедливо в случае большой величины времени обратного восстановления внутреннего паразитного диода.
Это особенно справедливо в случае большой величины времени обратного восстановления внутреннего паразитного диода.
С другой стороны, при большой нагрузке (то есть при большом значении тока в MOSFET-транзисторе) увеличенного падения напряжения на сопротивлении канала может оказаться достаточно, чтобы провести полную рекомбинацию неосновных зарядов к моменту окончания времени открытого состояния транзистора. Это обеспечит безопасное закрытие транзистора.
Допустим, что совокупность MOSFET-транзисторов обладает статистическим распределением (нормальным, например) относительно времени рекомбинации, его зависимости от обратного напряжения, приложенного к диоду, усиления паразитного n-p-n-транзистора, его устойчивости к скорости нарастания dv/dt и т. д. В результате, при тех же самых рабочих режимах только определенная часть из всех рассматриваемых компонентов может представлять интерес для рассматриваемой нами проблемы. Эти склонные к разрушению MOSFET-транзисторы должны быть наиболее медленными из всех компонентов с перечисленными статистическими распределениями. Объясним, почему это так.
Объясним, почему это так.
- Чем короче время обратного восстановления внутреннего паразитного диода, тем более низкая интенсивность отказов: trr — хороший показатель времени рекомбинации неосновных зарядов, и этот параметр очень важен в нашей гипотезе. Следовательно, мы имеем следующую ситуацию (рис. 9):
<img src=»https://kit-e.ru/wp-content/uploads/136p9-3.png» alt=»Рис. 9. Распределение критичных MOSFET-транзисторов от trr» title=»» width=»303″ height=»189″>
Рис. 9. Распределение критичных MOSFET-транзисторов от trr
Конечно, как было сказано прежде, следует учитывать как можно большее количество параметров для определения устойчивости MOSFET-транзистора в ПНН-конверторах, но единственный доступный в документации и весьма просто измеряемый параметр — trr.
- Существуют ситуации, когда часть источников питания работает в течение долгого времени без проблем, а другая часть идентичных источников питания выходит из строя за короткое время при тех же самых рабочих режимах: могло сломаться только то оборудование, в котором использовался «слабый» транзистор (более медленный).

- Оборудование, исправно проработавшее продолжительное время (даже при работе на критически малую нагрузку), имеет хорошие шансы и дальше работать без проблем: после отказа части более слабых MOSFET-транзисторов оставшиеся являются более живучими.
- Как правило, оборудование с отказавшим MOSFET-транзистором после однократной замены отказавшего элемента далее работает без аналогичных отказов: поскольку «слабые» компоненты составляют незначительную часть от всей совокупности, со статистической точки зрения очень маловероятно восстановление оборудования с использованием другого «слабого» транзистора.
Результаты экспериментов с внутренним паразитным диодом
1. Оценка запасенного заряда, остающегося в переходе
Для оценки обсуждаемой теории была построена схема испытаний (см. упрощенный вариант схемы на рис. 10). Она работает по следующему принципу. Сначала мы пропускаем прямой ток во внутреннем паразитном диоде тестируемого устройства; затем останавливаем протекание тока без приложения обратного напряжения к переходу. Наконец, после заданного периода времени обратное напряжение прикладывается к переходу внутреннего паразитного диода, и измеряется остающийся заряд обратного восстановления. Канал тестируемого устройства может быть включен или выключен в любое время до или во время испытательного цикла для выяснения последствий от смещения на затворе.
Наконец, после заданного периода времени обратное напряжение прикладывается к переходу внутреннего паразитного диода, и измеряется остающийся заряд обратного восстановления. Канал тестируемого устройства может быть включен или выключен в любое время до или во время испытательного цикла для выяснения последствий от смещения на затворе.
Рис. 10. Упрощенная схема
Для определения величины заряда обратного восстановления проводилось предварительное испытание без подачи прямого тока через внутренний паразитный диод и с приложением обратного напряжения 800 В с dv/dt = 1,33 В/нс. Он определен как базовый уровень заряда, или количество заряда, в котором отсутствует заряд, запасенный в результате прохождения прямого тока.
Проводился ряд испытаний для определения требуемого времени для рекомбинации всего запасенного в переходе заряда после прекращения прохождения прямого тока. Канал оставался закрытым в течение этих испытаний. Эти испытания проводились при прямом токе 5 А в течение 10 мкс и обратном напряжении 800 В с dv/dt = 1,33 В/нс. Данное обратное напряжение вначале прикладывалось через 100 нс после того, как был выключен прямой ток. Далее испытание с включением обратного напряжения повторялось с увеличением интервала времени до тех пор, пока не был достигнут базовый уровень заряда обратного восстановления. Эти испытания проводились на APT10026JN — стандартном MOSFET-транзисторе и на APT10025JVFR — FREDFET-транзисторе (MOSFET-транзистор с быстровосстанавливающимся внутренним паразитным диодом). Результаты показаны на рис. 11.
Данное обратное напряжение вначале прикладывалось через 100 нс после того, как был выключен прямой ток. Далее испытание с включением обратного напряжения повторялось с увеличением интервала времени до тех пор, пока не был достигнут базовый уровень заряда обратного восстановления. Эти испытания проводились на APT10026JN — стандартном MOSFET-транзисторе и на APT10025JVFR — FREDFET-транзисторе (MOSFET-транзистор с быстровосстанавливающимся внутренним паразитным диодом). Результаты показаны на рис. 11.
<img src=»https://kit-e.ru/wp-content/uploads/136p11-1.png» alt=»Рис. 11. Запасенный заряд, остающийся в переходе после прохождения прямого тока, стал равным нулю (Vgate = 0 В)» title=»» width=»299″ height=»304″>
Рис. 11. Запасенный заряд, остающийся в переходе после прохождения прямого тока, стал равным нулю (Vgate = 0 В)
Из рис. 11 ясно, что заряд остается в переходе какое-то более длительное время, чем указано в значении времени обратного восстановления. Стандартный MOSFET-транзистор был почти восстановлен через 100 мкс, но требовалось до 200 мкс времени, чтобы восстановить транзистор полностью.
Стандартный MOSFET-транзистор был почти восстановлен через 100 мкс, но требовалось до 200 мкс времени, чтобы восстановить транзистор полностью.
FREDFET-транзистор был почти восстановлен через 3 мкс и полностью восстановлен менее чем через 10 мкс. FREDFET-транзистор восстанавливался намного быстрее, чем стандартный MOSFET-транзистор из-за более короткой продолжительности жизни неосновных носителей, приводящей к более быстрой рекомбинации.
2. Оценка последствий смещения затвора при запасенном заряде
Для исследования включения канала транзистора при запасенном в переходе заряде проводился другой ряд испытаний. Данный режим достигался за счет подачи потенциала на затвор тестируемого устройства в течение периода прямого прохождения тока. Запасенный заряд был измерен через 1 мкс после того, как прямой ток был остановлен.
Как и прежде, эти испытания проводились при 5 А прямого тока в течение 10 мкс и обратном напряжении 800 В с dv/dt = 1,33 В/нс. Данное обратное напряжение прикладывалось через 1 мкс после того, как прямой ток был выключен.
Данное обратное напряжение прикладывалось через 1 мкс после того, как прямой ток был выключен.
Первое измерение было проведено с выключенным каналом транзистора. Второе измерение (рис. 12) было проведено с включением канала транзистора за 1 мкс до того, как прямой ток был выключен, и выключением канала транзистора за 300 нс до подачи обратного напряжения.
Рис. 12. Выбор временных отсчетов для измерения эффектов в канале транзистора при запасенном заряде, остающемся в переходе транзистора
Последующие измерения производились с увеличением времени открытого состояния канала транзистора с шагом 1 мкс и выключением канала всегда в то же самое время (300 нс до момента приложения обратного напряжения). Результаты приведены на рис. 13.
<img src=»https://kit-e.ru/wp-content/uploads/136p13-3.png» alt=»Рис. 13. Зависимость запасенного заряда, остающегося в переходе от времени (Vgate = 15 В)» title=»» width=»279″ height=»278″>
Рис. 13. Зависимость запасенного заряда, остающегося в переходе от времени (Vgate = 15 В)
Ясно, что включение канала в течение интервала прямой проводимости внутреннего паразитного диода уменьшает количество запасенного заряда, и чем скорее канал транзистора перейдет во включенное состояние, тем меньше величина остающегося заряда. Однако запасенный заряд стандартного MOSFET-транзистора никогда не достигает нулевого значения в течение периода проводимости (10 мкс), даже если канал транзистора находится во включенном состоянии перед состо янием проводимости внутреннего паразитного диода.
Однако запасенный заряд стандартного MOSFET-транзистора никогда не достигает нулевого значения в течение периода проводимости (10 мкс), даже если канал транзистора находится во включенном состоянии перед состо янием проводимости внутреннего паразитного диода.
С другой стороны, FREDFET-транзистор из-за короткой продолжительности жизни неосновных носителей имеет фактически нулевой запасенный заряд при включенном состоянии канала транзистора в течение последней микросекунды перед состоянием проводимости внутреннего паразитного диода.
3. Последствия от смещения затвора при обратном восстановлении
Мы подготовили испытательную установку (рис. 14) для тестирования поведения внутренних паразитных диодов при обратном восстановлении. Мы были заинтересованы в получении данных не по результатам «абсолютных измерений», а скорее «сравнительных измерений» при тех же самых условиях испытаний.
Рис. 14. Испытательная установка для измерения обратного восстановления
Испытательное оборудование работает следующим образом. Постоянный ток If, создаваемый генератором тока, протекает через внутренний паразитный диод. Далее мы резко меняем полярность напряжения, приложенного к переходу диода, посредством внешнего ключа, связанного с источником отрицательного напряжения Vr, приложенного к стоку. К затвору также может быть приложено напряжение. Фиксируемые сигналы — диодный ток (ток стока) и диодное напряжение (напряжение «сток–исток») (рис. 15).
Постоянный ток If, создаваемый генератором тока, протекает через внутренний паразитный диод. Далее мы резко меняем полярность напряжения, приложенного к переходу диода, посредством внешнего ключа, связанного с источником отрицательного напряжения Vr, приложенного к стоку. К затвору также может быть приложено напряжение. Фиксируемые сигналы — диодный ток (ток стока) и диодное напряжение (напряжение «сток–исток») (рис. 15).
Рис. 15. Пример формы сигнала обратного восстановления
Обратите внимание, что на рисунке диодный ток представлен в перевернутом виде: отрицательная часть формы сигнала — прямой ток в диоде, положительная часть — ток восстановления. Во всех измерениях прямой ток If — 2,5 А и обратное напряжение Vr — 1 В. Напряжение затвора равно 0 или 3 В.
Мы проверили несколько MOSFET-транзисторов. Рис. 16–19 показывают результаты испытаний для стандартного MOSFET-транзистора и для FREDFET-транзистора.
Стандартный MOSFET-транзистор
Как показано на рис. 16, в случае Vg = 0 В величина tb принимает большие значения. Это означает, что рекомбинация заряда требует много времени. Фактически, этот интервал закончен только в случае, когда неосновные носители, которые находятся на некотором расстоянии от перехода, захвачены и притянуты назад к переходу и, кроме того, емкость обратно-смещенного перехода заряжена до значения Vr. Когда затвор смещен напряжением 3 В (рис. 17), величины trr и Qrr (заряд обратного восстановления) уменьшаются значительно. Обратите внимание, что величина напряжения 3 В недостаточно велика, чтобы открыть канал транзистора и пропустить существенный ток.
<img src=»https://kit-e.ru/wp-content/uploads/136p16-1.png» alt=»Рис. 16. Обратное восстановление стандартного MOSFET-транзистора. If = 2,5 A, Vr = 1 В, Vg = 0 В. Масштаб горизонтальной шкалы: 500 нс/дел. » title=»» width=»457″ height=»348″>
» title=»» width=»457″ height=»348″>
Рис. 16. Обратное восстановление стандартного MOSFET-транзистора. If = 2,5 A, Vr = 1 В, Vg = 0 В. Масштаб горизонтальной шкалы: 500 нс/дел.
Рис. 17. Обратное восстановление стандартного MOSFET-транзистора. If = 2,5A, Vr = 1 В, Vg = 3 В. Масштаб горизонтальной шкалы: 500 нс/дел
FREDFET-транзистор
В FREDFET-транзисторе мы можем наблюдать то же самое явление, но в этом случае сокращение trr меньшее (рис. 18 и 19).
<img src=»https://kit-e.ru/wp-content/uploads/136p18-1.png» alt=»Рис. 18. Обратное восстановление FREDFET;транзистора. If = 2,5 A, Vr = 1 В, Vg = 0 В. Масштаб горизонтальной шкалы: 50 нс/дел» title=»» width=»457″ height=»348″>
Рис. 18. Обратное восстановление FREDFET;транзистора. If = 2,5 A, Vr = 1 В, Vg = 0 В. Масштаб горизонтальной шкалы: 50 нс/дел
<img src=»https://kit-e. ru/wp-content/uploads/136p19-1.png» alt=»Рис. 19. Обратное восстановление FREDFET;транзистора. If = 2,5 A, Vr = 1 В, Vg = 3 В. Масштаб горизонтальной шкалы: 50 нс/дел» title=»» width=»457″ height=»348″>
ru/wp-content/uploads/136p19-1.png» alt=»Рис. 19. Обратное восстановление FREDFET;транзистора. If = 2,5 A, Vr = 1 В, Vg = 3 В. Масштаб горизонтальной шкалы: 50 нс/дел» title=»» width=»457″ height=»348″>
Рис. 19. Обратное восстановление FREDFET;транзистора. If = 2,5 A, Vr = 1 В, Vg = 3 В. Масштаб горизонтальной шкалы: 50 нс/дел
По результатам проведенных испытаний, выполненных на нескольких MOSFET-транзисторах от различных поставщиков, можно сделать вывод о том, что небольшое положительное смещение на затворе (близкое, но не достигающее порогового значения напряжения открывания транзистора) имеет большое влияние на обратное восстановление внутреннего паразитного диода, даже при том, что канал транзистора фактически выключен. Достоверным объяснением данного поведения можно считать следующее: дополнительные электроны в канале транзистора имеют тенденцию повторно объединяться с избыточными «дырками», запасенными в эпитаксиальном n-слое, ускоряя, таким образом, восстановление внутреннего паразитного диода.
4. Последствия протекания тока в канале (полевого транзистора) и состояние канала во времени при запасенном заряде, остающемся в переходе
Для определения результатов протекания тока в канале полевого транзистора при запасенном заряде проводился другой ряд испытаний: пропускали прямой ток через диод в тестируемом устройстве и затем полностью меняли полярность тока (то есть меняли прямой ток через диод на прямой ток канала полевого транзистора равной величины) и поддерживали прямой ток канала транзистора в течение 2 мкс. Канал тестируемого устройства включался до или в момент перенаправления тока и выключался позже, через 2 мкс. Затем, через 200 нс после того, как канал транзистора был выключен, мы прикладывали к диоду обратное напряжение 800 В с dv/dt = 1,33 В/нс и измеряли запасенный заряд. Эти испытания проводились с 2 и 9 А прямого тока, протекающего через диод в течение 5 мкс. Первое измерение было предпринято при выключенном канале. Второе измерение было предпринято за 1 мс перед перенаправлением тока, когда канал находился во включенном состоянии.
Рис. 20. Зависимость запасенного заряда, остающегося в переходе, от состояния канала во времени с 2 и 9 А прямого тока
Последующие измерения были предприняты с включением канала полевого транзистора на 1 мкс ранее, поддерживая канал во включенном состоянии в течение 2 мкс после перенаправления тока и выключая канал за 200 нс до приложения обратного напряжения. Результаты показаны на рис. 20. Из рисунков ясно, что хотя 9 А прямого тока через диод привели к более высоким значениям начального запасенного заряда, чем 2 А (прямого тока через диод), запасенный заряд был удален более эффективно в случае нахождения канала транзистора во включенном состоянии. Причина этого кроется в более высоком падении напряжения через канал (из-за более высокого значения тока), которое охватит большее количество заряда в переходе. Это объясняет, почему отказы произошли в случае низкого уровня выходной мощности. В диоде остается большее количество заряда, которое делает диод более восприимчивым к вторичному пробою при приложении высокого напряжения.
Технические способы повышения надежности приборов
Для повышения устойчивости работы полевого транзистора и, следовательно, надежности оборудования было исследовано несколько решений.
1. Использование FREDFET-транзисторов
MOSFET-транзисторы с более быстрым временем обратного восстановления внутреннего паразитного диода демонстрируют большую устойчивость и прочность при работе в ПНН-преобразователе. В настоящее время доступны MOSFET-транзисторы с внутренним паразитным диодом, обладающим временем обратного восстановления приблизительно в десять раз меньше времени восстановления у полевых транзисторов, производимых несколько лет назад. Это особенно справедливо для случая полевых транзисторов высокого напряжения (800 В и 1000 В). Наш опыт показывает, что долговременная интенсивность отказов ПНН-преобразователей, построенных с 800-вольтовыми или 1000-вольтовыми FREDFET-транзисторами намного меньше, чем таковая для ПНН-преобразователей, построенных со стандартными MOSFET-транзисторами высокого напряжения.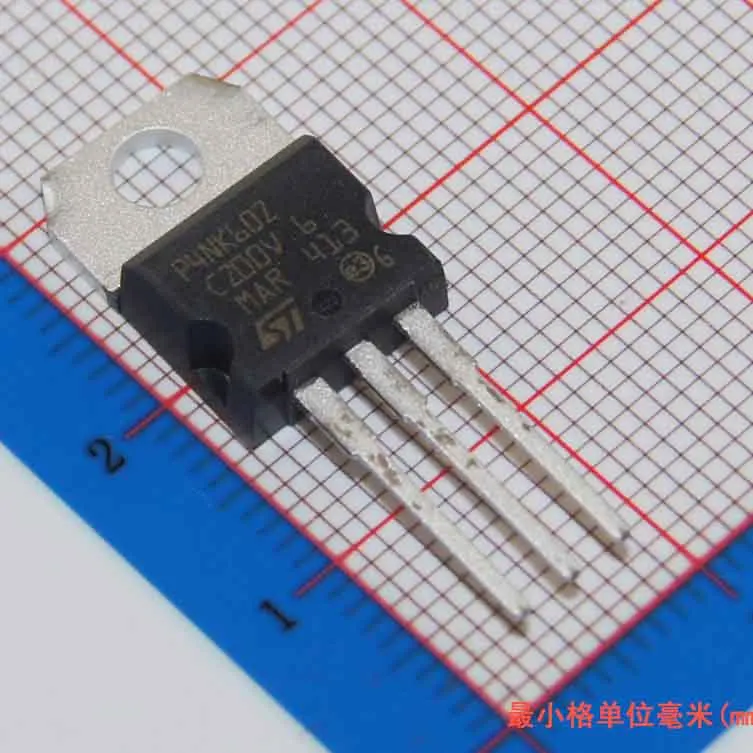
Мы также рассмотрели три других возможных варианта повышения устойчивости, каждый из которых требует некоторой модификации схемы ПНН-преобразователя.
2. Модификации конвертора
Цель модификаций состоит в том, чтобы избежать использования внутреннего паразитного диода или, по крайней мере, минимизировать последствия его влияния на работу схемы. Рассматривались три возможности:
- Проводимость тока внутренним паразитным диодом может быть предотвращена путем добавления перенаправляющих диодов (current-steering diodes) — диод Шоттки последовательно со стоком MOSFET-транзистора наряду с ультрабыстрым антипараллельным обводным диодом (рис. 21).
Рис. 21. Исключение проводимости внутреннего паразитного диода с использованием перенаправляющих диодов
В этом случае внутренний паразитный диод никогда не проводит ток. Однако это решение весьма дорого и сложно, кроме того, последовательный диод увеличивает потери проводимости.
- Нами было замечено, что в случае выходных нагрузок выше 25% предельного значения (который означает высокий ток в ПНН-конверторе и, следовательно, высокое падение напряжения на сопротивлении RDS(on) в течение времени, когда транзистор находится во включенном состоянии) вероятность отказа незначительна.
 Ожидается, что вероятность отказа будет уменьшена при незначительной нагрузке, если мы поддерживаем достаточно высокое напряжение «сток–исток», вынуждая неосновные носители полностью рекомбинировать перед окончанием включенного состояния транзистора. Это может быть достигнуто путем добавления схемы исключения насыщения. На рис. 22 показано упрощенное схемное решение исключения насыщения транзистора.
Ожидается, что вероятность отказа будет уменьшена при незначительной нагрузке, если мы поддерживаем достаточно высокое напряжение «сток–исток», вынуждая неосновные носители полностью рекомбинировать перед окончанием включенного состояния транзистора. Это может быть достигнуто путем добавления схемы исключения насыщения. На рис. 22 показано упрощенное схемное решение исключения насыщения транзистора.
Рис. 22. Упрощенная схема исключения насыщения
При использовании стабилитрона с надлежащим напряжением стабилизации, в случае незначительной нагрузки MOSFET-транзистор вынужден работать в линейной области своей рабочей характеристики. В этой области напряжение «сток–исток» больше не связано с током, протекающим в MOSFET-транзисторе, оно постоянно и равно разнице между управляющим напряжением и суммой напряжений стабилитрона и выпрямительного диода. Напряжение стабилитрона должно быть выбрано таким, чтобы установить напряжение «сток–исток», по крайней мере, столь же высоким, как это было при 25% от предельной величины нагрузки. При большей нагрузке падение напряжения через сопротивление RDS(on) выше, чем фиксированная величина, установленная напряжением управления затвором, а также напряжениями стабилитрона и выпрямительного диода, и поведение работы схемы является обычным.
При большей нагрузке падение напряжения через сопротивление RDS(on) выше, чем фиксированная величина, установленная напряжением управления затвором, а также напряжениями стабилитрона и выпрямительного диода, и поведение работы схемы является обычным.
Главные проблемы рассмотренного решения:
- высокие требования к точности напряжения на стабилитроне и температурная зависимость;
- увеличенное потребление мощности драйвера MOSFET-транзистора;
- сложность схемы и дороговизна.
- Подобно схеме исключения насыщения, третье решение предотвращает проводимость внутреннего паразитного диода только в случае опасности возникновения проблемы, то есть при незначительной нагрузке. Это решение оказалось простым и эффективным без дальнейшего увеличения сложности конвертора.
Более тщательное рассмотрение основных режимов работы мостового преобразователя с мягким переключением (стадии от 2 до 4) показывает, что внутренний паразитный диод может проводить, только если напряжение «сток – исток» достигает нуля прежде, чем транзистор переходит во включенное состояние (рис. 23).
23).
<img src=»https://kit-e.ru/wp-content/uploads/136p23-1.png» alt=»Рис. 23. Стандартный режим незначительной нагрузки. Io = 10 A, VDS: 100 В/дел, Vg: 2 В/дел, 500 нс/дел» title=»» width=»460″ height=»350″>
Рис. 23. Стандартный режим незначительной нагрузки. Io = 10 A, VDS: 100 В/дел, Vg: 2 В/дел, 500 нс/дел
Если мы переводим MOSFET-транзистор во включенное состояние прежде, чем его напряжение «сток–исток» достигает нуля (рис. 24), канал MOSFET-транзистора будет работать параллельно с внутренним паразитным диодом до того момента, как начнет протекать ток в транзисторе. Это, в свою очередь, предотвращает протекание тока во внутреннем паразитном диоде. Фактически, если падение напряжения через RDS(on) меньше, чем пороговое напряжение внутреннего паразитного диода, ток будет течь только в канале полевого транзистора. Именно это происходит при незначительной нагрузке.
<img src=»https://kit-e. ru/wp-content/uploads/136p24.png» alt=»Рис. 24. Улучшенное поведение транзистора при незначительной нагрузке. Io = 10 A, VDS: 100 В/дел, Vg: 2 В/дел, 100 нс/дел» title=»» width=»460″ height=»350″>
ru/wp-content/uploads/136p24.png» alt=»Рис. 24. Улучшенное поведение транзистора при незначительной нагрузке. Io = 10 A, VDS: 100 В/дел, Vg: 2 В/дел, 100 нс/дел» title=»» width=»460″ height=»350″>
Рис. 24. Улучшенное поведение транзистора при незначительной нагрузке. Io = 10 A, VDS: 100 В/дел, Vg: 2 В/дел, 100 нс/дел
Мы можем добиться включения MOSFET-транзистора прежде, чем его напряжение «сток–исток» достигнет нуля, во-первых, путем сокращения времени задержки включения или, во-вторых, путем сокращения dv/dt — скорости нарастания напряжения «сток–исток». Оба условия могут быть легко выполнены: первое требует изменения величины сопротивления в плате управления, которая устанавливает надлежащую задержку между транзисторными ключами, второе требует увеличения величины внешнего снабберного конденсатора, помещенного параллельно с каждым транзисторным ключом. (Эти конденсаторы обычно требуются, чтобы сократить потери на выключение; они замедляют нарастание напряжения «сток–исток», и в результате выключение тока транзистора заканчивается с незначительным напряжением на MOSFET-транзисторе).
Обратите внимание, что, открывая MOSFET-транзистор при напряжении, отличном от нуля, мы теряем преимущества переключения при нулевом напряжении. Это, однако, не проблема, так как это происходит при незначительной нагрузке, где небольшое снижение эффективности легко можно допустить. Так или иначе, мы имеем «квазипереключение при нулевом напряжении», поскольку напряжение «сток–исток» имеет достаточно времени, чтобы приблизиться к нулю до включения MOSFET-транзистора. Так как потери на включение транзистора пропорциональны квадрату напряжения на снабберном конденсаторе, режима квазипереключения при нулевом напряжении достаточно, чтобы поддерживать потери на включение на приемлемо низком уровне.
Если происходит увеличение тока нагрузки, наклон напряжения «сток–исток» также увеличивается и при фиксированной задержке включения напряжение «сток–исток» приближается к нулю в момент включения MOSFET-транзистора (рис. 25).
<img src=»https://kit-e.ru/wp-content/uploads/136p25. png» alt=»Рис. 25. Квазипереключение при нулевом напряжении при средней нагрузке. Io = 30 А, VDS: 100 В/дел, Vg: 2 В/дел, 100 нс/дел» title=»» width=»460″ height=»350″>
png» alt=»Рис. 25. Квазипереключение при нулевом напряжении при средней нагрузке. Io = 30 А, VDS: 100 В/дел, Vg: 2 В/дел, 100 нс/дел» title=»» width=»460″ height=»350″>
Рис. 25. Квазипереключение при нулевом напряжении при средней нагрузке. Io = 30 А, VDS: 100 В/дел, Vg: 2 В/дел, 100 нс/дел
Выше некоторого значения нагрузки напряжение «сток–исток» достигнет нуля прежде, чем включится MOSFET-транзистор. В этом случае конвертор работает с преимуществами переключения при нулевом напряжении (рис. 26).
<img src=»https://kit-e.ru/wp-content/uploads/136p26.png» alt=»Рис. 26. Переключение при нулевом напряжении в случае большой нагрузки. Io = 75 A, VDS: 100 В/дел, Vg: 2 В/дел, 100 нс/дел» title=»» width=»460″ height=»350″>
Рис. 26. Переключение при нулевом напряжении в случае большой нагрузки. Io = 75 A, VDS: 100 В/дел, Vg: 2 В/дел, 100 нс/дел
Применение этого решения существенно понизило вероятность отказа MOSFET-транзистора без усложнения схемы и изменений в расположении компонентов. В массовом производстве это решение использовалось в комбинации с FREDFET-транзисторами. Эффективность такого комплексного решения была доказана статистическим анализом, выполненным на более чем 500 приборах, которые суммарно проработали в течение свыше 3 миллионов часов. Этот анализ подтвердил, что вероятность отказа MOSFET-транзисторов в ПНН-конверторе теперь незначительна.
В массовом производстве это решение использовалось в комбинации с FREDFET-транзисторами. Эффективность такого комплексного решения была доказана статистическим анализом, выполненным на более чем 500 приборах, которые суммарно проработали в течение свыше 3 миллионов часов. Этот анализ подтвердил, что вероятность отказа MOSFET-транзисторов в ПНН-конверторе теперь незначительна.
Выводы
Данная статья пытается объяснить некоторые до сих пор необъяснимые отказы, которые наблюдались в конверторах с переключением при нулевом напряжении (в особенности в мостовом преобразователе с фазовым сдвигом) с использованием высоковольтного MOSFET-транзистора.
Главным механизмом отказа MOSFET-транзисторов является вторичный пробой паразитного биполярного транзистора. Вторичный пробой может происходить, когда паразитный биполярный транзистор активизирован остаточным зарядом, оставшимся в результате проводимости внутреннего паразитного диода. Согласно общим представлениям о конверторах с переключением при нулевом напряжении, в которых открытый внутренний паразитный диод обычно шунтируется сопротивлением канала, в полевом транзисторе не остается заряд после периода проводимости тока. Как разъяснено в статье, а также продемонстрировано на примере экспериментально полученных данных, это не соответствует истине: заряд, остающийся в стандартных MOSFET-транзисторах, может быть существенен и часто достаточен, чтобы вызвать вторичный пробой.
Как разъяснено в статье, а также продемонстрировано на примере экспериментально полученных данных, это не соответствует истине: заряд, остающийся в стандартных MOSFET-транзисторах, может быть существенен и часто достаточен, чтобы вызвать вторичный пробой.
С другой стороны, заряд, остающийся в MOSFET-транзисторах с быстровосстанавливающимся внутренним паразитным диодом (FREDFET-транзисторы), достаточно мал, и здесь проблема вторичного пробоя практически исчезает. Полная защита против вторичного пробоя может быть достигнута путем совместного использования FREDFET-транзистора с незначительной модификацией в конверторе. Эта модификация заключается в увеличении емкости снабберной цепи, помещенной параллельно MOSFET-транзистору таким образом, что канал полевого транзистора включается прежде, чем напряжение «сток–исток» достигнет нуля, и внутренний паразитный диод начнет проводить ток. Как рассмотрено в статье, это может быть сделано без существенного влияния на эффективность преобразователя с предельной нагрузкой, так как согласно сделанным в статье заключениям преждевременное включение канала необходимо только при незначительной нагрузке.
В то время как может ожидаться маленькое снижение эффективности при незначительной нагрузке из-за потери преимущества переключения при нулевом напряжении, эффективность на предельной нагрузке должна увеличиться из-за сокращения потерь на выключение, вызванного большими емкостями снабберной цепи. Статистический анализ отказа испытываемых источников питания доказывает, что комбинация FREDFET-транзисторов с увеличением емкости снабберной цепи фактически устраняет отказы MOSFET-транзистора, вызванные запасенным зарядом внутреннего паразитного диода.
Авторы благодарят Mr. Luca Franzan из SICON за полезные дискуссии и ценные комментарии, а также его общий вклад в данную работу.
- Redl R., Balogh L., and Nathan O. Sokal. A Novel Soft Switching Full Bridge DC/DC Converter: Analysis, Design Considerations and Experimental Results at 1.5 kW, 100 kHz. PESC ′90 Record.
- Andreycak B. Designing a Phase Shifted Zero Voltage Transition (ZVT) Converter. Topic 3 in the Unitrode Power Supply Design Seminar Manual.
 SEM-900. 1993. Unitrode Corporation.
SEM-900. 1993. Unitrode Corporation. - Andreycak B. Design Review: 500W, 40W/in3 Phase Shifted ZVT Power Converter. Topic 4 in the Unitrode Power Supply Design Seminar Manual. SEM-900. 1993. Unitrode Corporation.
- Andreycak B. Phase Shifted, Zero Voltage Transition Design Considerations and the UC3875 PWM Controller. Unitrode Application Note U-136A.
- Pelly B. The Do′s and Dont′s of Using the Power HEXFET. International Rectifier Application Note 936A.
- Avalanche and dv/dt Limitation of the Power MOSFET. Chapter 5. Motorola TMOS Power MOSFET Transistor Device Data Book. DL 135/D.
- Certain features of the circuit topology are protected by US Pat. 5,198,969. Readers should refer to the patent for details.
Транзистор КТ315: характеристики, цоколевка, маркировка, аналоги
КТ315 — кремниевый транзистор, со структурой NPN, планарно-эпитаксиальный, высокочастотный, малой мощности, общепромышленного применения. Конструктивное исполнение КТ-13 и КТ-26 (TO-92).
Содержание
- Предназначение
- Корпус, цоколевка и размеры
- Характерные особенности
- Предельные эксплуатационные характеристики
- Электрические параметры
- Маркировка
- Аналоги
- Отечественное производство
- Зарубежное производство
- Графические иллюстрации характеристик
Предназначение
Транзистор предназначен для работы в схемах усилителей высокой, промежуточной и низкой частоты, а также в схемах импульсных устройств в аппаратуре общего назначения.
Для компьютеров, станков с ЧПУ, цветных телевизоров и аудиоаппаратуры высшего класса выпускались транзисторы повышенной надежности, в их маркировке рядом с буквой присутствовала точка.
Корпус, цоколевка и размеры
Характерные особенности
- Относительно высокий коэффициент усиления hFE: значение до 350 в схеме с общим эмиттером.
- Относительно широкая полоса пропускания: частота среза fT ˃ 250 МГц.

- Комплементарная пара: КТ361, КТ361-1.
Предельные эксплуатационные характеристики
| Параметр | Мощность рассеивания, | Напряжение коллектор-эмиттер, | Напряжение коллектор-база, | Напряжение база-эмиттер, | Ток коллектора постоянный, | Температура п/п перехода, | Диапазон температур внешней среды |
|---|---|---|---|---|---|---|---|
| Обозначение/Тип | PC, Вт | UCE, В | UCB, В | UBE, В | IC, А | TJ, °С | °С |
| КТ315А | 0,15 | 25 | 25 | 6 | 0,1 | 120 | -60°С…+100°С |
| КТ315А1 | 0,15 | 25 | 25 | 6 | 0,1 | 120 | -45°С…+100°С |
| КТ315Б | 0,15 | 20 | 20 | 6 | 0,1 | 120 | -60°С…+100°С |
| КТ315Б1 | 0,15 | 20 | 20 | 6 | 0,1 | 120 | -45°С…+100°С |
| КТ315В | 0,15 | 40 | 40 | 6 | 0,1 | 120 | -60°С…+100°С |
| КТ315В1 | 0,15 | 40 | 40 | 6 | 0,1 | 120 | -45°С…+100°С |
| КТ315Г | 0,15 | 35 | 35 | 6 | 0,1 | 120 | -60°С…+100°С |
| КТ315Г1 | 0,15 | 35 | 35 | 6 | 0,1 | 120 | -45°С…+100°С |
| КТ315Д | 0,15 | 40 | 40 | 6 | 0,1 | 120 | -60°С…+100°С |
| КТ315Д1 | 0,15 | 40 | 40 | 6 | 0,1 | 120 | -45°С…+100°С |
| КТ315Е | 0,15 | 35 | 35 | 6 | 0,1 | 120 | -60°С…+100°С |
| КТ315Е1 | 0,15 | 35 | 35 | 6 | 0,1 | 120 | -45°С…+100°С |
| КТ315Ж | 0,1 | 15 | 15 | 6 | 0,05 | 120 | -60°С…+100°С |
| КТ315Ж1 | 0,1 | 20 | 20 | 6 | 0,05 | 120 | -45°С…+100°С |
| КТ315И | 0,1 | 60 | 60 | 6 | 0,05 | 120 | -60°С…+100°С |
| КТ315И1 | 0,1 | 60 | 60 | 6 | 0,05 | 120 | -45°С…+100°С |
| КТ315Н1 | 0,15 | 20 | 20 | 6 | 0,1 | 120 | -45°С…+100°С |
| КТ315Р1 | 0,15 | 35 | 35 | 6 | 0,1 | 120 | -45°С…+100°С |
Электрические параметры
| Параметр | Ток коллектора выключения | Ток эмиттера выключения | Статический коэффициент усиления | Напряжение насыщения | Напряжение насыщения | Частота среза | Емкость коллектора | Пост. времени коллектор-ной цепи времени коллектор-ной цепи |
|---|---|---|---|---|---|---|---|---|
| Обозначение | ICBO, мкА | IEBO, мкА | hFE | UCE(sat), В | UBE(sat), В | fT, МГц | пФ | пс |
| Режим/Тип | UCB = 10 В IE = 0 | UBE = 6 В | UCB = 10 В IE = 1 мА | IC = 20 мА IB = 2 мА | IC = 20 мА IB = 2 мА | UCE = 10 В IE = 5 мА | UCB = 10В | UCB = 10 В IE = 5 мА f = 5 МГц |
| КТ315А | 1 | 30 | 20…90 | 0,4 | 1,1 | ˃ 250 | 7 | ˂ 300 |
| КТ315А1 | 0,5 | 30 | 30…120 | 0,4 | 1 | ˃ 250 | 7 | 300…1000 |
| КТ315Б | 1 | 30 | 50…350 | 0,4 | 1,1 | ˃ 250 | 7 | ˂ 500 |
| КТ315Б1 | 0,5 | 30 | 50…350 | 0,4 | 1 | ˃ 250 | 7 | 300…1000 |
| КТ315В | 1 | 30 | 20…90 | 0,4 | 1,1 | ˃ 250 | 7 | ˂ 500 |
| КТ315В1 | 0,5 | 30 | 30…120 | 0,4 | 1 | ˃ 250 | 7 | 300…1000 |
| КТ315Г | 1 | 30 | 50…350 | 0,4 | 1,1 | ˃ 250 | 7 | ˂ 500 |
| КТ315Г1 | 0,5 | 30 | 50…350 | 0,4 | 1 | ˃ 250 | 7 | 300…1000 |
| КТ315Д | 1 | 30 | 20…90 | 1 | 1,5 | ˃ 250 | 7 | ˂ 1000 |
| КТ315Д1 | 0,6 | 30 | 20…90 | 0,6 | 1,1 | ˃ 250 | 7 | 300…1000 |
| КТ315Е | 1 | 30 | 50…350 | 1 | 1,5 | ˃ 250 | 7 | ˂ 1000 |
| КТ315Е1 | 0,6 | 30 | 50…350 | 0,6 | 1,1 | ˃ 250 | 7 | 300…1000 |
| КТ315Ж | 1 | 30 | 30…250 | 0,5 | 0,9 | ˃ 250 | 10 | ˂ 1000 |
| КТ315Ж1 | 0,6 | 30 | 30…250 | 0,5 | 0,9 | ˃ 250 | 10 | 300…1000 |
| КТ315И | 1 | 50 | ˃ 30 | — | — | ˃ 250 | — | — |
| КТ315И1 | 0,6 | 50 | ˃ 30 | 0,9 | 1,35 | ˃ 250 | 10 | 300…1000 |
| КТ315Н1 | 0,5 | 30 | 50…350 | 0,4 | 1 | ˃ 250 | 7 | 300…1000 |
| КТ315Р1 | 0,5 | 3 | 150…350 | 0,4 | 1 | ˃ 250 | 7 | 300…1000 |
Примечание: данные в таблице действительны при температуре среды Ta = 25°C.
Маркировка
Рассмотрим транзистор КТ315 в корпусе КТ-13. Радиоэлемент имеет цифробуквенное обозначение и чаще встречается в оранжевом исполнении. В правом верхнем углу корпуса размещен знак завода-изготовителя, а в левом группа коэффициента усиления. Под условными обозначениями группы и предприятия-изготовителя указана дата выпуска.
Современный KT315 выпускается в корпусе для сквозного монтажа КТ-26 (TO-92).
Цифра «1», в конце указывает на современный КТ315 (TO-92), а предпоследняя буква «Г» на группу, к которой относится транзистор из этой серии. На основе значений параметров в группе, можно определить его основное назначение.
Аналоги
Для замены могут подойти транзисторы кремниевые, со структурой NPN, эпитаксиально-планарные, для усилителей высокой, промежуточной и низкой частоты, схем импульсных устройств и другой аппаратуры общего применения.
Отечественное производство
| Тип | PC | UCB | UCE | UEB | IC | TJ | fT | Cob | hFE | Корпус |
|---|---|---|---|---|---|---|---|---|---|---|
| КТ315, КТ315-1 | 0,15 | 15…60 | 15…60 | 6 | 0,1 | 120 | 250 | 7 | 20…350 | КТ13, TO-92 |
| КТ3151 A9/B9/D9/E9/G9/V9 | 0,2 | 20…80 | 20…80 | 5 | 0,1 | 175 | 100 | 15 | 20…80 | SOT23 (КТ-46) |
| КТ3153 A9 | 0,15 | 60 | 50 | 5 | 0,4 | 150 | 250 | 4,5 | 100…300 | SOT23 (КТ-46А) |
| КТ3102 | 0,25 | 20…50 | 20…50 | 5 | 0,2 | 125 | — | 6 | 100…1000 | TO-92 (КТ-26) |
Зарубежное производство
| Тип | PC | UCB | UCE | UEB | IC | TJ | fT | Cob | hFE | Корпус |
|---|---|---|---|---|---|---|---|---|---|---|
| КТ315А | 0,15 | 25 | 25 | 6 | 0,1 | 120 | 250 | 7 | 20…90 | КТ13 |
| BFP719 ٭ | 0,15 | 25 | 25 | 5 | 0,1 | 120 | 250 | 7 | 20…90 | КТ13 |
| КТ315Б | 0,15 | 20 | 20 | 6 | 0,1 | 120 | 250 | 7 | 50…350 | КТ13 |
| BFP720 ٭ | 0,15 | 20 | 20 | 5 | 0,1 | 120 | 250 | 7 | 50…350 | КТ13 |
| КТ315В | 0,15 | 40 | 40 | 6 | 0,1 | 120 | 250 | 7 | 20…90 | КТ13 |
| BFP721 ٭ | 0,15 | 40 | 40 | 5 | 0,1 | 120 | 250 | 7 | 20…90 | КТ13 |
| КТ315Г | 0,15 | 35 | 35 | 6 | 0,1 | 120 | 250 | 7 | 50…350 | КТ13 |
| BFP722 ٭ | 0,15 | 35 | 35 | 5 | 0,1 | 120 | 250 | 7 | 50…350 | КТ13 |
| КТ315Д | 0,15 | 40 | 40 | 6 | 0,1 | 120 | 250 | 7 | 20…90 | КТ13 |
| 2SC641 | 0,1 | 40 | 15 | 5 | 0,1 | 150 | 400 | 6 | 45…160 | TO-92 |
| КТ315Е | 0,15 | 35 | 35 | 6 | 0,1 | 120 | 250 | 7 | 50…350 | КТ13 |
| 2N3397 | 0,36 | 25 | 25 | 5 | 0,1 | 150 | — | 10 | 55…800 | TO-92 |
| КТ315Ж | 0,1 | 15 | 15 | 6 | 0,05 | 120 | 250 | 7 | 30…250 | КТ13 |
| 2SC545 | 0,12 | 20 | 20 | 4 | 0,03 | 125 | 175 | — | 60 | TO-92 |
| 2SC546 | 0,12 | 30 | 30 | 4 | 0,03 | 125 | 300 | — | 40 | TO-92 |
| BFY37i | 0,15 | 25 | 20 | 5 | 0,1 | 175 | 270 | 2,3 | ˃ 35 | TO-18 |
| 2SC388 | 0,3 | 30 | 25 | 4 | 0,05 | 150 | 300 | 2 | 20…200 | TO-92 |
| КТ315И | 0,1 | 60 | 60 | 6 | 0,05 | 120 | 250 | — | ˃ 30 | КТ13 |
| 2SC634 | 0,18 | 40 | 40 | — | 0,1 | 125 | 140 | 4,5 | — | TO-923 |
| 2SC9014 | 0,45 | 50 | 45 | 5 | 0,1 | 150 | 150 | 3,5 | 60 | TO-92 |
| BC547 | 0,5 | 50 | 50 | 6 | 0,1 | 150 | 300 | 6 | 110 | TO-92 |
| 2N3904 | 0,31 | 60 | 40 | 6 | 0,2 | 135 | 300 | 4 | 40 | TO-92 |
| КТ315Н1 | 0,15 | 20 | 20 | 6 | 0,1 | 120 | 250 | 7 | 50…350 | TO-92 |
| 2SC633 | 0,3 | 26 | 26 | 6 | 0,2 | 125 | 112 | 7 | 45…660 | TO-92 |
| КТ315Р1 | 0,15 | 35 | 35 | 6 | 0,1 | 120 | 250 | 7 | 150…350 | TO-92 |
| BFP722 ٭ | 0,15 | 35 | 35 | 5 | 0,1 | 120 | 250 | 7 | 50…350 | КТ13 |
٭ — изделие в настоящее время не выпускается, однако могут иметься значительные запасы.
Примечание: данные таблиц получены из даташит компаний-производителей.
Графические иллюстрации характеристик
Рис. 1. Внешние характеристики некоторых транзисторов семейства КТ315: зависимости коллекторного тока IC от напряжения коллектор-эмиттер UCE при различных токах базы: 0,1; 0,2; 0,3; 0,4 мА.
Рис. 2. Внешние характеристики некоторых транзисторов семейства КТ315: зависимости коллекторного тока IC от напряжения коллектор-эмиттер UCE при различных токах базы: 0,05; 0,1; 0,15; 0,2; 0,25; 0,3; 0,4; 0,45 мА.
Рис. 3. Зависимость напряжения насыщения коллектор-эмиттер UCE(sat) от величины коллекторной нагрузки IC.
Характеристика снята при соотношении IC/IB = 10. Пунктиром показаны границы 95% разброса значений параметра.
Рис. 4. Зависимость напряжения насыщения база-эмиттер UBE(sat) от величины коллекторной нагрузки IC.
Характеристика снята при соотношении IC/IB = 10. Пунктиром показаны границы 95% разброса значений параметра.
Рис. 5. Зависимость для некоторых транзисторов семейства КТ315 статического коэффициента усиления hFE по току в схеме с общим эмиттером от величины тока эмиттера IE.
Характеристика снята при напряжении UCB = 10 В.
Пунктиром показаны границы 95% разброса значений параметра.
Рис. 6. Зависимость для некоторых транзисторов семейства КТ315 статического коэффициента усиления hFE по току в схеме с общим эмиттером от величины тока эмиттера IE.
Характеристика снята при напряжении UCB = 10 В.
Пунктиром показаны границы 95% разброса значений параметра.
Рис. 7. Зависимость модуля коэффициента усиления тока базы от тока эмиттера IE при высокой частоте f = 100 МГц.
Зависимость снята при напряжении UCE = 10В. Пунктиром показан 95% разброс результатов измерений параметра.
Рис. 8. Зависимости постоянной времени обратной связи по коллекторной цепи τС [пс] от величины напряжения коллектор-база при высокой частоте для некоторых транзисторов семейства КТ315.
Характеристика снята при токе эмиттера IE = 5 мА и частоте 5 МГц. Пунктирной линией показан 95% разброс значений измеренного параметра.
Транзистор bc547 аналоги, datasheet на русском, параметры, схема
Таблица 4 – Электрические параметры транзисторов КТ361Е, КТ361Ж, КТ361И, КТ361К, КТ361А, КТ361М, КТ361Н и КТ361П при приемке и поставке
| Наименование параметра (режим измерения), единица измерения | Буквенное обозначение | Норма | Температура, °С | |||||||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Обратный ток коллектора (UКБ=10 В), мкА | ||||||||||||||||||
| Статический коэффициент передачи тока в схеме с общим эмиттером (IЭ=1 мА, UКБ=10 В) | ||||||||||||||||||
| Обратный ток коллектор-эмиттер (RБЭ=10 кОм UКЭ=25 В), мА (RБЭ=10 кОм UКЭ=20 В), мА (RБЭ=10 кОм UКЭ=40 В), мА (RБЭ=10 кОм UКЭ=35 В), мА | ||||||||||||||||||
| Модуль коэффициента передачи тока на высокой частоте (UКБ = 10 В, IЭ= 5 мА, f = 100 МГц) | ||||||||||||||||||
| Постоянная времени цепи обратной связи на высокой частоте (IЭ= 5 мА, UКБ=10 В, f=5 МГц), пс |
В любом режиме, из указанных на рисунке 11, при конкретном применении максимальная ожидаемая интенсивность отказов может быть определена по следующей формуле:
где Jp – рабочий ток коллектора, мА;tн – наработка, часов, определенная по рисунку 11, при конкретной рассеиваемой мощности.
Справка об аналогах биполярного высокочастотного npn транзистора BC547.
Эта страница содержит информацию об аналогах биполярного высокочастотного npn транзистора BC547 .
Перед заменой транзистора на аналогичный, !ОБЯЗАТЕЛЬНО! сравните параметры оригинального транзистора и предлагаемого на странице аналога. Решение о замене принимайте после сравнения характеристик, с учетом конкретной схемы применения и режима работы прибора.
Можно попробовать заменить транзистор BC547 транзистором 2N5818; транзистором 2SC828A; транзистором 2SC945; транзистором КТ3102Б;
транзистором GS9022; транзистором 2SC4360; транзистором 2SC3653; транзистором 2SC4363; транзистором 2SC3901; транзистором 2SC4070; транзистором 2SC3655; транзистором 2SC4361; транзистором 2SC3654; транзистором 2SC4048;
Электрические параметры (при Ta = 25°C)
| Характеристика | Обозначение | Параметры при измерениях | Значения | |
|---|---|---|---|---|
| Ток коллектора выключения, мкА | ICBO | UCB = 60 В, IE = 0 | ≤ 0,1 | |
| Ток базы выключения, мкА | IEBO | UEB = 5 В, IC =0 | ≤ 0,1 | |
| Статический коэффициент усиления по току ٭ | hFE(1) | UCE = 6 В, IC = 0,002 А | 40…250 | |
| hFE(2) | UCE = 6 В, IC = 0,15 А | ≥ 25 | ||
| Напряжение насыщения коллектор-эмиттер, В | UCE(sat) | IC = 100мА, IB = 10 мА | 0,1…0,25 | |
| Напряжение насыщения база-эмиттер, В | UBE(sat) | IC = 100мА, IB = 10 мА | ≤ 0,1 | |
| Частота среза, МГц | fT | UCE = 10 В, IC = 1 мА | ≥ 80 | |
| Выходная емкость, pF | Cob | UCB = 10 В, IE = 0, f = 1 МГц | ≤ 3 | |
| Внутреннее сопротивление базового перехода, Ом | rbb’ | UCB = 10 В, IE = 1 мА, f = 30 МГц | 50 | |
| Коэффициент шума (типовое значение), dB | 2SC3198A | NF | UCE = 6 В, IC = 0,1 мА, f = 1 кГц, Rg = 10 кОм | 1 |
| 2SC3198L | NF | 0,2 |
٭ — транзисторы классифицируются по группам в зависимости от величины коэффициента усиления по току:
| Обозначение транзистора в группе | 2SC3198 O | 2SC3198 Y | 2SC3198 GR | 2SC3198 BL |
|---|---|---|---|---|
| Диапазон величины hFE | 70…140 | 120…240 | 200…400 | 350…700 |
Биполярный транзистор BC547B — описание производителя.
 Основные параметры. Даташиты.
Основные параметры. Даташиты.
Наименование производителя: BC547B
Тип материала: Si
Полярность: NPN
Максимальная рассеиваемая мощность (Pc): 0.5
W
Макcимально допустимое напряжение коллектор-база (Ucb): 50
V
Макcимально допустимое напряжение коллектор-эмиттер (Uce): 45
V
Макcимально допустимое напряжение эмиттер-база (Ueb): 6
V
Макcимальный постоянный ток коллектора (Ic): 0.1
A
Предельная температура PN-перехода (Tj): 150
°C
Граничная частота коэффициента передачи тока (ft): 200
MHz
Ёмкость коллекторного перехода (Cc): 4.5
pf
Статический коэффициент передачи тока (hfe): 200
Корпус транзистора:
BC547B
Datasheet (PDF)
0.1. bc547b bc547c.pdf Size:60K _st
BC547BBC547CSMALL SIGNAL NPN TRANSISTORSOrdering Code Marking Package / ShipmentBC547B BC547B TO-92 / BulkBC547B-AP BC547B TO-92 / AmmopackBC547C BC547C TO-92 / BulkBC547C-AP BC547C TO-92 / Ammopack SILICON EPITAXIAL PLANAR NPNTRANSISTORS TO-92 PACKAGE SUITABLE FORTHROUGH-HOLE PCB ASSEMBLYTO-92 TO-92 BC547B — THE PNP COMPLEMENTARYBulk AmmopackTYPE IS BC557BAP
0. 2. bc547 bc547a bc547b bc547c.pdf Size:26K _fairchild_semi
2. bc547 bc547a bc547b bc547c.pdf Size:26K _fairchild_semi
Discrete POWER & SignalTechnologiesBC547BC547ABC547BBC547CE TO-92BCNPN General Purpose AmplifierThis device is designed for use as general purpose amplifiersand switches requiring collector currents to 300 mA. Sourced fromProcess 10. See PN100A for characteristics.Absolute Maximum Ratings* TA = 25C unless otherwise notedSymbol Parameter Value UnitsVCEO Collector-
0.3. bc547ba3.pdf Size:412K _cystek
Spec. No. : C204A3 Issued Date : 2015.01.23 CYStech Electronics Corp.Revised Date : Page No. : 1 / 7 General Purpose NPN Epitaxial Planar Transistor BC547BA3Description The BC547BA3 is designed for use in driver stage of AF amplifier and low speed switching. Complementary to BC557BA3. Pb-free package Symbol Outline BC547BA3 TO-92 BBase CCollector
0.4. bc546abk bc547abk bc548abk bc549abk bc546bbk bc547bbk bc548bbk bc549bbk bc546cbk bc547cbk bc548cbk bc549cbk.pdf Size:81K _diotec
BC546xBK … BC549xBKBC546xBK … BC549xBKGeneral Purpose Si-Epitaxial Planar TransistorsNPN NPNSi-Epitaxial Planar-Transistoren fr universellen EinsatzVersion 2009-12-030.![]() 1Power dissipation Verlustleistung 500 mW4.6Plastic case TO-92Kunststoffgehuse (10D3)Weight approx. Gewicht ca. 0.18 gC B EPlastic material has UL classification 94V-0Gehusematerial
1Power dissipation Verlustleistung 500 mW4.6Plastic case TO-92Kunststoffgehuse (10D3)Weight approx. Gewicht ca. 0.18 gC B EPlastic material has UL classification 94V-0Gehusematerial
Другие транзисторы… BC546A
, BC546AP
, BC546B
, BC546BP
, BC546VI
, BC547
, BC547A
, BC547AP
, 2N3904
, BC547BP
, BC547C
, BC547VI
, BC548
, BC548A
, BC548AP
, BC548B
, BC548BP
.
BC547A Datasheet (PDF)
0.1. bc547 bc547a bc547b bc547c.pdf Size:26K _fairchild_semi
Discrete POWER & SignalTechnologiesBC547BC547ABC547BBC547CE TO-92BCNPN General Purpose AmplifierThis device is designed for use as general purpose amplifiersand switches requiring collector currents to 300 mA. Sourced fromProcess 10. See PN100A for characteristics.Absolute Maximum Ratings* TA = 25C unless otherwise notedSymbol Parameter Value UnitsVCEO Collector-
0.2. bc546b bc547a-b-c bc548b-c.pdf Size:72K _onsemi
BC546B, BC547A, B, C,BC548B, CAmplifier TransistorsNPN SiliconFeatureshttp://onsemi. com Pb-Free Packages are Available*COLLECTOR1MAXIMUM RATINGS2BASERating Symbol Value UnitCollector — Emitter Voltage VCEO VdcBC546 653BC547 45EMITTERBC548 30Collector — Base Voltage VCBO VdcBC546 80BC547 50BC548 30TO-92Emitter — Base Voltage VEBO 6.0 VdcCASE 2
com Pb-Free Packages are Available*COLLECTOR1MAXIMUM RATINGS2BASERating Symbol Value UnitCollector — Emitter Voltage VCEO VdcBC546 653BC547 45EMITTERBC548 30Collector — Base Voltage VCBO VdcBC546 80BC547 50BC548 30TO-92Emitter — Base Voltage VEBO 6.0 VdcCASE 2
0.3. bc546abk bc547abk bc548abk bc549abk bc546bbk bc547bbk bc548bbk bc549bbk bc546cbk bc547cbk bc548cbk bc549cbk.pdf Size:81K _diotec
BC546xBK … BC549xBKBC546xBK … BC549xBKGeneral Purpose Si-Epitaxial Planar TransistorsNPN NPNSi-Epitaxial Planar-Transistoren fr universellen EinsatzVersion 2009-12-030.1Power dissipation Verlustleistung 500 mW4.6Plastic case TO-92Kunststoffgehuse (10D3)Weight approx. Gewicht ca. 0.18 gC B EPlastic material has UL classification 94V-0Gehusematerial
Импортные и отечественные аналоги
Из представленной выше информации видно, что транзисторы BC546-550 различаются по допустимым величинам напряжений и имеют хотя не одинаковые, но близкие показатели коэффициента шума. Остальные электрические параметры и типовые характеристики у них идентичны.
Остальные электрические параметры и типовые характеристики у них идентичны.
Среди транзисторов российского производства наиболее близким к этой группе можно считать КТ3102, который имеет такой же корпус и цоколевку, но более высокий коэффициент усиления (КТ3102Г, Е).
В таблице приведены пригодные для замены BC547 n-p-n транзисторы (в корпусе ТО-92) и их основные параметры.
| Тип | VCEO, В | IC, мA | PC, мВт | hFE | fT, МГц | Цоколевка (слева направо) |
|---|---|---|---|---|---|---|
| BC547 | 50 | 100 | 500 | 110-800 | 300 | кбэ |
| Отечественное производство | ||||||
| КТ3102 | 20-50 | 100 | 250 | 100-1000 | от 150 | + (кбэ) |
| Импорт | ||||||
| BC171 | 45 | 100 | 350 | 120-800 | 150 | + (кбэ) |
| BC182 | 50 | 100 | 350 | 120-500 | 100 | + (кбэ) |
| BC237 | 45 | 100 | 500 | 120-460 | 100 | + (кбэ) |
| BC414 | 45 | 100 | 300 | 120-800 | 200 | + (кбэ) |
| BC447 | 80 | 300 | 625 | 50-460 | от 100 | + (кбэ) |
| BC550 | 45 | 200 | 500 | 110-800 | 300 | + (кбэ) |
| 2SC2474 | 30 | 100 | 310 | 20 | 2000 | + (кбэ) |
| 2SC828A | 45 | 100 | 400 | 130-520 | 220 | — (экб) |
| 2SC945 | 50 | 100 | 250 | 150-450 | от 150 | — (экб) |
Примечания:
- У КТ3102 значения VCEO и hFE зависит от буквы, следующей за последней цифрой.

- В последнем столбце знак «+» означает совпадение порядка следования выводов с BC547, знак «-» – различие.
- Параметры транзисторов указанные в таблице взяты из производителя.
Аналоги
Для замены подойдут транзисторы кремниевые, со структурой NPN, эпитаксиально-планарные, для применения в быстродействующих импульсных и высокочастотных устройствах в аппаратуре общего назначения.
Отечественное производство
| Модель | PC | UCB | UCE | UBE | IC | TJ | fT | CC | hFE | Корпус |
|---|---|---|---|---|---|---|---|---|---|---|
| C3198 | 0,625 | 60 | 50 | 5 | 0,15 | 150 | 80 | 3,5 | 25…700 | TO-92 |
| КТ604А/Б | 0,8 | 300 | 250 | 5 | 0,2 | 150 | 40 | ≤ 7 | 10…120 | TO-92 |
| КТ608А/Б | 0,8 | 60 | 60 | 4 | 0,4 | 150 | 200 | ≤ 15 | 20…160 | TO-92 |
| КТ611А/Б/В/Г | 0,8 | 200 | 180 | 4 | 0,1 | 150 | ≥ 60 | ≤ 5 | 10…120 | TO-8 |
| КТ6110 | 0,625 | 40 | 20 | 5 | 0,5 | 150 | — | — | 60…200 | TO-92 |
| КТ6111 | 0,45 | 50 | 45 | 5 | 0,1 | 150 | 150 | 3,5 | 60…1000 | TO-92 |
| КТ6117А/Б | 0,625 | 180 | 160 | 15 | 0,6 | 150 | 100 | ≤ 6 | 60…250 | TO-92 |
| КТ6137 | 0,625 | 60 | 40 | 6 | 0,2 | 150 | 300 | 4 | 100…300 | TO-92 |
| КТ660А/Б | 0,5 | 50/30 | 5 | 0,8 | 150 | 200 | ≤ 10 | 110…450 | TO-92 | |
| К125НТ1 | 0,4 | 45 | 4 | 0,4 | — | — | 15 | 10…150 | Транзисторная сборка |
Зарубежное производство
| Модель | PC | UCB | UCE | UBE | IC | TJ | fT | CC | hFE | Корпус |
|---|---|---|---|---|---|---|---|---|---|---|
| C3198 | 0,625 | 60 | 50 | 5 | 0,15 | 150 | 80 | 3,5 | от 25 до 700 | TO-92 |
| 2SA1246 | 0,4 | 60 | 50 | 15 | 0,15 | 150 | 100 | 9 | 100 | TO-92 |
| 2SC1815 | 0,4 | 60 | 50 | 5 | 0,15 | 175 | 80 | 3,5 | ≥ 70 | TO-92 |
| 2SC3331 | 0,5 | 60 | 50 | 6 | 0,2 | 150 | 200 | 3 | ≥ 100 | TO-92 |
| 2SC3382 | 0,4 | 60 | 50 | 6 | 0,2 | 150 | 250 | 2,7 | ≥ 100 | TO-92 |
| KTC3199 | 0,4 | 50 | 50 | 5 | 0,15 | 150 | 80 | 2 | 270 | TO-92S |
| 2N6428/A | 0,625 | 60 | 50 | 6 | 0,2 | 150 | 100 | — | 100 | TO-92 |
| 2SC5343T | 0,625 | 60 | 50 | — | 0,15 | — | 80 | — | 70 | TO-92 |
| 3DG1318 | 0,625 | 60 | 50 | 7 | 0,5 | 150 | 200 | — | 85 | TO-92 |
| BC431 | 0,625 | 60 | — | 5 | 0,5 | 150 | 100 | — | 63 | TO-92 |
| BC445A | 0,625 | 60 | 60 | 6 | 0,2 | 150 | 100 | — | 120 | TO-92 |
| BC547BA3 | 0,625 | 60 | 50 | 6 | 0,2 | 150 | 100 | — | 200 | TO-92 |
| BTC945A3 | 0,625 | 60 | 50 | 5 | 0,2 | 150 | 150 | — | 135 | TO-92 |
| DTD113Z | 0,625 | 60 | 50 | — | 0,5 | 150 | 200 | — | 200 | TO-92 |
| DTD143E | 0,625 | 60 | 50 | 5 | 0,5 | 150 | 200 | — | 47 | TO-92, SOT-23, SOT-323 |
| FTC1318 | 0,625 | 60 | 50 | 7 | 0,5 | 150 | 200 | — | 85 | TO-92 |
| h2420 | 0,625 | 60 | 60 | 7 | 0,2 | 150 | 150 | — | 70 | TO-92 |
| KSP8098 | 0,625 | 60 | 60 | 6 | 0,5 | 150 | 150 | — | 100 | TO-92 |
| KTC1815 | 0,625 | 60 | 50 | 5 | 0,15 | 150 | 80 | — | 70 | TO-92 |
| KTC945/B | 0,625 | 60 | 50 | 5 | 0,15 | 150 | 300 | — | 90/70 | TO-92 |
| STS5343 | 0,625 | 60 | 50 | 5 | 0,15 | 150 | 80 | — | 120 | TO-92 |
| TEC9014A/B | 0,625 | 60 | 50 | 5 | 0,15 | 150 | 150 | — | 60/100 | TO-92 |
Примечание: данные таблиц получены из даташит компаний-производителей.
Аналоги
Транзистор BC557 можно заменить на BC556 , BC560
Новейшее из новостей
Конкурс персональных сайтов среди учителей БСОШ №1.
Admin 11 Апр 2019 Просмотров:453 КОНКУРС САЙТОВ 2019
Видео для подготовки к ЕГЭ
Единый Государственный Экзамен по информатике и ИКТ в 2019 году Видео для подготовки к ЕГЭ: При подготовке данного метериала были использованы ресурсы: Информатика. Видеоуроки. Подготовка к ЕГЭ(Ч.1 и Ч.2).
Admin 26 Ноя 2018 Просмотров:292 ‘Подготовка к ЕГЭ (11 класс)
Задания на ЕГЭ в 2019 году
Единый Государственный Экзамен по информатике и ИКТ в 2019 году Задания по категориям: При подготовке данного метериала были использованы ресурсы: https://inf-ege.sdamgia.ru – РЕШУ ЕГЭ. Информатика. Видеоуроки. Подготовка к ЕГЭ(Ч.1 и Ч.2).
Admin 26 Ноя 2018 Просмотров:274 ‘Подготовка к ЕГЭ (11 класс)
Как узнать сколько знаков в тексте Word?
Как узнать сколько знаков в тексте Word? Когда требуется написание текста определенного объема, нужно периодически узнавать сколько знаков уже написано в текстовом документе Word. Многие пользователи не знают как это.
Многие пользователи не знают как это.
Admin 07 Ноя 2018 Просмотров:1005 КОМПЬЮТЕРы
Как в ворде вставить формулу суммы?
Как в ворде вставить формулу суммы? Несмотря на то, что Microsoft Word является текстовым редактором таблицы в нем встречаются довольно часто. А таблицы, как правило, состоят из числовых значений, которые зачастую.
Admin 07 Ноя 2018 Просмотров:1298 КОМПЬЮТЕРы
BC547BP Datasheet (PDF)
8.1. bc547b bc547c.pdf Size:60K _st
BC547BBC547CSMALL SIGNAL NPN TRANSISTORSOrdering Code Marking Package / ShipmentBC547B BC547B TO-92 / BulkBC547B-AP BC547B TO-92 / AmmopackBC547C BC547C TO-92 / BulkBC547C-AP BC547C TO-92 / Ammopack SILICON EPITAXIAL PLANAR NPNTRANSISTORS TO-92 PACKAGE SUITABLE FORTHROUGH-HOLE PCB ASSEMBLYTO-92 TO-92 BC547B — THE PNP COMPLEMENTARYBulk AmmopackTYPE IS BC557BAP
8.2. bc547 bc547a bc547b bc547c.pdf Size:26K _fairchild_semi
Discrete POWER & SignalTechnologiesBC547BC547ABC547BBC547CE TO-92BCNPN General Purpose AmplifierThis device is designed for use as general purpose amplifiersand switches requiring collector currents to 300 mA. Sourced fromProcess 10. See PN100A for characteristics.Absolute Maximum Ratings* TA = 25C unless otherwise notedSymbol Parameter Value UnitsVCEO Collector-
Sourced fromProcess 10. See PN100A for characteristics.Absolute Maximum Ratings* TA = 25C unless otherwise notedSymbol Parameter Value UnitsVCEO Collector-
8.3. bc547ba3.pdf Size:412K _cystek
Spec. No. : C204A3 Issued Date : 2015.01.23 CYStech Electronics Corp.Revised Date : Page No. : 1 / 7 General Purpose NPN Epitaxial Planar Transistor BC547BA3Description The BC547BA3 is designed for use in driver stage of AF amplifier and low speed switching. Complementary to BC557BA3. Pb-free package Symbol Outline BC547BA3 TO-92 BBase CCollector
8.4. bc546abk bc547abk bc548abk bc549abk bc546bbk bc547bbk bc548bbk bc549bbk bc546cbk bc547cbk bc548cbk bc549cbk.pdf Size:81K _diotec
BC546xBK … BC549xBKBC546xBK … BC549xBKGeneral Purpose Si-Epitaxial Planar TransistorsNPN NPNSi-Epitaxial Planar-Transistoren fr universellen EinsatzVersion 2009-12-030.1Power dissipation Verlustleistung 500 mW4.6Plastic case TO-92Kunststoffgehuse (10D3)Weight approx. Gewicht ca. 0.18 gC B EPlastic material has UL classification 94V-0Gehusematerial
Gewicht ca. 0.18 gC B EPlastic material has UL classification 94V-0Gehusematerial
Предельно допустимые значения
В таблице указаны величины параметров транзистора, при превышении каждого из которых производитель не гарантирует не только соблюдения цифр, указанных в следующей таблице и выполнения функциональных зависимостей, приведенных в графиках, но и целостности самой детали.
| Обозначение | Параметр | Значение | |
|---|---|---|---|
| VCBO | Напряжение коллектор-база, В | BC546 | 80 |
| (UCB max) | BC547/550 | 50 | |
| BC548/549 | 30 | ||
| VCEO | Напряжение коллектор-эмиттер, В | BC546 | 65 |
| (UCE max) | BC547/550 | 45 | |
| BC548/549 | 30 | ||
| VEBO (UEB max) | Напряжение эмиттер-база (обратное), В | BC546/547 | 6 |
| BC548-550 | 5 | ||
| IC (ICmax) | Ток коллектора, А | 0,1 | |
| PC (PC max) | Рассеиваемая мощность, Вт | 0,5 | |
| Tj (tjmax) | Температура кристалла, °С | 150 | |
| Tstg | Температура хранения, °С | -65…+150 |
Технические характеристики
Транзисторы КТ361 распределены по параметрам группам усиления и отличаются между собой преимущественно такими основными характеристиками: максимальное постоянное напряжения между выводами К-Э, К-Б (при RБЭ=10 кОм) от 20 до 50 В; статическим коэффициентом передачи тока (H21Э) от 20 до 350. При этом разброс возможного H21Э, даже в одинаково промаркированных устройствах, может значительно варьироваться. У них также разные напряжения между К-Э от 10 до 60 В, при обратном токе К-Э не более 1 мА. Другие значения параметров похожие и являются типовыми для всего семейства.
При этом разброс возможного H21Э, даже в одинаково промаркированных устройствах, может значительно варьироваться. У них также разные напряжения между К-Э от 10 до 60 В, при обратном токе К-Э не более 1 мА. Другие значения параметров похожие и являются типовыми для всего семейства.
Предельно допустимые
Рассмотрим предельно допустимые параметры, характерные для серии КТ361:
- напряжение между выводами Б-Э до 4В;
- ток коллектора до 50мА;
- мощность рассеивания: 150мВт, если Т>+100оС до 30мВт;
- температуры: кристалла до 120 оС; окружающей среды – 60…+100 оС;
- статический потенциал до 200 В.
При повышении нагрева устройства свыше +100 оС отдельные параметры ухудшаются. Особенно это сильно влияет на мощность рассеивания.
Типовые электрические
К типовым электрическим параметрам у КТ361 относятся:
- граничная частота по H21Э (если UKЭ=10 В и IЭ=5 мА) более 250 МГц;
- обратные токи: между К-Э (при RБЭ=10 кОм и максимальном UKЭ) до 1 мкА; коллектора (при UKБ=10В) до 1 мкА;
- возможная емкость перехода на коллекторе-7.
 .9 пФ;
.9 пФ; - статический коэффициент усиления H21Э от 20 до 350.
Исходя из вышесказанного, КТ361 можно отнести к высокочастотным полупроводниковым триодам p-n-p-структуры малой мощности. В таблице представлены основные значения наиболее распространенных его групп.
Особенности работы
Из-за специфичной эпитаксиально-планарной технологии изготовления, КТ361 получился не столь хорош, как его «старший брат» КТ315. К основным его недостаткам можно отнести:
- большой разброс значений H21Э;
- в два раза меньший предельно допустимый коллекторный ток;
- внезапно появляющиеся/пропадающие шумы.
Вместе эти транзисторы выгодней использовать при IК в районе 20…30 мА, в этот момент H21Э у них самый высокий. Но при одинаковых условиях и режимах эксплуатации КТ 361 выходит из строя быстрее. Как следствие альтернативу ему приходится искать чаще. Но многое зависит от схемы и её назначения.
Аналоги
Импортные аналоги для кт361 обычно подбирают из следующих устройств: BC556, 2N3905, BC557, BC308A, BC327, SS9012, 2N3906, Из отечественных в качестве замены можно рассмотреть: КТ3107, КТ502. В SMD-корпусе импортные ВС857, ВС858 и российский или белорусский КТ3129.
В SMD-корпусе импортные ВС857, ВС858 и российский или белорусский КТ3129.
Маркировка
Первоначальная кодовая маркировка пластиковой упаковки КТ-13 состояла всего из одного символа, размещенного прямо по центру. Она могла запутать многих радиолюбителей, так как в начальный период производства (с 1967 г.) уже были похожие изделия в аналогичном исполнении, но с другими параметрами.
Поэтому с 1971г. обозначение группы коэффициента усиления по току у КТ361, состоящее всего из одной буквы, стали наносить посередине корпуса. Чуть ниже — дату выпуска. Данный транзистор легко отличить от КТ315, групповая принадлежность которого указана в левом верхнем углу на пластике. Таким образом, производители продолжают делать и сейчас.
Транзисторы в корпусе КТ-26 имеют полную цифро-буквенную маркировку и их идентификация обычно не вызывает трудностей.
Биполярный транзистор BC547C — описание производителя. Основные параметры. Даташиты.
Наименование производителя: BC547C
Тип материала: Si
Полярность: NPN
Максимальная рассеиваемая мощность (Pc): 0. 5
5
W
Макcимально допустимое напряжение коллектор-база (Ucb): 50
V
Макcимально допустимое напряжение коллектор-эмиттер (Uce): 45
V
Макcимально допустимое напряжение эмиттер-база (Ueb): 6
V
Макcимальный постоянный ток коллектора (Ic): 0.1
A
Предельная температура PN-перехода (Tj): 150
°C
Граничная частота коэффициента передачи тока (ft): 200
MHz
Ёмкость коллекторного перехода (Cc): 4.5
pf
Статический коэффициент передачи тока (hfe): 420
Корпус транзистора:
BC547C
Datasheet (PDF)
0.1. bc547b bc547c.pdf Size:60K _st
BC547BBC547CSMALL SIGNAL NPN TRANSISTORSOrdering Code Marking Package / ShipmentBC547B BC547B TO-92 / BulkBC547B-AP BC547B TO-92 / AmmopackBC547C BC547C TO-92 / BulkBC547C-AP BC547C TO-92 / Ammopack SILICON EPITAXIAL PLANAR NPNTRANSISTORS TO-92 PACKAGE SUITABLE FORTHROUGH-HOLE PCB ASSEMBLYTO-92 TO-92 BC547B — THE PNP COMPLEMENTARYBulk AmmopackTYPE IS BC557BAP
0. 2. bc547 bc547a bc547b bc547c.pdf Size:26K _fairchild_semi
2. bc547 bc547a bc547b bc547c.pdf Size:26K _fairchild_semi
Discrete POWER & SignalTechnologiesBC547BC547ABC547BBC547CE TO-92BCNPN General Purpose AmplifierThis device is designed for use as general purpose amplifiersand switches requiring collector currents to 300 mA. Sourced fromProcess 10. See PN100A for characteristics.Absolute Maximum Ratings* TA = 25C unless otherwise notedSymbol Parameter Value UnitsVCEO Collector-
0.3. bc546abk bc547abk bc548abk bc549abk bc546bbk bc547bbk bc548bbk bc549bbk bc546cbk bc547cbk bc548cbk bc549cbk.pdf Size:81K _diotec
BC546xBK … BC549xBKBC546xBK … BC549xBKGeneral Purpose Si-Epitaxial Planar TransistorsNPN NPNSi-Epitaxial Planar-Transistoren fr universellen EinsatzVersion 2009-12-030.1Power dissipation Verlustleistung 500 mW4.6Plastic case TO-92Kunststoffgehuse (10D3)Weight approx. Gewicht ca. 0.18 gC B EPlastic material has UL classification 94V-0Gehusematerial
Другие транзисторы… BC546B
, BC546BP
, BC546VI
, BC547
, BC547A
, BC547AP
, BC547B
, BC547BP
, BC107
, BC547VI
, BC548
, BC548A
, BC548AP
, BC548B
, BC548BP
, BC548C
, BC548CP
.
Принцип работы
Когда на клеммы подается входное напряжение, некоторое количество тока (IB) начинает течь от базы к эмиттеру и управляет током на коллекторе (IC). Напряжение между базой и эмиттером (VBE) для NPN-структуры должно быть прямым. Т.е. на базу прикладывается положительный потенциал, а на эмиттер отрицательный. Полярность напряжения, приложенного к каждому выводу, показана на рисунке ниже.
Входной сигнал усиливается на базе, а затем передается на эмиттер. Меньшее количество тока в базе используется для управления большим, между коллектором и эмиттером (IC).
Когда транзистор открыт, он способен пропускать IC до 100 мА. Этот этап называется областью насыщения. При этом допустимое напряжение между коллектором и эмиттером (VBE) может составлять около 200 мВ,а VBE достигать 900 мВ. Когда ток базы перестает течь, транзистор полностью отключается, эта ступень называется областью отсечки, а VBE будет составлять около 650 мВ.
Электрические параметры
В следующей таблице приведены основные параметры, используемые при расчете электрических схем.
Обратный ток коллектора – обратный ток коллекторногоперехода при свободном (не подключенном никуда) эмиттере. Его наличие приводит к нагреву транзистора. С увеличением температуры быстро растет.
Коэффициент усиления по току – отношение величин коллекторного и базового токов при активном режиме. Его величина определяет способность транзистора к усилению сигналов.
Напряжения насыщения – величина напряжений на p-n переходах транзистора, который находится в состоянии насыщения, то есть оба перехода смещены в прямом направлении (открыты). Такое состояние прибора используется в ключевых схемах.
Граничная частота – частота сигнала, при которой hFE транзистора падает до 1. Обычно приемлемой для работы считается частота 0,1 fT.
Выходная и входная емкости – эквивалентные емкости, являющиеся суммой емкостей Скб и Сбэ. Их величина существенна при работе с сигналами высокой частоты и в переключателях.
Их величина существенна при работе с сигналами высокой частоты и в переключателях.
Коэффициент шума – отношение полной мощности шумов на выходе к ее части, вызываемой тепловыми шумами генератора шума. Параметр играет роль в случае необходимости усиления слабых сигналов. RG – выходное сопротивление источника сигнала.
| Обозначение | Параметр | Условия измерений | Значение | |||
|---|---|---|---|---|---|---|
| Мин. | Тип. | Макс. | ||||
| ICBO | Обратный ток коллектора, nA | VCB =30В, IE =0 | 15 | |||
| hFE (h21) | Коэффициент усиления | VCE =5В, IC =2мА | 110 | 800 | ||
| VCE(sat) (UBEsat) | Напряжение насыщения к-э, мВ | IC=10 мA, IB =0,5мA | 90 | 250 | ||
| IC=100 мA, IB =5мA | 200 | 600 | ||||
| VBE(sat) (UBEsat) | Напряжение насыщения б-э, мВ | IC =10 мA, IB =0,5мA | 700 | |||
| IC =100 мA, IB =5мA | 900 | |||||
| VBE (UBE) | Напряжение б-э (прямое), В | VCE =5 В, IC =2 мA | 580 | 660 | 700 | |
| VCE =5 В, IC =10 мA | 720 | |||||
| fT | Граничная частота, МГц | VCE =5В, IC =10мA, f=100 MГц | 300 | |||
| Cob | Выходная емкость, пФ | VCB =10В, IE =0, f= 1MГц | 3,5 | 6 | ||
| Cib | Входная емкость, пФ | VEB =0,5В, IС =0, f= 1MГц | 9 | |||
| NF (F) | Коэффициент шума, дБ | ВС546-548 | VCE =5В, IC =0,2мA, RG=2кОм, f= 1кГц, Δf=200Гц | 2 | 10 | |
| ВС549, 550 | 1,2 | 4 | ||||
| ВС549 | VCE =5В, IC =0,2мA, RG=2кОм, f= 30-15000 Гц | 1,4 | 4 | |||
| ВС550 | 1,4 | 3 |
Примечания:
- Измерение параметров проводилось при температуре окружающей среды 25° С.
 Предельно допустимые значения указаны для тех же условий.
Предельно допустимые значения указаны для тех же условий. - В первом столбце обеих таблиц в скобках указаны обозначения, принятые в соответствии с ГОСТ 15172-70.
BC547BA3 Datasheet (PDF)
0.1. bc547ba3.pdf Size:412K _cystek
Spec. No. : C204A3 Issued Date : 2015.01.23 CYStech Electronics Corp.Revised Date : Page No. : 1 / 7 General Purpose NPN Epitaxial Planar Transistor BC547BA3Description The BC547BA3 is designed for use in driver stage of AF amplifier and low speed switching. Complementary to BC557BA3. Pb-free package Symbol Outline BC547BA3 TO-92 BBase CCollector
8.1. bc547b bc547c.pdf Size:60K _st
BC547BBC547CSMALL SIGNAL NPN TRANSISTORSOrdering Code Marking Package / ShipmentBC547B BC547B TO-92 / BulkBC547B-AP BC547B TO-92 / AmmopackBC547C BC547C TO-92 / BulkBC547C-AP BC547C TO-92 / Ammopack SILICON EPITAXIAL PLANAR NPNTRANSISTORS TO-92 PACKAGE SUITABLE FORTHROUGH-HOLE PCB ASSEMBLYTO-92 TO-92 BC547B — THE PNP COMPLEMENTARYBulk AmmopackTYPE IS BC557BAP
8. 2. bc547 bc547a bc547b bc547c.pdf Size:26K _fairchild_semi
2. bc547 bc547a bc547b bc547c.pdf Size:26K _fairchild_semi
Discrete POWER & SignalTechnologiesBC547BC547ABC547BBC547CE TO-92BCNPN General Purpose AmplifierThis device is designed for use as general purpose amplifiersand switches requiring collector currents to 300 mA. Sourced fromProcess 10. See PN100A for characteristics.Absolute Maximum Ratings* TA = 25C unless otherwise notedSymbol Parameter Value UnitsVCEO Collector-
8.3. bc546abk bc547abk bc548abk bc549abk bc546bbk bc547bbk bc548bbk bc549bbk bc546cbk bc547cbk bc548cbk bc549cbk.pdf Size:81K _diotec
BC546xBK … BC549xBKBC546xBK … BC549xBKGeneral Purpose Si-Epitaxial Planar TransistorsNPN NPNSi-Epitaxial Planar-Transistoren fr universellen EinsatzVersion 2009-12-030.1Power dissipation Verlustleistung 500 mW4.6Plastic case TO-92Kunststoffgehuse (10D3)Weight approx. Gewicht ca. 0.18 gC B EPlastic material has UL classification 94V-0Gehusematerial
onsemi MJL4281AG Транзистор NPN, 15 А, 350 В, 3-контактный TO-3PBL
Это изображение представляет ассортимент продукции
Посмотреть все Биполярные транзисторы
Доступно для заказа.
Добавить в корзину
Этот продукт в настоящее время недоступен для заказа.
К сожалению, этого товара нет на складе, и в настоящее время он недоступен для заказа.
tickДобавлено
Посмотреть корзину
Цена за штуку (в тубе 25 шт.)
PHP312.306
(EXC. NAC)
PHP349.783
(INC. НДС)
| на душу. PHP312.306 | PHP7,807.65 | ||
| 50 — 75 | PHP302. 937 937 | PHP7,573.425 | |
| 100 — 225 | PHP293.849 | PHP7,346.225 | |
| 250 — 475 | 285.034 филиппинских песо | PHP7,125.85 | |
| 500 + | PHP276.483 | PHP6,912.075 | |
| *price indicative | |||
- RS Stock No.:
- 100-7570
- Mfr.
 Часть №:
Часть №: - MJL4281AG
- Производитель:
- ONSEMI
- COO (Страна происхождения):
- CZ
Технические данные.0113
- docZipSchematic Symbol & PCB Footprint
Legislation and Compliance
- COO (Country of Origin):
- CZ
Product Details
NPN Power Transistors, ON Semiconductor
Стандарты
Номера деталей производителя с префиксом NSV соответствуют автомобильным требованиям стандарта AEC-Q101.
Технические характеристики
| Attribute | Value |
| Transistor Type | NPN |
| Maximum DC Collector Current | 15 A |
| Maximum Collector Emitter Voltage | 350 V |
| Package Тип | TO-3PBL |
| Тип монтажа | Сквозное отверстие |
| Максимальная рассеиваемая мощность | 230 Вт |
| Transistor Configuration | Single |
| Maximum Collector Base Voltage | 350 V |
| Maximum Emitter Base Voltage | 5 V |
| Maximum Operating Frequency | 35 MHz |
| Pin Count | 3 |
| Количество элементов на чип | 1 |
| Размеры | 26,4 x 20,3 x 5,3 мм |
| Максимальная рабочая температура | +150 °C |
Напечатанная на струйной печати растяжимая низковольтная синаптическая матрица транзисторов
. 2019 18 июня; 10 (1): 2676.
2019 18 июня; 10 (1): 2676.
doi: 10.1038/s41467-019-10569-3.
Ф Молина-Лопес
1
2
, ТЗ Гао
3
, У Крафт
4
5
, Чжу
4
, Т Олунд
1
6
, Р Пфаттнер
1
7
, В. Р. Фейг
3
, Ю Ким
4
, С. Ван
1
8
, Ю Юнь
9
, Z Бао
10
Принадлежности
- 1 Факультет химического машиностроения, Стэнфордский университет, 443 Виа Ортега, Стэнфорд, Калифорния, -4125, США.

- 2 Кафедра материаловедения, KU Leuven, Kasteelpark Arenberg 44, 3001, Leuven, Бельгия.
- 3 Факультет материаловедения и инженерии, Стэнфордский университет, 496 Lomita Mall, Стэнфорд, Калифорния, -4034, США.
- 4 Факультет электротехники, Стэнфордский университет, 350 Serra Mall, Стэнфорд, Калифорния, , США.
- 5 Лаборатория Кавендиша, Кембриджский университет, JJ Thomson Avenue, Cambridge, CB3 0HE, UK.
- 6 Факультет естественных наук, Университет Средней Швеции, Holmgatan 10, Sundsvall, 852 30, Швеция.
- 7 Институт материаловедения Барселоны (ICMAB-CISC), Campus de la UAB, 08193, Беллатерра, Испания.

- 8 Институт молекулярной инженерии Чикагского университета, 5640S Ellis Avenue, Чикаго, Иллинойс, 60637, США.
- 9 Передовой технологический институт Samsung, 130 Самсон-ро, Сувон, 16678, Южная Корея. [email protected].
- 10 Факультет химического машиностроения, Стэнфордский университет, 443 Виа Ортега, Стэнфорд, Калифорния, -4125, США. [email protected].
PMID:
31213599
PMCID:
PMC6582140
DOI:
10.1038/s41467-019-10569-3
Бесплатная статья ЧВК
F Молина-Лопес и соавт.
Нац коммун.
.
Бесплатная статья ЧВК
. 2019 18 июня; 10 (1): 2676.
doi: 10.1038/s41467-019-10569-3.
Авторы
Ф Молина-Лопес
1
2
, ТЗ Гао
3
, У Крафт
4
5
, Чжу
4
, Т Олунд
1
6
, Р Пфаттнер
1
7
, В. Р. Фейг
3
, Ю Ким
4
, С. Ван
Ван
1
8
, Ю Юнь
9
, З Бао
10
Принадлежности
- 1 Факультет химического машиностроения, Стэнфордский университет, 443 Виа Ортега, Стэнфорд, Калифорния, -4125, США.
- 2 Кафедра материаловедения, KU Leuven, Kasteelpark Arenberg 44, 3001, Leuven, Бельгия.
- 3 Факультет материаловедения и инженерии, Стэнфордский университет, 496 Lomita Mall, Стэнфорд, Калифорния, -4034, США.
- 4 Факультет электротехники, Стэнфордский университет, 350 Serra Mall, Стэнфорд, Калифорния, , США.
- 5 Кавендишская лаборатория, Кембриджский университет, Дж.
 Дж. Томсон-авеню, Кембридж, CB3 0HE, Великобритания.
Дж. Томсон-авеню, Кембридж, CB3 0HE, Великобритания. - 6 Факультет естественных наук, Университет Средней Швеции, Holmgatan 10, Sundsvall, 852 30, Швеция.
- 7 Институт материаловедения Барселоны (ICMAB-CISC), Campus de la UAB, 08193, Беллатерра, Испания.
- 8 Институт молекулярной инженерии Чикагского университета, 5640S Ellis Avenue, Чикаго, Иллинойс, 60637, США.
- 9 Передовой технологический институт Samsung, 130 Самсон-ро, Сувон, 16678, Южная Корея. [email protected].
- 10 Факультет химического машиностроения, Стэнфордский университет, 443 Виа Ортега, Стэнфорд, Калифорния, -4125, США.
 [email protected].
[email protected].
PMID:
31213599
PMCID:
PMC6582140
DOI:
10.1038/с41467-019-10569-3
Абстрактный
Носимая электроника и электроника для кожи извлекают выгоду из механически мягких и растяжимых материалов, чтобы соответствовать изогнутым и динамическим поверхностям, тем самым обеспечивая бесшовную интеграцию с человеческим телом. Однако такие материалы сложно обрабатывать с использованием традиционных методов микроэлектроники. Здесь растягиваемые массивы транзисторов формируются исключительно из раствора путем струйной печати полимеров и углеродных нанотрубок. Аддитивная, бесконтактная и безмасочная природа струйной печати обеспечивает простой, недорогой и масштабируемый способ укладки этих химически чувствительных материалов и нанесения рисунка на большие площади. Транзисторы, стабильные в условиях окружающей среды, демонстрируют подвижность до 30 см 2 В -1 s -1 и токи на ширину канала 0,2 мА см -1 при рабочем напряжении до 1 В из-за ионного характера их печатного диэлектрика затвора. Кроме того, эти транзисторы с двухслойным емкостным диэлектриком могут имитировать синаптическое поведение нейронов, что делает их интересными для конформных интерфейсов мозг-машина и другой носимой биоэлектроники.
Транзисторы, стабильные в условиях окружающей среды, демонстрируют подвижность до 30 см 2 В -1 s -1 и токи на ширину канала 0,2 мА см -1 при рабочем напряжении до 1 В из-за ионного характера их печатного диэлектрика затвора. Кроме того, эти транзисторы с двухслойным емкостным диэлектриком могут имитировать синаптическое поведение нейронов, что делает их интересными для конформных интерфейсов мозг-машина и другой носимой биоэлектроники.
Заявление о конфликте интересов
Авторы заявляют об отсутствии конкурирующих интересов.
Цифры
Рис. 1
Общая концепция и конструкция. а…
Рис. 1
1
Общая концепция и конструкция. a Эскиз внутренне растягиваемой матрицы транзисторов, представляющей…
рисунок 1
Общая концепция и дизайн. a Эскиз внутренне растягиваемой матрицы транзисторов, показывающий, как каждый активный материал транзистора был аддитивно изготовлен с использованием одного и того же метода струйной (IJ) печати. Эти материалы использовались для формирования: электродов истока (S), стока (D) и затвора (G), межсоединений истока и стока, диэлектрика затвора, канала и сквозных герметизирующих переходных отверстий. Штриховая линия соответствует месту поперечного сечения, показанному на рис. 9.0444 б . б Эскиз поперечного сечения устройства, где промаркирован материал каждого слоя. c Изображение массива транзисторов IJ, напечатанное на большой площади и изогнутое над рукой
Рис. 2
2
Детальное изготовление струйной…
Рис. 2
Детальное изготовление растяжимого однослойного полевого транзистора из углеродных нанотрубок (SWCNT-FET), напечатанного методом струйной печати (IJ)…
Рис. 2
Детальное изготовление массивов растяжимых однослойных полевых транзисторов из углеродных нанотрубок (SWCNT-FET), напечатанных струйной (IJ) печатью. Этапы процесса пронумерованы и представлены в хронологическом порядке изготовления вместе с упрощенным трехмерным (3D) эскизом или эскизом поперечного сечения. Репрезентативные оптические изображения устройств после некоторых шагов также добавлены для ясности. Топографии амплитуд атомно-силовой микроскопии (АСМ) на вставке в левом нижнем углу рисунка соответствуют шагу №5. На нем показано, как плотность SWCNT (количество трубок на площадь поверхности) сетей полупроводников (SC)-SWCNT, напечатанных IJ, можно легко настроить с помощью количества проходов печати: сеть, полученная в результате 1, 5 и 10 проходов печати на SiO 2 подложка показана после удаления сортирующего полимера. Масштабная линейка = 200 мкм с шагом: 1 (увеличение), 3, 9 и 17. Масштабная линейка = 1 мм с шагом: 1, 10 и 12
Масштабная линейка = 200 мкм с шагом: 1 (увеличение), 3, 9 и 17. Масштабная линейка = 1 мм с шагом: 1, 10 и 12
Рис. 3
Электрические характеристики струйного…
Рис. 3
Электрические характеристики растяжимых полевых транзисторов (FET), напечатанных струйной (IJ) печатью. a Передача…
Рис. 3
Электрические характеристики растяжимых полевых транзисторов (FET), напечатанных струйной (IJ) печатью. a Передаточная кривая и квадратный корень из тока исток-сток √− I ds в зависимости от напряжения на затворе ( В gs ) характерного одностенного полевого транзистора из углеродных нанотрубок, напечатанного методом IJ -ФЭТ). b Карта максимального тока сток-исток (− I ds,max ) в режиме насыщения для каждого полевого транзистора в массиве 5 × 3. Ненанесенные на график устройства не работали. c Выходные характеристики при различных напряжениях затвора. W / L всех устройств были 1000 мкм/50 мкм. d Перекрывающиеся кривые передачи SWCNT-FET, напечатанного IJ, подвергнутого различным условиям деформации вдоль двух основных направлений: перпендикулярно (слева) и параллельно (справа) длине канала. e Карта − I ds,max в режиме насыщения для каждого полевого транзистора в массиве 3 × 2 недеформированных и растянутых на 10% в направлениях, перпендикулярных (perp) и параллельных (para) длине канала. Текущие измерения при растяжении доступны только для некоторых репрезентативных устройств из-за ограничений настройки и потери производительности в результате тяжелого обращения, связанного с экспериментом по растяжению. f Снимки с оптического микроскопа некоторых транзисторов, растянутых при деформации 20% в двух основных направлениях. Пунктирные линии служат для выделения изменения размера растянутых транзисторов по сравнению с эталонным транзистором (0% деформации) в середине.
Ненанесенные на график устройства не работали. c Выходные характеристики при различных напряжениях затвора. W / L всех устройств были 1000 мкм/50 мкм. d Перекрывающиеся кривые передачи SWCNT-FET, напечатанного IJ, подвергнутого различным условиям деформации вдоль двух основных направлений: перпендикулярно (слева) и параллельно (справа) длине канала. e Карта − I ds,max в режиме насыщения для каждого полевого транзистора в массиве 3 × 2 недеформированных и растянутых на 10% в направлениях, перпендикулярных (perp) и параллельных (para) длине канала. Текущие измерения при растяжении доступны только для некоторых репрезентативных устройств из-за ограничений настройки и потери производительности в результате тяжелого обращения, связанного с экспериментом по растяжению. f Снимки с оптического микроскопа некоторых транзисторов, растянутых при деформации 20% в двух основных направлениях. Пунктирные линии служат для выделения изменения размера растянутых транзисторов по сравнению с эталонным транзистором (0% деформации) в середине. Масштабная линейка 1 мм
Масштабная линейка 1 мм
Рис. 4
Синаптическое поведение струйного…
Рис. 4
Синаптическое поведение струйных (IJ) растяжимых полевых транзисторов (FET). a Источник-слив…
Рис. 4
Синаптическое поведение растяжимых полевых транзисторов (FET), напечатанных на струйной (IJ) печати. a Изменение тока исток-сток (Δ I ds , на левой оси) отклик во времени на небольшие импульсы напряжения затвора ( V gs , на правой оси), который имитирует всплески пресинаптического потенциала нейрона для Полевые транзисторы с Вт / L = 1000 мкм/50 мкм. Импульсы состоят из прямоугольного сигнала с амплитудой -80 мВ (помимо начального напряжения смещения -0,6 В, приложенного в течение достаточного времени, чтобы обеспечить полное формирование канала), частотой 25 Гц и рабочим циклом 50 %. Напряжение сток-исток поддерживалось на уровне -1,1 В. Реакция тока исток-сток проверена для последовательных последовательностей 1, 2, 16 (увеличено в 9 раз).0444 b ) и 32 импульса напряжения затвора, демонстрирующие типичное изменение постсинаптического тока, которое увеличивается с количеством импульсов и ослабевает в их отсутствие (чем больше количество импульсов, тем больше время релаксации). b Увеличение части сигнала, ограниченной пунктирной рамкой в a . Пульсации в Δ I ds , наблюдаемые для каждого отдельного импульса всего в −80 мВ, подчеркивают хорошее разрешение устройств по напряжению. c Изменение тока исток-сток (Δ I ds , на левой оси) во времени для тех же устройств при подаче на затвор последовательности импульсов напряжения. Последовательности импульсов имеют рабочий цикл 50% и вводятся таким образом, что каждая последовательность отличается от первой (контрольной) либо: (1) количеством импульсов (40 импульсов для 2-й последовательности против 20 для контрольной).
Напряжение сток-исток поддерживалось на уровне -1,1 В. Реакция тока исток-сток проверена для последовательных последовательностей 1, 2, 16 (увеличено в 9 раз).0444 b ) и 32 импульса напряжения затвора, демонстрирующие типичное изменение постсинаптического тока, которое увеличивается с количеством импульсов и ослабевает в их отсутствие (чем больше количество импульсов, тем больше время релаксации). b Увеличение части сигнала, ограниченной пунктирной рамкой в a . Пульсации в Δ I ds , наблюдаемые для каждого отдельного импульса всего в −80 мВ, подчеркивают хорошее разрешение устройств по напряжению. c Изменение тока исток-сток (Δ I ds , на левой оси) во времени для тех же устройств при подаче на затвор последовательности импульсов напряжения. Последовательности импульсов имеют рабочий цикл 50% и вводятся таким образом, что каждая последовательность отличается от первой (контрольной) либо: (1) количеством импульсов (40 импульсов для 2-й последовательности против 20 для контрольной). ), (2) амплитуда (-80 мВ для 3-й серии по сравнению с -40 мВ для контроля) или (3) частота (50 Гц для 4-й серии по сравнению с 25 Гц для контроля). Ток исток-сток реагирует на все три фактора в соответствии с краткосрочной синаптической пластичностью, т. е. чем больше число импульсов, их амплитуда и период, тем выше вариация производимого тока и тем больше времени требуется для устройств. расслабиться, вернуться к равновесию. Второй набор импульсов с противоположным знаком напряжения генерирует также изменение тока с противоположным знаком, демонстрируя, что устройства способны к симметричному возбуждающему и тормозному постсинаптическому току
), (2) амплитуда (-80 мВ для 3-й серии по сравнению с -40 мВ для контроля) или (3) частота (50 Гц для 4-й серии по сравнению с 25 Гц для контроля). Ток исток-сток реагирует на все три фактора в соответствии с краткосрочной синаптической пластичностью, т. е. чем больше число импульсов, их амплитуда и период, тем выше вариация производимого тока и тем больше времени требуется для устройств. расслабиться, вернуться к равновесию. Второй набор импульсов с противоположным знаком напряжения генерирует также изменение тока с противоположным знаком, демонстрируя, что устройства способны к симметричному возбуждающему и тормозному постсинаптическому току
См. это изображение и информацию об авторских правах в PMC
Похожие статьи
Электроника кожи из масштабируемого изготовления массива транзисторов с возможностью растяжения.
Ван С.
 , Сюй Дж., Ван В., Ван Г.Н., Растак Р., Молина-Лопес Ф., Чанг Дж.В., Ню С., Фейг В.Р., Лопес Дж., Лей Т., Квон С.К., Ким И., Фуде А.М., Эрлих А., Гасперини А, Юнь Ю, Мурманн Б, Ток Дж. Б., Бао З.
, Сюй Дж., Ван В., Ван Г.Н., Растак Р., Молина-Лопес Ф., Чанг Дж.В., Ню С., Фейг В.Р., Лопес Дж., Лей Т., Квон С.К., Ким И., Фуде А.М., Эрлих А., Гасперини А, Юнь Ю, Мурманн Б, Ток Дж. Б., Бао З.
Ван С. и др.
Природа. 2018 март 1 555 (7694):83-88. дои: 10.1038/nature25494. Epub 2018 19 февраля.
Природа. 2018.PMID: 2
34
Высокопроизводительные массивы транзисторов из органической нанопроволоки, полностью обработанные раствором, с узорчатыми электродами, нанесенными методом струйной печати.
Лю Н., Чжоу Ю., Ай Н., Луо С., Пэн Дж., Ван Дж., Пей Дж., Цао Й.
Лю Н и др.
Ленгмюр. 2011 20 декабря; 27 (24): 14710-5. doi: 10.1021/la2033324. Epub 2011 11 ноября.
Ленгмюр. 2011.PMID: 22043855
Электроника, вдохновленная кожей: новая парадигма.

Ван С., О ЧЖИ, Сюй Дж., Тран Х., Бао З.
Ван С. и др.
Acc Chem Res. 2018 15 мая; 51 (5): 1033-1045. doi: 10.1021/acs.accounts.8b00015. Epub 2018 25 апр.
Acc Chem Res. 2018.PMID: 296
Обзор.
Функционализированные органические тонкопленочные транзисторы для биодатчиков.
Ван Н, Ян А, Фу Ю, Ли Ю, Ян Ф.
Ван Н и др.
Acc Chem Res. 2019 19 февраля; 52 (2): 277-287. doi: 10.1021/acs.accounts.8b00448. Epub 2019 8 января.
Acc Chem Res. 2019.PMID: 30620566
Обзор.
Растягивающиеся углеродные нанотрубки, память с плавающим затвором и логические устройства с ловушкой заряда для носимой электроники.
Сон Д., Ку Дж. Х., Сонг Дж. К., Ким Дж., Ли М., Шим Х. Дж., Пак М.
 , Ли М., Ким Дж. Х., Ким Д. Х.
, Ли М., Ким Дж. Х., Ким Д. Х.
Сон Д и др.
АКС Нано. 2015 26 мая; 9(5): 5585-93. doi: 10.1021/acsnano.5b01848. Epub 2015 23 апр.
АКС Нано. 2015.PMID: 25897592
Посмотреть все похожие статьи
Цитируется
Высокая плотность интеграции растяжимых неорганических тонкопленочных транзисторов с превосходными характеристиками и надежностью.
Oh H, Oh JY, Park CW, Pi JE, Yang JH, Hwang CS.
О Х и др.
Нац коммун. 2022 авг 24;13(1):4963. doi: 10.1038/s41467-022-32672-8.
Нац коммун. 2022.PMID: 36002441
Бесплатная статья ЧВК.Вязкоупругий гель-эмульсия металл-в-воде с помощью соединения «хозяин-гость» для печатных и активируемых напряжением растягивающихся электродов.

Ван Ц, Цзи С, Лю С, Лю И, Лян Дж.
Ван Кью и др.
АКС Нано. 2022 4 августа; 16 (8): 12677-85. doi: 10.1021/acsnano.2c04299. Онлайн перед печатью.
АКС Нано. 2022.PMID: 359
Бесплатная статья ЧВК.Обработка импульсных сигналов с несколькими входами, не относящимися к фон Нейману, с помощью искусственного синаптического мультиплексора.
Хо Д.Х., Роу Д.Г., Чой Й.Ю., Ким С., Чой Й.Дж., Ким Д.Х., Джо С.Б., Чо Дж.Х.
Хо Д.Х. и др.
Научная реклама 2022 Июн 24;8(25):eabn1838. doi: 10.1126/sciadv.abn1838. Epub 2022 22 июня.
Научная реклама 2022.PMID: 35731885
Бесплатная статья ЧВК.Аддитивное производство проводящих полимеров: последние достижения, проблемы и возможности.
Криадо-Гонсалес М.
 , Домингес-Альфаро А., Лопес-Ларреа Н., Алегрет Н., Месеррейес Д.
, Домингес-Альфаро А., Лопес-Ларреа Н., Алегрет Н., Месеррейес Д.
Криадо-Гонсалес М. и соавт.
ACS Appl Polym Mater. 2021 11 июня; 3(6):2865-2883. doi: 10.1021/acsapm.1c00252. Epub 2021 1 июня.
ACS Appl Polym Mater. 2021.PMID: 35673585
Бесплатная статья ЧВК.Обзор.
Полностью растяжимые транзисторы из углеродных нанотрубок со стирол-этилен-бутилен-стиролом в качестве диэлектриков затвора, интегрированные с помощью процесса на основе фотолитографии.
Цзяо Х., Чжан М., Ду С., Чжан З., Хуан В., Хуан Ц.
Цзяо Х и др.
RSC Adv. 2020 25 февраля; 10 (14): 8080-8086. дои: 10.1039/c9ra10534d. Электронная коллекция 2020 24 февраля.
RSC Adv. 2020.PMID: 35497813
Бесплатная статья ЧВК.
Просмотреть все статьи «Цитируется по»
использованная литература
Сомея Т.
 , Бао З., Маллиарас Г.Г. Расцвет пластиковой биоэлектроники. Природа. 2016; 540:379–385. дои: 10.1038/nature21004.
, Бао З., Маллиарас Г.Г. Расцвет пластиковой биоэлектроники. Природа. 2016; 540:379–385. дои: 10.1038/nature21004.—
DOI
—
пабмед
Чортос А., Лю Дж., Бао З. В поисках протеза электронной кожи. Нац. Матер. 2016;15:937–950. DOI: 10.1038/nmat4671.
—
DOI
—
пабмед
Ким Дж.
 и др. Эластичная электроника на основе кремниевых нанолент для кожных протезов. Нац. коммун. 2014; 5:1–11.
и др. Эластичная электроника на основе кремниевых нанолент для кожных протезов. Нац. коммун. 2014; 5:1–11.—
пабмед
Васкес-Кинтеро, А., Верпланке, Р., Де Смет, Х. и Ван Флетерен, Дж. Растягивающаяся электронная платформа для применения мягких и интеллектуальных контактных линз. Доп. Матер. Технол. 2, 1700073 (2017).
Цянь Ю и др. Растяжимые органические полупроводниковые устройства. Доп. Матер. 2016;28:9243–9265. doi: 10.1002/adma.201601278.
—
DOI
—
пабмед
Типы публикаций
термины MeSH
вещества
Грантовая поддержка
- P2ELP2_155355/Schweizerischer Nationalfonds zur Förderung der Wissenschaftlichen Forschung (Швейцарский национальный научный фонд)/International
- DE-SC0016523/США Министерство энергетики (DOE)/Международное
Транзистор с крутым наклоном, сочетающий фазовый переход и межполосное туннелирование для достижения коэффициента тела, меньшего единицы
Abstract
Транзисторы с крутым наклоном позволяют уменьшить напряжение питания и энергию на вычисленный бит информации по сравнению с обычными полевыми транзисторами (FET) из-за их подпорогового колебания менее 60 мВ / декада при комнатной температуре. В настоящее время реализуемые подходы к достижению такого субтермионного подпорогового колебания заключаются в альтернативных механизмах инжекции носителей, таких как квантово-механическое межзонное туннелирование (BTBT) в туннельных полевых транзисторах или резкое фазовое изменение в устройствах с переходом металл-изолятор (MIT). Сильные стороны BTBT и MIT были объединены в архитектуре гибридного устройства, называемого туннельным полевым транзистором с фазовым переходом (PC-TFET), в котором резкое MIT в диоксиде ванадия (VO 2 ) снижает подпороговый размах полевых транзисторов на основе нанопроволоки из напряженного кремния. В этой работе мы демонстрируем, что принцип, лежащий в основе низкого размаха в PC-TFET, связан с субъединичным коэффициентом тела, достигаемым за счет внутреннего дифференциального усиления напряжения затвора. Мы изучаем влияние температуры на коэффициент переключения и размах PC-TFET, сообщая о таких низких значениях, как 4,0 мВ/декада при 25 °C, 7,8 мВ/декада при 45 °C.
В настоящее время реализуемые подходы к достижению такого субтермионного подпорогового колебания заключаются в альтернативных механизмах инжекции носителей, таких как квантово-механическое межзонное туннелирование (BTBT) в туннельных полевых транзисторах или резкое фазовое изменение в устройствах с переходом металл-изолятор (MIT). Сильные стороны BTBT и MIT были объединены в архитектуре гибридного устройства, называемого туннельным полевым транзистором с фазовым переходом (PC-TFET), в котором резкое MIT в диоксиде ванадия (VO 2 ) снижает подпороговый размах полевых транзисторов на основе нанопроволоки из напряженного кремния. В этой работе мы демонстрируем, что принцип, лежащий в основе низкого размаха в PC-TFET, связан с субъединичным коэффициентом тела, достигаемым за счет внутреннего дифференциального усиления напряжения затвора. Мы изучаем влияние температуры на коэффициент переключения и размах PC-TFET, сообщая о таких низких значениях, как 4,0 мВ/декада при 25 °C, 7,8 мВ/декада при 45 °C. Мы обсудим, как уникальные характеристики PC-TFET открывают новые перспективы, помимо полевых транзисторов и других транзисторов с крутым наклоном, для маломощной электроники, аналоговых схем и нейроморфных вычислений.
Мы обсудим, как уникальные характеристики PC-TFET открывают новые перспективы, помимо полевых транзисторов и других транзисторов с крутым наклоном, для маломощной электроники, аналоговых схем и нейроморфных вычислений.
Введение
Комплементарная технология металл-оксид-полупроводник (КМОП) уже несколько десятилетий является основой микро/наноэлектроники. В деннардовскую эпоху масштабирования МОП-транзисторов чрезвычайные улучшения с точки зрения скорости переключения, плотности устройств, функциональности и стоимости были достигнуты за счет аддитивного применения нескольких технологических ускорителей, таких как проектирование подложек, деформация, многозатвор, high-k/metal. стеки ворот и высокомобильные материалы каналов. Однако концепция полевого транзистора металл-оксид-полупроводник (MOSFET) осталась неизменной. В последнее время агрессивное масштабирование размеров затвора до нескольких десятков нанометров сталкивается с серьезными проблемами с точки зрения изменчивости процесса, высокой мощности утечки, немасштабируемого напряжения питания и ухудшенных коэффициентов переключения тока 1 .
Поиск нового переключателя, выходящего за пределы КМОП, направленный на решение проблемы масштабирования мощности утечки и напряжения, включает в себя новые концепции устройств и материалы, способные дополнять МОП-транзисторы и интегрироваться в передовые КМОП-платформы 2, 3 . Основной целью является снижение подпорогового колебания СС (= dV
г / г бревно I
d ), который в обычном полевом МОП-транзисторе ограничен 60 мВ/декада при комнатной температуре ( T = 300 K) за счет механизма инжекции термоэмиссионных носителей 4 . Переключатель с крутым наклоном, с SS < 60 мВ/декада, позволит снизить напряжение питания и обеспечить будущие вычисления с низким энергопотреблением 5 . Для этой цели были предложены различные принципы устройств с крутым наклоном, использующие отрицательную емкость 6 , подвижные электромеханические затворы 7 , ударную ионизацию 8 и туннельные полевые транзисторы (TFET) на основе -полосное туннелирование 9 (БТБТ). TFET в настоящее время считается наиболее многообещающим твердотельным переключателем с крутым наклоном среди альтернативных технологий, с экспериментально продемонстрированными значениями порядка 30 мВ/декаду при комнатной температуре 10 , в основном ограниченными диапазоном малых токов. Однако механизм туннельной проводимости ограничивает производительность устройства по току «включено», I
TFET в настоящее время считается наиболее многообещающим твердотельным переключателем с крутым наклоном среди альтернативных технологий, с экспериментально продемонстрированными значениями порядка 30 мВ/декаду при комнатной температуре 10 , в основном ограниченными диапазоном малых токов. Однако механизм туннельной проводимости ограничивает производительность устройства по току «включено», I
на и частоту работы.
Недавно материалы с фазовым переходом, такие как коррелированные функциональные оксиды, были предложены в качестве многообещающего решения для КМОП-электроники. Внешнее возбуждение, применяемое к материалам с фазовым переходом, может вызвать фазовый переход, сопровождающийся резким изменением их свойств проводимости 11,12,13,14,15,16,17,18,19 . Одним из наиболее изученных материалов с фазовым переходом является диоксид ванадия (VO 2 ), который демонстрирует переход металл-изолятор (MIT), соответствующий структурному фазовому переходу при критической температуре T
MIT (340 K в массе VO 2 20,21,22 ). При повышении температуры ВО 2 выше Т
При повышении температуры ВО 2 выше Т
MIT , материал переходит из моноклинной фазы в тетрагональную структуру рутила одновременно с закрытием энергетической щели Е
g ≈ 0,6 эВ в 3d-зоне проводимости и резкое падение удельного сопротивления, до 5 порядков в объеме VO 2 . При понижении температуры VO 2 переход обратно в моноклинную фазу наблюдается при значениях ниже T
MIT , что приводит к возникновению гистерезиса, ширина которого зависит от качества материала. VO 2 обладает большим потенциалом для электроники, выходящей за рамки КМОП, поскольку ПМИ может быть индуцирован электрическим возбуждением, что позволяет использовать приложения, основанные на энергозависимом резистивном переключении. ВО 2 Переключатель MIT на основе в 2-контактной конфигурации демонстрирует интересные свойства, такие как резкое увеличение тока при подаче напряжения 23, 24, 25, 26, 27, 28, 29, 30, 31 , быстрое время переключения 32, 33,34 , высокая надежность 35, 36 , отрицательное дифференциальное сопротивление 37,38,39,40 , мемристивное переключение 41, 42 и низкотемпературная зависимость динамики перехода 43, 44 . Однако основным недостатком 2-контактного переключателя MIT является относительно высокий ток утечки я
Однако основным недостатком 2-контактного переключателя MIT является относительно высокий ток утечки я
OFF из-за малой ширины запрещенной зоны VO 2 в изолирующем состоянии. Хотя эта проблема может быть смягчена легированием VO 2 45 , наиболее эффективным решением будет разработка 3-выводных переключателей, в которых канал VO 2 выполняет управляемое затвором изменение фазы. Сначала была предпринята попытка разработки такого устройства со стандартными структурами MOSFET с использованием VO 2 в качестве полупроводникового материала 46 , но наблюдаемая модуляция проводимости напряжением затвора была ограничена небольшим процентом 47,48,49,50 . Это стимулировало исследование использования электролитного затвора для получения очень сильных электрических полей на границе между VO 2 и ионной жидкостью 51, 52 , вызывая более высокую модуляцию проводимости канала из-за создания кислородных вакансий 53, 54,55 или протонирование 56 , но с более медленным временем переключения 57, 58 .
Чтобы преодолеть эти проблемы, был предложен туннельный полевой транзистор с фазовым переходом (PC-TFET) 59 в качестве гибридной конструкции, объединяющей туннельный полевой транзистор и двухконтактный переключатель MIT, сочетающий сильные стороны двух устройств. и в результате появился первый полупроводниковый VO 2 на базе 3-контактного коммутатора с одновременным очень низким I
ВЫКЛ ток, высокий I
НА / И
OFF и сверхкрутое подпороговое колебание (рис. 1a), характеристики, которые не могут быть достигнуты по отдельности с помощью TFET или переключателя MIT. Передаточные характеристики PC-TFET качественно сравниваются с характеристиками TFET, используемого в качестве составной части на рис. 1b. Основной принцип работы PC-TFET заключается в обратной связи (путем соответствующего соединения затвора или истока) сверхрезкого переключения материала MIT в характеристику TFET, используемую для блокировки тока в выключенном состоянии. Изменение фазы в переключателе МИП соответствует напряжению срабатывания В
Изменение фазы в переключателе МИП соответствует напряжению срабатывания В
действует (настраивается конструкцией компонента MIT), позволяя переключаться из состояния с высоким сопротивлением в состояние с низким сопротивлением, в котором ток соответствует передаточной характеристике TFET. Для идеальной производительности V
действие двухконтактного переключателя MIT должно быть согласовано с пороговым напряжением TFET В
th (определяется методом постоянного тока). На рисунках 1a и b также показано результирующее гистерезисное поведение PC-TFET, унаследованное от его компонента MIT. В этой работе мы подробно обсуждаем принцип PC-TFET, его интеграцию и метод извлечения фактора тела. Кроме того, мы дополнительно характеризуем PC-TFET, чтобы обсудить его температурную зависимость и возможные применения для аналоговых схем и нейроморфных вычислений.
Рисунок 1
Сравнение трех переключателей с крутым наклоном: TFET, MIT и предлагаемого PC-TFET. ( a ) Передаточные характеристики для PC-TFET и других переключателей с крутым наклоном (TFET, переключатель MIT), обеспечивающих более низкий подпороговый размах, чем у MOSFET. ( b ) Характеристики PC-TFET для различных значений порогового напряжения переключателя MIT В
( a ) Передаточные характеристики для PC-TFET и других переключателей с крутым наклоном (TFET, переключатель MIT), обеспечивающих более низкий подпороговый размах, чем у MOSFET. ( b ) Характеристики PC-TFET для различных значений порогового напряжения переключателя MIT В
акт , по сравнению с передаточными характеристиками компонента TFET с пороговым напряжением В
-й -й. Площади гистерезиса для трех различных значений V
и выделены заштрихованными областями.
Изображение полного размера
Результаты
Гибридный PC-TFET: принцип
Принцип работы гибридного устройства PC-TFET для крутых наклонов заключается в одновременном использовании двух физических механизмов для снижения подпороговых коэффициентов качания m и n 9{n}$$
(1)
, в то время как использование междиапазонного туннелирования по своей сути предлагает простое решение потенциально ниже 60 мВ/декада n -фактора для снижения м , в В отличие от любых других предыдущих отчетов, мы не используем никакого принципа отрицательной емкости, а используем простую схемную технику, использующую резкое переключение в 2-выводном устройстве MIT, подключенном к делителю напряжения, помещенному в затвор или в исток TFET. Стоит отметить, что снижение фактора тела, м , TFET ниже 1, соответствует менее изученному подходу (ранее предложенному Ionescu 60 ) для повышения резкости подпороговых характеристик TFET.
Стоит отметить, что снижение фактора тела, м , TFET ниже 1, соответствует менее изученному подходу (ранее предложенному Ionescu 60 ) для повышения резкости подпороговых характеристик TFET.
Далее мы изучаем две конструкции PC-TFET, в которых переключатель MIT подключен к затвору (рис. 2a, c, e, «конфигурация затвора») или к истоку (рис. 2b, d, f). , «исходная конфигурация») вывод TFET. В обоих случаях состояние ключа МИП контролируется напряжением затвора В
GS и изменение фазы вызывает внутреннее дифференциальное усиление падения напряжения В
GS_INT между выводами затвора и истока TFET (d V
GS_INT / В
GS >> 1) приводит к резкому увеличению тока I
ДС .
Рис. 2
Интеграция TFET с фазовым переходом в конфигурации затвора и истока. ( a , b ) 3D принципиальные схемы PC-TFET интегрирующих вертикальных переключателей VO 2 . ( c , d ) 3D принципиальные схемы PC-TFET интегрирующих планарных переключателей VO 2 . ( e , f ) Эквивалентные схемы, показывающие внутреннее напряжение затвора TFET В
( a , b ) 3D принципиальные схемы PC-TFET интегрирующих вертикальных переключателей VO 2 . ( c , d ) 3D принципиальные схемы PC-TFET интегрирующих планарных переключателей VO 2 . ( e , f ) Эквивалентные схемы, показывающие внутреннее напряжение затвора TFET В
GS_INT усиление за счет изменения фазы переключателя MIT, индуцированного внешним напряжением затвора В
ГС .
Полноразмерное изображение
На рис. 2a показана гибридная конструкция, объединяющая 3-контактный TFET и 2-контактный переключатель VO 2 для получения конфигурации затвора PC-TFET. Тонкая пленка VO 2 наносится поверх вывода затвора TFET, а второй металлический слой используется для контакта с ним и определяет электрод затвора PC-TFET. Эта же конструкция может быть адаптирована к конфигурации источника, показанной на рис. 2б, где ВО 2 переключатель построен поверх терминала источника TFET. Альтернативная конструкция с использованием планарных переключателей VO 2 показана на рис. 2c для конфигурации затвора и на рис. 2d для конфигурации истока.
2б, где ВО 2 переключатель построен поверх терминала источника TFET. Альтернативная конструкция с использованием планарных переключателей VO 2 показана на рис. 2c для конфигурации затвора и на рис. 2d для конфигурации истока.
На рисунке 2e представлена эквивалентная схема и распределение напряжения для PC-TFET в конфигурации с затвором. Сопротивление нагрузки R
L используется для обеспечения протекания тока, достаточного для достижения порога мощности VO 2 переключатель 43 . Стоимость р
L выбран для того, чтобы иметь R
VO2_OFF >> Ч
Л >> П
ВО2_ОН , где Р
VO2_OFF — сопротивление переключателя МИТ в изолированном состоянии, а R
ВО2_ОН — сопротивление в металлическом состоянии. Как В
Как В
GS нарастает в этой конфигурации, материал VO 2 изначально находится в высокоомном состоянии, следовательно, большая часть падений напряжения на переключателе MIT ( В
VO2 ≈ В
ГС ) и В
GS_INT остается низким. Как только напряжение станет достаточно высоким, чтобы вызвать металлическое состояние VO 2 , В
VO2 падает до очень низкого значения и В
GS_INT испытывает резкий переход к значению, приближающемуся к В
ГС .
На рисунке 2f представлены эквивалентная схема и распределение напряжения для PC-TFET в конфигурации источника. В этом случае переключатель MIT подключен к клемме внутреннего источника TFET, и оба внутренних напряжения падают В
GS_INT и В
DS_INT меняются при развертке В
GS в зависимости от V
VO2 , такой что V
ГС − В
GS_INT = В
ДС − В
DS_INT = В
ВО2 . Для низких значений В
Для низких значений В
GS , материал VO 2 находится в изолирующем состоянии, но сопротивление канала TFET намного выше, что эффективно блокирует утечку через переключатель MIT и поддерживает низкий уровень I
ВЫКЛ ток. Отсюда В
GS_INT следует за В
ГС . Увеличение В
GS , туннельный ток постоянно увеличивается, пока сопротивление TFET не станет сравнимым с R
VO2_OFF . В этот момент рост V
GS_INT уменьшается, и переключатель MIT приближается к своему порогу мощности. Как только VO 2 переходит в металлическое состояние, В
GS_INT резко переходит к значениям, близким к В
ГС . Понятно, что конфигурация источника очень подходит для наименьшего энергопотребления и агрессивного масштабирования, поскольку не требует дополнительного нагрузочного резистора (которым является сам TFET) и в такой нагрузке нет рассеиваемой мощности. Однако, как будет показано позже, конфигурация затвора особенно интересна своими более крутыми характеристиками.
Понятно, что конфигурация источника очень подходит для наименьшего энергопотребления и агрессивного масштабирования, поскольку не требует дополнительного нагрузочного резистора (которым является сам TFET) и в такой нагрузке нет рассеиваемой мощности. Однако, как будет показано позже, конфигурация затвора особенно интересна своими более крутыми характеристиками.
Конфигурация источника аналогична описанному ранее решению на основе транзисторов III–V FinFET и переключателей VO 2 61 . Однако в этой работе использовались классические FinFET с термоэлектронным подпороговым размахом и с очень высоким током утечки, чтобы вызвать изменение фазы в VO 2 и, как следствие, I .
НА / И
OFF Соотношение было ограничено до 4 × 10 2 и область резкого переключения наблюдалась менее чем за декаду тока, в то время как PC-TFET достигает одновременно низких I
ВЫКЛ. и высокий I
и высокий I
НА / И
ВЫКЛ соотношение.
PC-TFET в конфигурации затвора
Экспериментальная демонстрация PC-TFET была достигнута путем изготовления и определения характеристик TFET и VO 2 переключателя , подключенных, как описано в предыдущем разделе (рис. 2e,f). В ходе экспериментальных испытаний дважды прогоняется напряжение на затворе и регистрируется напряжение внутреннего узла высокоимпедансным вольтметром во всем диапазоне работы устройства. Это позволяет нам тщательно рассчитать внутреннее усиление и влияние точки перехода MIT на характеристики TFET, извлекая его собственные напряжения затвора и стока.
TFET, используемые в этой работе, основаны на технологии нанопроволоки (NW) с напряженным кремниевым затвором (GAA) 62, 63 с сечением СЗ 40 × 5 нм 2 и длиной затвора 350 нм. Для обеспечения маломощной конструкции PC-TFET необходимо минимизировать порог мощности переключателя MIT. На основе электротермической модели, рассматривающей джоулев нагрев в качестве пускового механизма для резкого перехода ПМИ 26, 64 , удобная геометрия устройства достигается за счет уменьшения объема VO 2 между двумя электродами переключателя ПМИ 65 . В данной работе такое маломощное срабатывание МИП-переключателя достигается за счет изготовления планарных переключателей с нанозазором на основе Si/SiO 9 .0488 2 подложка, ограничивающая объем VO 2 между электродами до значений до 200 × 100 × 100 нм 3 конечное устройство).
На основе электротермической модели, рассматривающей джоулев нагрев в качестве пускового механизма для резкого перехода ПМИ 26, 64 , удобная геометрия устройства достигается за счет уменьшения объема VO 2 между двумя электродами переключателя ПМИ 65 . В данной работе такое маломощное срабатывание МИП-переключателя достигается за счет изготовления планарных переключателей с нанозазором на основе Si/SiO 9 .0488 2 подложка, ограничивающая объем VO 2 между электродами до значений до 200 × 100 × 100 нм 3 конечное устройство).
На рис. 3а показаны модели I .
ДС — В
GS характеристики TFET для разных значений В
DS , в диапазоне от -0,25 В до -1 В. TFET смещен при В
DS = −0,75 V имеет очень низкий уровень I
ВЫКЛ. = 69,1 пА, очень хорошо I
= 69,1 пА, очень хорошо I
НА / И
ВЫКЛ = 1,0 × 10 7 Коэффициент, малая утечка затвора I
G < 8 нА до В
GS = −2 В (см. Дополнительный рисунок 3) и хороший средний подпороговый наклон за 4 декады тока: SS
TFET = ∂ В
GS /∂log 10 ( I
DS ) = 112 мВ/декада. На рис. 3б представлены ВАХ переключателя ВО 2 при различных температурах в диапазоне от 25 °С до 55 °С. Резистор 1 кОм подключен последовательно к переключателю MIT, чтобы ограничить ток в металлическом состоянии и предотвратить чрезмерный перегрев устройства. Конструкция переключателя была оптимизирована для использования в PC-TFET, обеспечивая низкое напряжение срабатывания В
акт = −0,93 В при комнатной температуре, крутой наклон перехода ( SS
VO2 = 18,7 мВ/декада) и способность к высокому уровню I
ВКЛ ток. Переход представляет собой ограниченную ширину гистерезиса (<0,2 В при комнатной температуре), когда напряжение снимается и переключатель возвращается в выключенное состояние. При повышении температуры напряжение срабатывания уменьшается, а я
Переход представляет собой ограниченную ширину гистерезиса (<0,2 В при комнатной температуре), когда напряжение снимается и переключатель возвращается в выключенное состояние. При повышении температуры напряжение срабатывания уменьшается, а я
ON и наклон остаются стабильными ( SS
VO2 = 17,7 мВ/декада при 35 °C, 23 мВ/декада при 45 °C) до достижения значений около T
MIT , где теряется резкий переход. Такое поведение можно объяснить с помощью модели электротермического срабатывания, основанной на джоулевом нагреве 66 .
Рис. 3
Экспериментальная демонстрация TFET с фазовым переходом в конфигурации с затвором. ( а ) я
ДС — В
ГС Передаточная характеристика ТПТ для различных применений В
ДС . ( b ) ВАХ переключателя ВО 2 , измеренные при различных температурах с последовательным сопротивлением 1 кОм. ( с ) я
( b ) ВАХ переключателя ВО 2 , измеренные при различных температурах с последовательным сопротивлением 1 кОм. ( с ) я
ДС — В
GS получено комбинацией (a) и (b) в конфигурации затвора с сопротивлением нагрузки R
L = 1 кОм между клеммой затвора и землей и приложенным В
DS = −0,75 В ( d ) Внутреннее напряжение затвора В
GS_INT смещение TFET в зависимости от внешнего воздействия В
ГС .
Полноразмерное изображение
На рисунке 3c показан I
ДС — В
GS характеристики PC-TFET в затворной конфигурации при различных температурах, смещенных на В
ДС = −0,75 В и с использованием сопротивления нагрузки R
L = 1 кОм. Различные значения Р
Различные значения Р
L позволяют смещать V
Уровень GS_act , необходимый для индукции фазового перехода (как описано в дополнительных измерениях, представленных на дополнительном рисунке 4). Как только VO 2 претерпевает фазовый переход в низкоомное состояние, мы наблюдаем резкий рост I
ДС по току до значений, близких к значениям ТПТ при тех же условиях смещения. PC-TFET при комнатной температуре имеет более низкие я
ВЫКЛ. = 29,5 пА (12,3 пА/мкм, нормализованное по ширине TFET), чем у TFET, сопоставимо I
НА / И
OFF соотношение (5,5 × 10 6 ) и подпороговая крутизна, значительно превосходящая характеристики современных устройств TFET, о которых сообщалось на сегодняшний день: SS
PC_TFET = 4,0 мВ/декада при 25 °C, 7,8 мВ/декада при 45 °C. Это связано с внутренним усилением В
Это связано с внутренним усилением В
GS_INT , показанный на рис. 3d, на котором мы наблюдаем очень крутой переход от низких уровней напряжения к значениям, близким к пороговому напряжению TFET (например, от −0,14 В до −0,49 В при комнатной температуре в пределах В).
GS = шаг 10 мВ). Выходные характеристики PC-TFET в конфигурации затвора представлены на дополнительном рисунке 5. Из-за относительно значительного энергопотребления резистивного делителя на выводе затвора, практически продиктованного VO 2 (см. рис. 3b), PC-TFET в затворной конфигурации не дает существенных преимуществ для маломощной электроники. Однако очень резкий переход в конфигурации затвора PC-TFET можно использовать для приложений аналоговых схем, таких как буферный генератор, управляемый напряжением (см. Дополнительный рисунок 6).
PC-TFET в исходной конфигурации
На рис. 4a показан I
ДС — В
GS характеристики компонента TFET, используемого для реализации PC-TFET в исходной конфигурации для различных значений В
DS , в диапазоне от -0,25 В до -1,5 В. TFET измерен при T = 55 °C и смещен при В
TFET измерен при T = 55 °C и смещен при В
DS = −0,75 V представляет среднее подпороговое колебание SS
TFET ≈ 180 мВ/дек и коэффициент тока 6,3 × 10 5 в окне напряжения затвора 2 В. На рис. 4б показаны ВАХ используемого в данном случае переключателя ВО 2 с последовательным сопротивлением 3 кОм. Напряжение срабатывания уменьшается с температурой от −2,61 В при 25 °C до −1,19 В при 55 °C, при этом крутой наклон сохраняется вплоть до значений, приближающихся к T
Массачусетский технологический институт ( нержавеющая сталь
VO2 = 11,9 мВ/декада при T = 25 °C, 22,3 мВ/декада при T = 55 °C).
Рис. 4
Экспериментальная демонстрация TFET с фазовым переходом в конфигурации источника. ( и ) я
ДС — В
GS передаточная характеристика компонента TFET для различных применений V
DS измерено при T = 55 °C. ( б ) ВАХ ВО 2 переключатель, измеренный при различных температурах с последовательным сопротивлением 3 кОм. ( с ) я
( б ) ВАХ ВО 2 переключатель, измеренный при различных температурах с последовательным сопротивлением 3 кОм. ( с ) я
ДС — В
GS PC-TFET, полученный путем введения переключателя VO 2 в клемму источника TFET; измерения выполнены при T = 55 °C с приложенным внешним V
ДС = −2 В.( d ) Собственное напряжение затвора TFET В
GS_INT и напряжение стока В
DS_INT по сравнению с прикладным В
ГС .
Полноразмерное изображение
На рис. 4c изображен I
ДС — В
GS характеристики PC-TFET в исходной конфигурации. В
В
DS был повышен до -2 В, а измерение сообщается при 55 °C, чтобы достичь уровней тока, необходимых для индукции перехода при В
GS < 4 В. PC-TFET в конфигурации источника сочетает в себе сильные стороны двухкомпонентных устройств, обеспечивая высокое I
НА / И
ВЫКЛ. Коэффициент , низкий я
ВЫКЛ. ток и низкий уровень I
G утечка затвора сравнима с TFET, а подпороговый наклон аналогичен таковому у переключателя VO 2 ( SS
PC_TFET = 20,6 мВ/дек). Субтермическое (<60 мВ/дек) значение наклона при переходе с изменением фазы связано с аналогичным механизмом усиления внутреннего напряжения затвора, используемым для конфигурации затвора, с той разницей, что как собственные напряжения затвора, так и напряжения стока резко переключаются одновременно: В
GS_INT = В
ГС − Р
VO2 · I
Д и В
DS_INT = В
ДС − Р
VO2 · I
D (см. рис. 4г). Однако, как показано на рис. 4г, в этом случае усиление происходит для значений В
рис. 4г). Однако, как показано на рис. 4г, в этом случае усиление происходит для значений В
GS_INT выше порога TFET (от −2,54 В до −3,31 В в пределах В
GS = шаг 10 мВ), что приводит к менее резкому увеличению I
ДС . Более того, наши эксперименты показывают, что V
DS_INT изменение при подметании В
GS количественно менее важен, чем эффект d В
GS_INT /д В
Усиление G (см. Дополнительный рисунок 7).
Выходные характеристики гибридного PC-TFET в конфигурации источника представлены на рис. 5a, указывая на очень специфическое поведение, которое можно было бы в дальнейшем использовать в энергоэффективных логических или нейроморфных схемах. Изменение фазы ВО 2 вызывает очень резкое переключение выходных характеристик PC-TFET, соответствующее по абсолютной величине выше В
GS_INT и выше V
DS_INT , как показано на рис. 5b. Выходные характеристики PC-TFET наследуют от точек перехода MIT гистерезисное поведение, которое напрямую влияет на эффективный ток возбуждения (из-за другой траектории выходных характеристик при логическом переключении), если такое устройство используется для создания КМОП-инверторов. . Более того, низкий ток утечки в PC-TFET, незначительный по отношению к току стока во всей области работы (см. Дополнительный рис. 8), делает его перспективным для энергоэффективных реализаций нейроморфных схем на основе релаксационных генераторов 9.0248 67, 68 .
5b. Выходные характеристики PC-TFET наследуют от точек перехода MIT гистерезисное поведение, которое напрямую влияет на эффективный ток возбуждения (из-за другой траектории выходных характеристик при логическом переключении), если такое устройство используется для создания КМОП-инверторов. . Более того, низкий ток утечки в PC-TFET, незначительный по отношению к току стока во всей области работы (см. Дополнительный рис. 8), делает его перспективным для энергоэффективных реализаций нейроморфных схем на основе релаксационных генераторов 9.0248 67, 68 .
Рисунок 5
Выходные характеристики и переключение напряжения стока TFET с фазовым переходом в конфигурации истока. ( a ) Выходные характеристики PC-TFET в конфигурации источника для различных примененных В
GS (в диапазоне от −2,75 В до −4 В), измерено при T = 55 °C. ( b ) Собственное напряжение затвора TFET В
GS_INT и напряжение стока В
DS_INT по сравнению с прикладным В
ДС .
Изображение полного размера
Уменьшение коэффициента тела в PC-TFET
Глубокое субтермическое переключение в PC-TFET можно объяснить субединичным коэффициентом тела из-за внутреннего усиления напряжения затвора. Связь между подпороговым наклоном и коэффициентом корпуса отражена в уравнении (1) с коэффициентом корпуса транзистора, равным 9.0514 м = d В
ГС /d Ψ
S выражается как инверсия дифференциального усиления поверхностного потенциала по отношению к внешнему напряжению на затворе. В обычных полевых МОП-транзисторах коэффициент корпуса зависит от отношения емкостей между емкостью оксида затвора, C
ox , а емкость истощения C
д , м = 1 + С
д / С
ox , что дает нижнюю границу m ≥ 1. {-1}=(1+\frac{{C}_{{\rm{d} }}}{{C}_{{\rm{ox}}}})\frac{d{V}_{{\rm{GS}}}}{d{V}_{{\rm{GS} }\_{\rm{INT}}}}$$
{-1}=(1+\frac{{C}_{{\rm{d} }}}{{C}_{{\rm{ox}}}})\frac{d{V}_{{\rm{GS}}}}{d{V}_{{\rm{GS} }\_{\rm{INT}}}}$$
(2)
следовательно, при максимальном внутреннем усилении PC-TFET G = d В
GS_INT /д В
GS >> 1, а учитывая, что в полностью истощенном корпусе приборов (1 + C
д / С
ox )~1, следует, что m << 1, показывая, что фактор тела является усилителем подпорогового колебания TFET. Мы извлекаем фактор тела из наших экспериментальных результатов, начиная с расчета поверхностного потенциала как функции В
GS , как показано на рис. 6a для конфигурации затвора и на рис. 6b для конфигурации источника. На тех же рисунках мы включаем измеренное внутреннее усиление, G , экспериментальные значения которого используются для извлечения м с использованием уравнения (2). Значения Ψ
Значения Ψ
С ( В
GS ) получены с помощью технологии автоматизированного проектирования (TCAD) моделирования NW-TFET идентичных изготовленным конструкциям, смещенным на экспериментальные значения В
GS_INT и В
DS для конфигурации ворот (рис. 3d), V
GS_INT и В
DS_INT для исходной конфигурации (рис. 4d). Мы наблюдаем резкое изменение Ψ
S (в результате получается очень низкий м ) в соответствии с V
GS , для которых зафиксировано высокое усиление внутреннего усиления, подчеркивая ключевую роль внутреннего усиления в крутых характеристиках переключения PC-TFET.
Рис. 6
6
Поверхностный потенциал и фактор тела в фазовом переходе TFET. ( a , b ) Зависимость от V
GS поверхностного потенциала, Ψ
S и внутреннее усиление, G = d V
GS_INT /д В
GS , для конфигураций затвора и истока. Опорный уровень поверхностного потенциала берется на клемме источника. ( c , d ) Фактор тела как функция I
DS для конфигураций затвора и истока; пунктирные линии представляют м ≥ 1 предел преодолен благодаря внутреннему В
GS_INT усиление.
Полноразмерное изображение
На рис. 6c,d показаны м в зависимости от измеренного I
DS соответственно для конфигураций затвора и истока. В обоих случаях экспериментально извлеченный коэффициент тела показывает значение менее 0,1 в переходной области. PC-TFET в конфигурации затвора имеет значение m ~0,05 (<<1) для более чем двух декад тока, от 0,43 нА до 142,3 нА при переходе от ВЫКЛ к ВКЛ и от 27,5 нА до 0,15 нА при переходе от ВЫКЛ к ВКЛ. PC-TFET в исходной конфигурации показывает аналогичные значения м (0,025 при переходе от ВЫКЛ к ВКЛ, 0,5 при переходе от ВКЛ к ВЫКЛ). Стоит отметить, что область низких значений м расширена на большее количество декад тока в конфигурации затвора из-за лучшего совмещения внутренних пиков усиления и пороговой области TFET.
В обоих случаях экспериментально извлеченный коэффициент тела показывает значение менее 0,1 в переходной области. PC-TFET в конфигурации затвора имеет значение m ~0,05 (<<1) для более чем двух декад тока, от 0,43 нА до 142,3 нА при переходе от ВЫКЛ к ВКЛ и от 27,5 нА до 0,15 нА при переходе от ВЫКЛ к ВКЛ. PC-TFET в исходной конфигурации показывает аналогичные значения м (0,025 при переходе от ВЫКЛ к ВКЛ, 0,5 при переходе от ВКЛ к ВЫКЛ). Стоит отметить, что область низких значений м расширена на большее количество декад тока в конфигурации затвора из-за лучшего совмещения внутренних пиков усиления и пороговой области TFET.
Обсуждение
Мы сообщали о PC-TFET как о новом гибридном электронном переключателе с крутым наклоном, объединяющем два механизма крутого переключения в одном устройстве, и о его подробных характеристиках в широком диапазоне температур вплоть до значений, приближающихся к температуре перехода VO 2 . Уникальное сочетание BTBT в TFET и MIT в VO 2 приводит к превосходным показателям качества для цифровой электроники, такой как I .
на / я
от отношения лучше, чем 5,5 × 10 6 , и подпороговое колебание ниже 10 мВ/дек за 3 декады токов. Мы наблюдаем слабую зависимость размаха PC-TFET в затворной конфигурации от температуры: от 4,0 мВ/дек при комнатной температуре до 7,8 мВ/дек при 45 °С. Кроме того, мы продемонстрировали, что основным механизмом резкого переключения является усиление напряжения на внутреннем затворе, что приводит к субединичному эквивалентному коэффициенту тела. Такой коэффициент корпуса ниже 1 для достижения субтермического переключения является гораздо более общим критерием проектирования, чем предыдущий принцип отрицательной емкости, который служит усилителем производительности как для TFET, так и для MOSFET. PC-TFET представляет собой важный шаг вперед, выходящий за рамки КМОП-электроники, впервые используя весь потенциал VO 9.0488 2 MIT в трехтерминальной архитектуре с электрическим управлением и открывает новые перспективы для маломощной электроники и нейроморфных вычислений.
Методы
Изготовление экспериментальных устройств
ВО 2 Нанощелевые переключатели были изготовлены на кремниевой подложке с нанесенным сверху слоем SiO 2 толщиной 200 нм. Слой VO 2 был нанесен методом реактивного магнетронного распыления при 600 °C мишени из чистого ванадия, при этом подробные экспериментальные условия описаны в другом месте 9.0248 69 . Электрические контакты определяли с помощью электронно-лучевой литографии на ПММА/ММА и отрыва пленки платины толщиной 100 нм, нанесенной напылением. Затем участки ВО 2 вокруг переключателя удаляются методами электронно-лучевой литографии на ЗЭП и ионно-лучевого травления. Напряженные кремниевые GAA TFET были изготовлены на подложке кремний-изолятор с использованием процесса, основанного на сегрегации легирующих примесей из NiSi 2 70 .
Моделирование TCAD для извлечения поверхностного потенциала
Моделирование TCAD выполнялось с помощью Sentaurus TCAD Suite 2014. 09. Мы смоделировали напряженный кремниевый TFET с двойным затвором и толщиной канала T
09. Мы смоделировали напряженный кремниевый TFET с двойным затвором и толщиной канала T
CH = 5 нм, толщина оксида T
OX = 3 нм с HfO 2 ( ε
r = 22) работа выхода металла затвора ϕ
м = 4,1 эВ, что соответствует TiN. Источник легирования Н
S = 1 × 10 20 см −3 и легирование стока N
D = 1 × 10 19 см −3 с резкими переходами. Поскольку полупроводниковый слой очень тонкий, мы увеличили ширину запрещенной зоны на 70 мэВ, что соответствует квантованному состоянию эллипсоидов [100]. Однако это увеличение компенсируется напряжением нанопроволоки, что приводит к уменьшению общей ширины запрещенной зоны на Δ Е
г = −25 мэВ. Все смоделированные значения поверхностного потенциала, представленные в этой работе, взяты на 0,1 Å ниже границы раздела полупроводник-оксид. Графики поверхностного потенциала в зависимости от В
Все смоделированные значения поверхностного потенциала, представленные в этой работе, взяты на 0,1 Å ниже границы раздела полупроводник-оксид. Графики поверхностного потенциала в зависимости от В
GS (рис. 5a,b) взяты на туннельном переходе, а полный потенциальный профиль поперек канала представлен на дополнительном рисунке 9. . В 2009 2-й международный . Работа . Электронные устройства Semicond . Технол . 1–4, doi:10.1109/EDST.2009.5166100 (IEEE, 2009).
Бернштейн, К., Кавин, Р.К., Пород, В., Сибо, А. и Велзер, Дж. Перспективы устройств и архитектуры для коммутаторов Beyond CMOS. Проц. ИЭЭЭ
98 , 2169–2184 (2010).
Артикул
Google ученый
Сибо, А. К. и Чжан, К. Низковольтные туннельные транзисторы для логики, выходящей за рамки КМОП. Проц. ИЭЭЭ
ИЭЭЭ
98 , 2095–2110 (2010).
КАС
Статья
Google ученый
Лундстрем М.С. Новый взгляд на полевой МОП-транзистор: физика устройств и моделирование в наномасштабе. В 2006 IEEE international SOI Conferencee Proceedings 1–3, doi:10.1109/SOI.2006.284404 (IEEE, 2006).
Ионеску, А. М. и Риэль, Х. Туннельные полевые транзисторы как энергоэффективные электронные переключатели. Природа
479 , 329–337 (2011).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
Google ученый
Салахуддин С. и Датта С. Использование отрицательной емкости для усиления напряжения в маломощных наноразмерных устройствах. Нано Летт.
8 , 405–410 (2008).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
Google ученый
Абеле, Н. и др. . МОП-транзистор с подвесным затвором: привнесение новых функций МЭМС в твердотельный МОП-транзистор. В IEEE Int . Электронные устройства встречают . 2005 . ИЭДМ Тех . Копать . 479–481, doi: 10.1109/IEDM.2005.1609384 (IEEE, 2005).
Гопалакришнан К., Гриффин П. Б. и Пламмер Дж. Д. I-MOS: новое полупроводниковое устройство с подпороговым наклоном ниже кТл/q. В Копать . Интервал . Электронные устройства встречают . 289–292, doi: 10.1109/IEDM.2002.1175835 (IEEE, 2002).
Букарт, К. и Ионеску, А. М. Туннельный полевой транзистор с двойным затвором и диэлектриком затвора high-k. IEEE Trans. Электронные устройства
54 , 1725–1733 (2007).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Саркар, Д. и др. Субтермический туннельный полевой транзистор с атомарно тонким каналом. Природа
и др. Субтермический туннельный полевой транзистор с атомарно тонким каналом. Природа
526 , 91–95 (2015).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
Google ученый
Ньюнс, Д. М. и др. Полевой транзистор с переходом Мотта . Заяв. физ. лат.
73 , 780 (1998).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Иноуэ, И. Х. Легирование электростатическим носителем перовскитных оксидов переходных металлов. Полуконд. науч. Технол.
20 , S112–S120 (2005 г.).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Иноуэ, И. Х. и Розенберг, М. Дж. Укрощение перехода Мотта для нового транзистора Мотта. Доп. Функц. Матер.
Функц. Матер.
18 , 2289–2292 (2008).
КАС
Статья
Google ученый
Ха, С. Д. и Раманатан, С. Адаптивная оксидная электроника: обзор. J. Appl. физ.
110 , 071101 (2011).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Ян, З., Ко, К. и Раманатан, С. Оксидная электроника, использующая сверхбыстрые переходы металл-изолятор. год. Преподобный Матер. Рез.
41 , 337–367 (2011).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Басов Д. Н., Аверитт Р. Д., Ван дер Марел Д., Дрессель М. и Холе К. Электродинамика материалов с коррелированными электронами. Ред. Мод. физ.
83 , 471–541 (2011).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Чжоу Ю. и Раманатан С. Коррелированные электронные материалы и полевые транзисторы для логики: обзор. Крит. Преподобный твердотельный материал. наука
38 , 286–317 (2013).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Mannhart, J. & Haensch, W. Физика устройства: нажмите на педаль до упора. Природа
487 , 436–437 (2012).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
Google ученый
Ши, Дж., Чжоу, Ю. и Раманатан, С. Колоссальное переключение сопротивления и модуляция запрещенной зоны в никелате перовскита с помощью электронного легирования. Нац. коммун.
5 , 4860 (2014).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
Google ученый
Morin, F. J. Оксиды, демонстрирующие переход металла в изолятор при температуре Нееля. Физ. Преподобный Летт.
3 , 34–36 (1959).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Мотт, Н. Ф. Переход металл-изолятор. Ред. Мод. физ.
40 , 677–683 (1968).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Гуденаф, Дж. Б. Два компонента кристаллографического перехода в VO 2 . J. Solid State Chem.
3 , 490–500 (1971).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Ли, С. Б., Ким, К., О, Дж. С., Канг, Б. и Ли, Дж. С. Происхождение изменений напряжения переключения в явлениях порогового переключения тонких пленок VO 2 . Заявл. физ. лат.
102 , 63501 (2013).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Саймон Мун, Б. и др. . Роль эффекта джоулева нагрева и объемных поверхностных фаз в переходе металл-диэлектрик под напряжением в кристалле ВО 2 . Заявка . Физ. . Буква . 103 (2013).
Юн, Дж., Ли, Г., Парк, К., Мун, Б.С. и Джу, Х. Исследование зависимых от длины характеристик индуцированного напряжением перехода металлического изолятора в VO 2 киноаппараты. Заяв. физ. лат.
105 , 83503 (2014).
Артикул
Google ученый
Иордания, Т. С. и др. Модель и характеристика VO 2 Тонкопленочные переключающие устройства. IEEE Trans. Электронные устройства
61 , 813–819 (2014).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Рати, С. и др. Влияние отжига после изготовления на переходы изолятор-металл в тонкопленочных устройствах ВО 2 . Приложение ACS Матер. Интерфейсы
6 , 19718–19725 (2014).
КАС
Статья
пабмед
Google ученый
Рати, С. и др. Раскрытие механизмов переключения при индуцированных электрическим полем переходах изолятор–металл в VO 2 нанопучки. J. Phys. Д. Заявл. физ.
47 , 295101 (2014).
Артикул
Google ученый
Джушагани, А. и др. Управляемое напряжением переключение и тепловые эффекты в ВО 2 нанощелевые переходы. Заяв. физ. лат.
104 , 221904 (2014).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Сингх, С. и др. Пролиферация металлических доменов, вызванная неоднородным нагревом вблизи электрически управляемого перехода в нанопучках VO 2 . Физ. Версия B
92 , 155121 (2015).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Ли, Д. и др. . Переход металл–изолятор при джоулевом нагреве в эпитаксиальном VO 2 /TiO 2 Устройства. Приложение ACS . Мать . Интерфейсы acsami.6b03501, doi:10.1021/acsami.6b03501 (2016 г.).
Чае, Б.Г., Ким, Х.Т., Юн, Д.Х. и Канг, К.Ю. Резкий переход металл-изолятор, наблюдаемый в тонких пленках VO 2 , индуцированный импульсом напряжения переключения. Физ. Б Конденс. Материя
369 , 76–80 (2005).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Лерой, Дж. и др. Высокоскоростной переход металл-изолятор в пленках диоксида ванадия, индуцированный импульсным электрическим напряжением на нанощелевых электродах. Заяв. физ. лат.
100 , 213507 (2012).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Чжоу Ю. и др. Инициируемый напряжением сверхбыстрый фазовый переход в переключателях на диоксиде ванадия. Электронное устройство IEEE Lett
34 , 220–222 (2013).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Витале, В. А. и др. . Крутой наклон VO 2 переключатели для широкополосной (DC-40 ГГц) реконфигурируемой электроники. В 72-й конференции по исследованию устройств 29–30, doi: 10.1109/DRC.2014.6872284 (IEEE, 2014).
Раду, И. П. и др. Механизм переключения в двухполюсных приборах на диоксиде ванадия. Нанотехнологии
26 , 165202 (2015).
ОБЪЯВЛЕНИЯ
Статья
пабмед
Google ученый
Сакаи, Дж. Высокоэффективные колебания напряжения в плоскостных переходах VO 2 с бесконечным отрицательным дифференциальным сопротивлением. J. Appl. физ.
103 , 103708 (2008 г.).
ОБЪЯВЛЕНИЕ
Статья
Google ученый
Lee, YW и др. . Индуцированные переходом металл-изолятор электрические колебания в тонкой пленке диоксида ванадия. Заявка . Физ. . Буква . 92 (2008).
Шукла Н. и др. Синхронные колебания заряда в коррелированных электронных системах. Науч. Респ
4 , 4964 (2014).
ОБЪЯВЛЕНИЯ
КАС
Статья
ПабМед Центральный
Google ученый
Бомонт, А., Лерой, Дж., Орлианж, Ж.-К. и Крунтяну, А. Индуцированные током электрические автоколебания через внеплоскостные пороговые переключатели на основе слоев VO 2 , интегрированных в геометрию перекладин. J. Appl. физ.
115 , 154502 (2014).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Bae, S.H. и др. Мемристивные свойства одиночной нанопроволоки ВО 2 с переключением, контролируемым саморазогревом. Доп. Матер.
и др. Мемристивные свойства одиночной нанопроволоки ВО 2 с переключением, контролируемым саморазогревом. Доп. Матер.
25 , 5098–5103 (2013).
КАС
Статья
пабмед
Google ученый
Seo, G., Kim, B.J., Kim, H.T. & Lee, Y.W. Термическое или оптическое мемристивное переключение в двухполюснике VO 2 устройства. Курс. заявл. физ.
14 , 1251–1256 (2014).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Витале, В. А. и др. . Электронное устройство IEEE Lett
36 , 972–974 (2015).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Витале, В. А. и др. . Усовершенствованная конструкция переключателей с крутым наклоном VO 2 для низкого напряжения срабатывания. In 2016 46th European Solid-State Research Conference ( ESSDERC ), 352–355, doi:10.1109/ESSDERC.2016.7599659 (IEEE, 2016).
In 2016 46th European Solid-State Research Conference ( ESSDERC ), 352–355, doi:10.1109/ESSDERC.2016.7599659 (IEEE, 2016).
Krammer, A., Gremaud, A., Bouvard, O., Sanjines, R. & Schüler, A. In situ фотоэлектронная спектроскопическая характеристика реактивно напыленных тонких пленок легированного оксида ванадия. Прибой . Анальный интерфейс . 1–5, doi:10.1002/sia.5989 (2016).
Ким Х.-Т. и др. Механизм и наблюдение перехода Мотта в ВО 2 на основе двух- и трехполюсников. New J. Phys.
6 , 52–52 (2004).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Рузметов, Д., Гопалакришнан, Г., Ко, С., Нараянамурти, В. и Раманатан, С. Трехвыводные устройства с полевым эффектом, использующие тонкопленочный оксид ванадия в качестве канального слоя. J. Appl. физ.
J. Appl. физ.
107 , 114516 (2010 г.).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Сенгупта, С. и др. Полевая модуляция проводимости в нанолучевых транзисторах VO 2 с HfO2 в качестве подзатворного диэлектрика. Заяв. физ. лат.
99 , 62114 (2011).
Артикул
Google ученый
Мартенс, К. и др. Эффект поля и сильно локализованные носители в материале перехода металл-диэлектрик VO 2 . Физ. Преподобный Летт.
115 , 196401 (2015).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
Google ученый
Вей, Т., Канки, Т., Фудзивара, К., Чиканари, М. и Танака, Х. Индуцированная электрическим полем транспортная модуляция в VO 2 Полевые транзисторы с гибридным затворным диэлектриком из оксида high-k/органический парилен-C. Заяв. физ. лат.
Заяв. физ. лат.
108 , 53503 (2016).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Накано М. и др. Коллективная делокализация балкера, вызванная накоплением электростатического поверхностного заряда. Природа
487 , 459–62 (2012).
ОБЪЯВЛЕНИЕ
КАС
Статья
пабмед
Google ученый
Лю, К. и др. Плотная электронная система от управляемого затвором поверхностного перехода металл-изолятор. Нано Летт.
12 , 6272–7 (2012).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
Google ученый
Чон, Дж. и др. Подавление перехода металл-изолятор в VO 2 путем образования кислородных вакансий, индуцированных электрическим полем. Наука
Наука
339 , 1402–1405 (2013).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
Google ученый
Карел, Дж. и др. Отчетливая электронная структура электропроводящей фазы, индуцированной электролитическим затвором, в диоксиде ванадия, обнаруженная с помощью фотоэлектронной спектроскопии высоких энергий. СКД Нано
8 , 5748–5789 (2014).
Артикул
Google ученый
Чжон, Дж. и др. Гигантские обратимые, зависящие от граней, структурные изменения в изоляторе коррелированных электронов, вызванные вентилированием ионной жидкостью. Проц. Натл. акад. наука
112 , 1013–1018 (2015).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
ПабМед Центральный
Google ученый
Шибуя, К. и Сава, А. Модуляция перехода металл-изолятор в VO 2 с помощью протонирования, вызванного электролизом. Доп. Электрон. Мать
2 , 1500131 (2016).
Артикул
Google ученый
Чжоу, Ю. и Раманатан, С. Динамика релаксации интерфейсов ионной жидкости-VO 2 и влияние на электрические двухслойные транзисторы. J. Appl. физ.
111 , 84508 (2012).
Артикул
Google ученый
Пэн, X. и др. Эффективная и безгистерезисная модуляция полевым эффектом амбиполярно легированных нанопроводов диоксида ванадия. Физ. Ред. Приложение
5 , 54008 (2016).
ОБЪЯВЛЕНИЯ
Статья
Google ученый
Casu, EA и др. . Гибридный фазовый переход — туннельный полевой транзистор (PC-TFET) с подпороговым размахом <10 мВ/декада и коэффициентом тела менее 0,1: цифровой и аналоговый бенчмаркинг. В 20 16 IEEE International Electron Devices Meeting (2016).
Ионеску, А. М. Сегнетоэлектрический туннельный полевой транзистор и память. Патент США (2010 г.).
Шукла Н. и др. Транзистор с крутым наклоном на основе резкого электронного фазового перехода. Нац. коммун.
6 , 7812 (2015).
ОБЪЯВЛЕНИЯ
КАС
Статья
пабмед
ПабМед Центральный
Google ученый
Чжао, К. Т. и др. Туннельные полевые транзисторы из нанопроволоки Si и SiGe для логических и аналоговых приложений. IEEE J. Электронные устройства Soc
3 , 103–114 (2015).
Артикул
Google ученый
Нолл, Л. и др. Туннельные полевые транзисторы Si и SiGe с напряженными элементами и дополнительные инверторы с туннельными полевыми транзисторами с минимальной длиной затвора 50 нм. Твердый. Состояние. Электрон.
97 , 76–81 (2014).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Циммерс, А. и др. Роль теплового нагрева в индуцированном напряжением переходе изолятор-металл в VO 2 . Физ. Преподобный Летт.
110 , 56601 (2013).
ОБЪЯВЛЕНИЯ
КАС
Статья
Google ученый
Джушагани, А. и др. Характеристики управляемого током фазового перехода микропроводов ВО 2 для гибридных оптоэлектронных устройств. Фотоника
Фотоника
2 , 916–932 (2015).
КАС
Статья
Google ученый
Витале, В. А., Молдован, К. Ф., Паоне, А., Шулер, А. и Ионеску, А. М. Исследование перехода металл-изолятор в VO 2 для электронных переключателей с крутым подпороговым наклоном менее 1 мВ/декаду . В Silicon Nanoelectronics Workshop , doi:10.1109/SNW.2016.7578041 (2016).
Шукла Н. и др. . Гибридные генераторы на двуокиси ванадия и МОП-транзисторах с парной связью (HVFET) для небулевых ассоциативных вычислений. В IEEE International Electronic Devices Meeting 2014 28.7.1-28.7.4, doi:10.1109/IEDM.2014.7047129 (IEEE, 2014).
Джерри М. и др. . Оксидный нейрон фазового перехода для импульсных нейронных сетей. В 74th Annual Device Research Conference 1-2, doi:10.1109/DRC.2016. 7548503 (IEEE, 2016).
7548503 (IEEE, 2016).
Витале, В. А., Молдован, К. Ф., Паоне, А., Шулер, А. и Ионеску, А. М. Изготовление КМОП-совместимых электронных переключателей с резким переключением на основе диоксида ванадия. Микроэлектрон. англ.
145 , 117–119 (2015).
КАС
Статья
Google ученый
Луонг, Г. В., Трелленкамп, С., Чжао, К. Т., Мантл, С. и Бурдель, К. К. Напряженные кремниевые нанопроволоки GAA n-TFET для низких напряжений питания. EUROSOI-ULIS 2015 — 2015 Jt . Интервал . ЕВРОСОИ Рабочий . Интервал . Конф. . Ультим . Интегр . Silicon 65–68, doi:10.1109/ULIS.2015.7063774 (2015).
Ссылки на скачивание
Благодарности
Эта работа была поддержана грантом ERC Advanced Grant ‘Millitech’ Европейской комиссии, проект E 2 SWITCH FP7 (грантовое соглашение № 257267), Швейцарский национальный научный фонд (грант № 144268) и Федерального управления энергетики Швейцарии (грант № 8100072).
Информация об авторе
Авторы и организации
Лаборатория наноэлектронных устройств (NanoLab), Федеральная политехническая школа Лозанны (EPFL), 1015, Лозанна, Швейцария
Вольфганг А. Витале, Эмануэле А. Казу, Арнаб Бисвас, Теодор Рошка, 90 103 Ионеку, Джем Альпер и А.
Лаборатория солнечной энергии и строительной физики (LESO-PB), Федеральная политехническая школа Лозанны (EPFL), 1015, Лозанна, Швейцария
Анна Краммер и Андреас Шулер
Институт Петера Грюнберга 9(PGI-9), Forschungszentrum Jülich, 52425, Jülich, Germany
Gia V. Luong, Qing-T. Zhao & Siegfried Mantl
Авторы
- Wolfgang A. Vitale
Посмотреть публикации автора
Вы также можете искать этого автора в
PubMed Google Scholar - Emanuele A. Casu
Посмотреть публикации автора
Вы также можете искать этого автора в
PubMed Google Scholar - Arnab Biswas
Посмотреть публикации автора
Вы также можете искать этого автора в
PubMed Google Scholar - Teodor Rosca
Посмотреть публикации автора
Вы также можете искать этого автора в
PubMed Google Scholar - Cem Alper
Посмотреть публикации автора
Вы также можете искать этого автора в
PubMed Google Scholar - Анна Краммер
Посмотреть публикации автора
Вы также можете искать этого автора в
PubMed Google Scholar - Gia V.
 Luong
LuongПросмотр публикаций автора
Вы также можете искать этого автора в
PubMed Google Scholar - Qing-T. Чжао
Посмотреть публикации автора
Вы также можете искать этого автора в
PubMed Google Scholar - Siegfried Mantl
Посмотреть публикации автора
Вы также можете искать этого автора в
PubMed Google Scholar - Andreas Schüler
Посмотреть публикации автора
Вы также можете искать этого автора в
PubMed Google Scholar - A. M. Ionescu
Просмотр публикаций автора
Вы также можете искать этого автора в
PubMed Google Scholar
Contributions
W.A.V., E.A.C. и А.Б. проводил опыты. W.A.V., E.A.C. и К.А. проанализировал данные. Т.Р. спроектированы и смоделированы схемные приложения. А.К. и в качестве. депонировал ВО 2 пленки. Е. А.С. изготовлены выключатели ВО 2 . Г.В.Л., К.-Т.З. и С.М. разработал и изготовил ТПТ. W.A.V. и А.М.И. написал рукопись. Все авторы обсудили результаты и прокомментировали рукопись. А.М.И. руководил общим исследовательским проектом.
А.С. изготовлены выключатели ВО 2 . Г.В.Л., К.-Т.З. и С.М. разработал и изготовил ТПТ. W.A.V. и А.М.И. написал рукопись. Все авторы обсудили результаты и прокомментировали рукопись. А.М.И. руководил общим исследовательским проектом.
Автор, ответственный за переписку
Вольфганг А. Витале.
Заявление об этике
Конкурирующие интересы
Авторы заявляют, что у них нет конкурирующих интересов.
Дополнительная информация
Примечание издателя: Springer Nature остается нейтральной в отношении юрисдикционных претензий в опубликованных картах и институциональной принадлежности.
Электронные дополнительные материалы
Дополнительная информация
Права и разрешения
Эта работа находится под лицензией Creative Commons Attribution 4.0 International License. Изображения или другие сторонние материалы в этой статье включены в лицензию Creative Commons на статью, если иное не указано в кредитной строке; если материал не включен в лицензию Creative Commons, пользователям необходимо будет получить разрешение от держателя лицензии на воспроизведение материала. Чтобы просмотреть копию этой лицензии, посетите http://creativecommons.org/licenses/by/4.0/
Чтобы просмотреть копию этой лицензии, посетите http://creativecommons.org/licenses/by/4.0/
Перепечатка и разрешения
Об этой статье
Дополнительная литература
Трехмерные диаграммы Смита, параметры рассеяния, частотно-зависимый анализ ориентации и комплексно-скалярная многопараметрическая характеристика, применяемые к реконфигурируемым индукторам из диоксида ванадия Пеано
- Андрей Александрович Мюллер
- Алин Молдовяну
- Адриан М. Ионеску
Научные отчеты (2019)
Устройства крутого переключения для маломощных приложений: полевые транзисторы с отрицательной дифференциальной емкостью/сопротивлением
- Юна Ко
- Джемин Шин
- Чанхван Шин
Наноконвергенция (2018)
Комментарии
Отправляя комментарий, вы соглашаетесь соблюдать наши Условия и Правила сообщества. Если вы обнаружите что-то оскорбительное или не соответствующее нашим условиям или правилам, отметьте это как неприемлемое.
Если вы обнаружите что-то оскорбительное или не соответствующее нашим условиям или правилам, отметьте это как неприемлемое.
Что лучше транзистор MJE340/350 или BD139/BD140
Катияр
Участник
#1
Можно ли безопасно заменить BD139/BD140 на высоковольтные транзисторы MJE340/MJE350 без изменения параметров схемы. Будут ли какие-либо изменения в характеристиках схемы в отношении звуковых характеристик, искажений и т. д.
д.
Wintermute
Администратор
#2
Я не очень хороший человек, чтобы отвечать, но я думаю, что знание приложения поможет людям ответить. Они потенциально могут быть использованы как для VAS, так и для драйверов, в зависимости от усилителя.
редактировать: беглый взгляд на таблицы данных показывает BD139Ток коллектора 1,5 А, ток коллектора MJE340 0,5 А. актуально это или нет, зависит от приложения
актуально это или нет, зависит от приложения
Тони.
Последнее редактирование:
#3
#3
Для чего лучше?
ЭндрюТ
Р.
 И.П.
И.П.
#4
#4
Для меня, когда я читаю даташиты, это совершенно разные транзисторы.
Я бы никогда не стал считать одно эквивалентом другого.
Если они не эквивалентны, то нет разумного способа оценить, лучше они или хуже.
Согласитесь, что bd139 — это низковольтные, сильноточные устройства средней мощности.
и MJE340 — это высоковольтные, слаботочные устройства средней мощности.
изобретательность
Участник
#5
#5
Я полагаю, вопрос должен заключаться в том, какой драйвер лучше всего подходит для выходного транзистора.
арту
Участник
#6
#6
АндрейТ сказал:
Для меня, когда я читаю даташиты, это совершенно разные транзисторы.
Я бы никогда не стал считать одно эквивалентом другого.
….Нажмите, чтобы развернуть…
Я сделал это один раз и получил осцилляции
Ура
Катияр
Участник
#7
#7
Схема усилителя NMOS200 использует BD139/BD140, тогда как схема усилителя NMOS350 с более высоким напряжением использует MJE340/MJE350.
john_ellis
Участник
#8
#8
Это зависит от тока, которым вы хотите управлять. BD139/BD140 рассчитаны на (по крайней мере, в оригинальном техпаспорте Philips) 80 В Vceo и 100 В Vcbo/Vcer. Не все производители придерживаются Vcer на 100 В, но в принципе вы сможете использовать BD139/BD140 при мощности до 70 Вт с шин +/- 45 В. Обычно они имеют коэффициент усиления по току 100 при 150 мА и минимум 63 (первоначально 40) и хорошо работают до 250 мА, поэтому являются хорошими драйверами для 2N3055/MJ29.55 пар.
BD139/BD140 рассчитаны на (по крайней мере, в оригинальном техпаспорте Philips) 80 В Vceo и 100 В Vcbo/Vcer. Не все производители придерживаются Vcer на 100 В, но в принципе вы сможете использовать BD139/BD140 при мощности до 70 Вт с шин +/- 45 В. Обычно они имеют коэффициент усиления по току 100 при 150 мА и минимум 63 (первоначально 40) и хорошо работают до 250 мА, поэтому являются хорошими драйверами для 2N3055/MJ29.55 пар.
MJE340/350 в основном представляют собой высоковольтные транзисторы. У них низкое значение fT (около 20 МГц, но это не указано в технических характеристиках) и плохая работа по току (обычно номинальный ток составляет 50 мА). Так что это зависит от того, для чего вы хотите их использовать. Почему бы не использовать 2SC4793/2SA1837 в качестве достойного высоковольтного драйвера? Они представляют собой высоковольтные высокочастотные драйверы и хорошо работают при токе более 200 мА, поэтому они являются хорошим расширением BD139/BD140 для более высоких мощностей, чем 70 Вт (т. е. 100 Вт и более).
е. 100 Вт и более).
Найджелрайт7557
Участник
#9
#9
арту сказал:
Я сделал это один раз и получил осцилляцию
Ура
Нажмите, чтобы развернуть…
При использовании в VAS требуется конденсатор от c до b. Я нашел 220pf хорошим компромиссом.
Я нашел 220pf хорошим компромиссом.
Один и тот же конденсатор требуется от c до b, если он используется в качестве квазинизкого драйвера.
CBS240
Участник
#10
#10
Катияр сказал:
Схема усилителя NMOS200 использует BD139/BD140, тогда как схема усилителя NMOS350 с более высоким напряжением использует MJE340/MJE350.
Нажмите, чтобы развернуть…
Это не имеет значения. Каково назначение устройств в цепи? Здесь вы должны определить рабочую область транзистора и, следовательно, подойдет он или нет. Другие вещи также могут иметь значение, Ccb и пара других параметров… а может и нет.
грейрасул
Участник
#11
#11
бд139 лучше
Ян Финч
Участник
#12
#12
greierasul сказал:
bd139 лучше
Нажмите, чтобы развернуть…
Чем лучше? Вы предполагаете, что BD139 лучше в более мощном усилителе NMOS200? как спрашивает катияр? Думали ли вы, что 80-вольтовый транзистор может выйти из строя в качестве VAS или буфера при вероятном более высоком напряжении на шине? В конце концов, будут простые причины использовать другой транзистор для версии с большей мощностью, но давайте хотя бы иметь схему или ссылку на нее на этом форуме, чтобы делать оценки.
Если вы предлагаете BD139 лучше просто усилителя меньшей мощности, то вполне может быть и так, но вопрос не в этом, как я читал. Есть лучшие транзисторы для обоих размеров или приложений. Учитывая, что BD139существует уже как минимум 40 лет, можно ожидать каких-то изменений, не так ли?
Последнее редактирование:
домашний моддер
Отключенная учетная запись
№13
№13
Ян Финч сказал:
Учитывая, что BD139существует уже как минимум 40 лет, можно ожидать каких-то изменений, не так ли?
Нажмите, чтобы развернуть…
Хотя это старый рабочий инструмент, на самом деле это отличный транзистор во всех отношениях, учитывая его SOA.
Эта пара представляет собой не что иное, как bc639/640 в корпусе TO126 для большей рассеиваемой мощности. Если вы посмотрите таблицы данных для bc639, вы обнаружите, что это очень мощная деталь. Из-за смены на корпус ТО126 початок будет чуть хуже, чем на ТО92, так что ожидайте около 12-15 пф. Как драйверы для выходного каскада, работающие в заданных пределах, они превосходны, мало кто может сравниться с ними по производительности.
Ян Финч
Участник
№14
№14
Можно было бы добавить еще пару переупаковок для старого доброго BD139/40 на протяжении многих лет тоже. Я считаю, что форма TO126 была первой на несколько лет, так как форма TO92 не фигурирует в моем каталоге 1973 года. Конечно, он был где-то рядом, и он дешев и доступен везде, но я все еще хочу знать, как его будет использовать усилитель MOSFET мощностью 200 Вт / 8 Ом.
Почему-то я так не думаю, ни в VAS, ни, скажем, в роли буфера, а вы?
домашний моддер
Отключенная учетная запись
№15
№15
Ян Финч сказал:
Вы могли бы добавить еще пару переупаковок для старых верных BD139/40 за эти годы.
Я считаю, что форма TO126 была первой на несколько лет, так как форма TO92 не фигурирует в моем каталоге 1973 года. Конечно, он был где-то рядом, и он дешев и доступен везде, но я все еще хочу знать, как его будет использовать усилитель MOSFET мощностью 200 Вт / 8 Ом.
Почему-то я так не думаю ни в VAS, ни, скажем, в роли буфера, а вы?
Нажмите, чтобы развернуть…
Может быть, T0126 появился первым, хотя я сомневаюсь, что техник сервисного отдела Philips, который дал мне эту информацию, упомянул бы об этом, так как мне также было любопытно узнать об этой части, но это не имеет значения, важно то, что вы можете Получите все параметры таблицы данных от bc639, такие как цифры ft и cob, и это очень хорошая часть. Хороший вопрос заключается в том, придерживаются ли современные производители, такие как onsemi, SIT и т. д., спецификации относительно оригиналов, поскольку пока я вижу, что все они просто копируют таблицы данных друг у друга.
Должен согласиться, что я не вижу для него места в усилителе мощностью 200 Вт.
грейрасул
Участник
№16
№16
Mje340 имеет ft=10Mhz, а mje350 имеет ft=4Mhz. Это не слишком хорошо для фазового сдвига усилителя
.
мегаймир
Участник
# 17
# 17
Любые мысли о паре MJE253/243? В положении водителя или VAS…
домашний моддер
Отключенная учетная запись
# 18
# 18
мегаймир сказал:
Любые мысли о паре MJE253/243? В положении водителя или VAS…
Нажмите, чтобы развернуть…
Они хороши для водителя, для оптимальной производительности вам следует обратить внимание на высоковольтные низковольтные типы, такие как 2sc1380, 2sc1381, 2sc1209.
Ян Финч
Участник
# 19
# 19
ПОИСК
На главной странице есть кнопка поиска, которая позволяет вам найти темы, полные сообщений о подходящих транзисторах для всего, что связано с аудио. Почему бы не использовать их и не узнать немного по пути? Просто введите транзистор VAS (например), выберите «показать темы» и прочитайте. — просто.
Если вы пытаетесь найти подходящие типы в вашем регионе, которые могут не быть перечислены здесь, рассмотрите транзисторы драйвера ЭЛТ-телевизора. Из них получаются отличные VAS-транзисторы, а некоторые из них могут даже иметь достаточный пиковый ток в качестве драйверов MOSFET, поскольку они не требуют больших токов, которые требуются для биполярных транзисторов. 2SC3503/A1381 являются хорошими примерами, как и BF469./70.
Примечание: как написал Homemodder, низкий Cob, высокое напряжение и Ft.
мегаймир
Участник
#20
#20
Это была небольшая рекомендация, мой друг. Это Cob действительно немного высок. Во всяком случае, я использовал его в качестве драйвера в паре Шиклаи. Пробовал сравнивать с BD139/140, я не мог услышать/померить разницу.
Последнее редактирование:
Транзистор
%20tip%20350 спецификация и примечания по применению
РОМ Полупроводник
РОМ Полупроводник
РОМ Полупроводник
РОМ Полупроводник
РОМ Полупроводник
РОМ Полупроводник
транзистор%20tip%20350 Листы данных Context Search
| Лист данных по каталогу | MFG и тип | ПДФ | Теги документов |
|---|---|---|---|
хб*9Д5Н20П Реферат: khb9d0n90n 6v стабилитрон khb * 2D0N60P транзистор KHB7D0N65F BC557 транзистор kia * 278R33PI KHB9Схема Д0Н90Н на транзисторе ктд998 | Оригинал | 2N2904E до н.э.859 КДС135С 2N2906E до н.э.860 KAC3301QN КДС160 2Н3904 BCV71 KDB2151E хб*9Д5Н20П хб9д0н90н 6В стабилитрон хб*2Д0Н60П транзистор КХБ7Д0Н65Ф Транзистор BC557 киа*278R33PI Схема КХБ9Д0Н90Н транзистор ктд998 | |
КИА78*ПИ Реферат: Транзистор KIA78*p TRANSISTOR 2N3904 хб*9D5N20P хб9д0н90н KID65004AF TRANSISTOR mosfet хб*2D0N60P KIA7812API | Оригинал | 2N2904E до н.э.859 КДС135С 2N2906E до н.э.860 KAC3301QN КДС160 2Н3904 BCV71 KDB2151E КИА78*пи транзистор КИА78*р ТРАНЗИСТОР 2N3904 хб*9Д5Н20П хб9д0н90н КИД65004AF ТРАНЗИСТОР MOSFET хб*2Д0Н60П KIA7812API | |
2SC4793 2sa1837 Реферат: 2sC5200, 2SA1943, 2sc5198 2sC5200, 2SA1943 транзистор 2SA2060 силовой транзистор npn к-220 транзистор 2SC5359Транзистор 2SC5171, эквивалентный 2sc5198, эквивалентный транзистору NPN | Оригинал | 2SA2058 2SA1160 2SC2500 2SA1430 2SC3670 2SA1314 2SC2982 2SC5755 2SA2066 2SC5785 2SC4793 2sa1837 2СК5200, 2СА1943, 2СК5198 2sC5200, 2SA1943 транзистор 2SA2060 силовой транзистор npn к-220 транзистор 2SC5359 эквивалент транзистора 2SC5171 эквивалент 2sc5198 НПН-транзистор | |
транзистор Реферат: транзистор ITT BC548 pnp транзистор транзистор pnp BC337 pnp транзистор BC327 NPN транзистор pnp bc547 транзистор MPSA92 168 транзистор 206 2n3904 транзистор PNP | OCR-сканирование | 2Н3904 2Н3906 2Н4124 2Н4126 2N7000 2Н7002 до н.  э.327 э.327до н.э.328 до н.э.337 до н.э.338 транзистор транзистор ИТТ BC548 п-н-п транзистор транзистор п-н-п BC337 п-н-п транзистор BC327 NPN-транзистор pnp bc547 транзистор MPSA92 168 транзистор 206 2н3904 ТРАНЗИСТОР PNP | |
Ч520Г2 Реферат: Ч520Г2-30ПТ транзистор цифровой 47к 22к ПНП НПН ФБПТ-523 транзистор npn переключающий транзистор 60в Ч521Г2-30ПТ Р2-47К транзистор цифровой 47к 22к 500мА 100мА Ч4904Т1ПТ | Оригинал | А1100) QFN200 ЧДТА143ЕТ1ПТ ФБПТ-523 100 мА ЧДТА143ЗТ1ПТ ЧДТА144ТТ1ПТ CH520G2 Ч520Г2-30ПТ транзистор цифровой 47k 22k PNP NPN ФБПТ-523 транзистор npn-переключающий транзистор 60 В Ч521Г2-30ПТ Р2-47К транзистор цифровой 47к 22к 500мА 100мА Ч4904T1PT | |
транзистор 45 f 122 Реферат: Транзистор AC 51 mos 3021 TRIAC 136 634 транзистор tlp 122 ТРАНЗИСТОР транзистор ac 127 транзистор 502 транзистор f 421 | OCR-сканирование | TLP120 TLP121 TLP130 TLP131 TLP160J транзистор 45 ф 122 Транзистор переменного тока 51 Моск 3021 СИМИСТОР 136 634 транзистор тлп 122 ТРАНЗИСТОР транзистор переменного тока 127 транзистор 502 транзистор ф 421 | |
СТХ12С Реферат: SLA4038 fn651 SLA4037 sla1004 CTB-34D SAP17N 2SC5586 2SK1343 CTPG2F | Оригинал | 2SA744 2SA745 2SA746 2SA747 2SA764 2SA765 2SA768 2SA769 2SA770 2SA771 CTX12S SLA4038 фн651 SLA4037 sla1004 СТВ-34Д SAP17N 2SC5586 2SK1343 CTPG2F | |
Варистор RU Реферат: Транзистор SE110N 2SC5487 SE090N 2SA2003 высоковольтный транзистор 2SC5586 SE090 RBV-406 | Оригинал | 2SA1186 2SA1215 2SA1216 2SA1262 2SA1294 2SA1295 2SA1303 2SA1386 2SA1386A 2SA1488 Варистор RU SE110N транзистор 2SC5487 SE090N 2SA2003 высоковольтный транзистор 2SC5586 SE090 РБВ-406 | |
Q2N4401 Резюме: D1N3940 Q2N2907A D1N1190 Q2SC1815 Q2N3055 D1N750 Q2N1132 D02CZ10 D1N751 | Оригинал | РД91ЭБ Q2N4401 Д1Н3940 Q2N2907A Д1Н1190 Q2SC1815 Q2N3055 Д1Н750 Q2N1132 D02CZ10 Д1Н751 | |
фн651 Реферат: CTB-34D 2SC5586 hvr-1×7 STR20012 sap17n 2sd2619 RBV-4156B SLA4037 2sk1343 | Оригинал | 2SA744 2SA745 2SA746 2SA747 2SA764 2SA765 2SA768 2SA769 2SA770 2SA771 фн651 СТВ-34Д 2SC5586 ХВР-1х7 STR20012 sap17n 2сд2619РБВ-4156Б SLA4037 2ск1343 | |
2SC5471 Аннотация: 2SC5853 2sa1015 транзистор 2sc1815 транзистор 2SA970 транзистор 2SC5854 транзистор 2sc1815 2Sc5720 транзистор 2SC5766 низкочастотный малошумящий транзистор PNP | Оригинал | 2SC1815 2SA1015 2SC2458 2SA1048 2SC2240 2SA970 2SC2459 2SA1049 А1587 2SC4117 2SC5471 2SC5853 транзистор 2са1015 транзистор 2sc1815 2SA970 транзистор 2SC5854 транзистор 2sc1815 Транзистор 2Sc5720 2SC5766 Низкочастотный малошумящий транзистор PNP | |
МОП-транзистор FTR 03-E Реферат: mt 1389 fe 2SD122 dtc144gs малошумящий транзистор Дарлингтона V/65e9 транзистор 2SC337 MOSFET FTR 03 транзистор DTC143EF | OCR-сканирование | 2SK1976 2SK2095 2SK2176 О-220ФП 2SA785 2SA790 2SA790M 2SA806 Мосфет FTR 03-E мт 1389фе 2СД122 dtc144gs малошумящий транзистор Дарлингтона Транзистор V/65e9 2SC337 мосфет фтр 03 транзистор DTC143EF | |
фгт313 Реферат: транзистор fgt313 SLA4052 RG-2A диод SLA5222 fgt412 RBV-3006 FMN-1106S SLA5096 диод ry2a | Оригинал | 2SA1186 2SC4024 2SA1215 2SC4131 2SA1216 2SC4138 100 В переменного тока 2SA1294 2SC4140 фгт313 транзистор фгт313 SLA4052 Диод РГ-2А SLA5222 фгт412 РБВ-3006 ФМН-1106С SLA5096 диод ry2a | |
транзистор 91 330 Реферат: ТРАНЗИСТОР tlp 122 R358 TLP635F 388 транзистор 395 транзистор транзистор f 421 IC 4N25 симистор 40 RIA 120 | OCR-сканирование | 4Н25А 4Н29А 4Н32А 6Н135 6Н136 6Н137 6Н138 6Н139 CNY17-L CNY17-M транзистор 91 330 ТРАНЗИСТОР тлп 122 Р358 TLP635F 388 транзистор 395 транзистор транзистор ф 421 IC 4N25 симистор 40 РИА 120 | |
1999 — Системы горизонтального отклонения телевизора Резюме: РУКОВОДСТВО ПО ЗАМЕНЕ ТРАНЗИСТОРА an363 TV горизонтальные системы отклонения 25 транзистор горизонтальной секции tv Горизонтальное отклонение Коммутационные транзисторы TV горизонтальные системы отклонения MOSFET горизонтальная секция в ЭЛТ-телевизоре ЭЛТ-телевизор электронная пушка ТВ трансформатор обратного хода | Оригинал | 16 кГц 32 кГц, 64 кГц, 100 кГц.  Системы горизонтального отклонения телевизора РУКОВОДСТВО ПО ЗАМЕНЕ ТРАНЗИСТОРА Ан363 Системы горизонтального отклонения телевизора 25 транзистор горизонтальной секции телевизор Переключающие транзисторы с горизонтальным отклонением Мосфет системы горизонтального отклонения телевизора горизонтальная секция в ЭЛТ-телевизоре ЭЛТ ТВ электронная пушка Обратный трансформатор для телевизора | |
транзистор Реферат: силовой транзистор npn to-220, транзистор PNP PNP POWER TRANSISTOR TO220, демпферный диод, транзистор Дарлингтона, силовой транзистор 2SD2206A, npn, транзистор Дарлингтона TO220 | Оригинал | 2СД1160 2СД1140 2СД1224 2СД1508 2SD1631 2SD1784 2СД2481 2SB907 2СД1222 2СД1412А транзистор силовой транзистор npn к-220 транзистор PNP СИЛОВОЙ ТРАНЗИСТОР PNP TO220 демпферный диод Транзистор Дарлингтона силовой транзистор 2СД2206А нпн дарлингтон транзистор ТО220 | |
1999 — транзистор Реферат: POWER MOS FET 2sj 2sk транзистор 2sk 2SK тип Низкочастотный силовой транзистор n-канальный массив полевых транзисторов high hfe транзистор ТРАНЗИСТОР P 3 транзистор mp40 список | Оригинал | X13769XJ2V0CD00 О-126) МП-25 О-220) МП-40 МП-45 МП-45Ф О-220 МП-80 МП-10 транзистор МОЩНЫЙ МОП-транзистор FET 2sj 2sk транзистор 2ск тип 2СК Силовой низкочастотный транзистор n-канальный полевой массив высокочастотный транзистор ТРАНЗИСТОР Р 3 транзистор мп40 список | |
транзистор 835 Реферат: Усилитель на транзисторе BC548 ТРАНЗИСТОР регулятор АУДИО Усилитель на транзисторе BC548 транзистор 81 110 Вт 85 транзистор 81 110 Вт 63 транзистор транзистор 438 транзистор 649 ТРАНЗИСТОР РУКОВОДСТВО | OCR-сканирование | БК327; БК327А; до н.  э.328 э.328БК337; БК337А; до н.э.338 до н.э.546; до н.э.547; до н.э.548 до н.э.556; транзистор 835 Усилитель на транзисторе BC548 ТРАНЗИСТОРНЫЙ регулятор Усилитель ЗВУКА на транзисторе BC548 транзистор 81 110 Вт 85 транзистор 81 110 Вт 63 транзистор транзистор 438 транзистор 649ТРАНЗИСТОР РУКОВОДСТВО | |
2002 — SE012 Реферат: sta474a SE140N диод SE115N 2SC5487 SE090 sanken SE140N STA474 UX-F5B | Оригинал | 2SA1186 2SA1215 2SA1216 2SA1262 2SA1294 2SA1295 2SA1303 2SA1386 2SA1386A 2SA1488 SE012 sta474a SE140N диод SE115N 2SC5487 SE090 Санкен SE140N СТА474 UX-F5B | |
2SC5586 Реферат: транзистор 2SC5586 диод RU 3AM 2SA2003 диод СВЧ 2SC5487 однофазный мостовой выпрямитель IC с выходом 1A RG-2A диод Dual MOSFET 606 2sc5287 | Оригинал | 2SA1186 2SA1215 2SA1216 2SA1262 2SA1294 2SA1295 2SA1303 2SA1386 2SA1386A 2SA1488 2SC5586 транзистор 2SC5586 диод РУ 3АМ 2SA2003 диод для микроволновой печи 2SC5487 однофазный мостовой выпрямитель IC с выходом 1A Диод РГ-2А Двойной МОП-транзистор 606 2sc5287 | |
PWM ИНВЕРТОРНЫЙ сварочный аппарат Резюме: KD224510 250A транзистор Дарлингтона Kd224515 демпфирующий конденсатор powerex инвертор сварочный контур KD221K75 kd2245 kd224510 примечание по применению транзистор | OCR-сканирование | ||
варикап диоды Реферат: БИПОЛЯРНЫЙ ТРАНЗИСТОР Модуль gsm с микроконтроллером p-канальный MOSFET Hitachi SAW Фильтр с двойным затвором MOSFET в усилителе УКВ Транзисторы mosfet p-channel Mosfet-транзистор Hitachi VHF FET LNA Низкочастотный силовой транзистор | OCR-сканирование | PF0032 PF0040 PF0042 ПФ0045А PF0065 ПФ0065А HWCA602 HWCB602 ХВКА606 HWCB606 варикапные диоды БИПОЛЯРНЫЙ ТРАНЗИСТОР gsm модуль с микроконтроллером p-канальный мосфет Хитачи ПАВ Фильтр МОП-транзистор с двойным затвором в усилителе УКВ Транзисторы mosfet p канал МОП-транзистор хитачи УКВ Фет лна Силовой низкочастотный транзистор | |
Транзистор мощности телевизора, техническое описание Реферат: силовой транзистор 2SD2599 эквивалент 2SC5411 транзистор 2sd2499 2Sc5858 эквивалент транзистор 2SC5387 2SC5570 компоненты в горизонтальном выходе | Оригинал | 2SC5280 2SC5339 2SC5386 2SC5387 2SC5404 2SC5411 2SC5421 2SC5422 2SC5445 2SC5446 Технический паспорт силового транзистора телевизора силовой транзистор Эквивалент 2SD2599 транзистор 2sd2499 эквивалент 2Sc5858 транзистор 2SC5570 компоненты в горизонтальном выводе | |
2009 — 2sc3052ef Реферат: 2n2222a SOT23 ТРАНЗИСТОР SMD МАРКИРОВКА КОД s2a 1N4148 SMD LL-34 ТРАНЗИСТОР SMD КОД ПАКЕТ SOT23 2n2222 sot23 ТРАНЗИСТОР S1A 64 smd 1N4148 SOD323 полупроводниковый перекрестный справочник toshiba smd код маркировки транзистора | Оригинал | 24 ГГц BF517 Б132-Х8248-Г5-С-7600 2sc3052ef 2н2222а СОТ23 КОД МАРКИРОВКИ SMD ТРАНЗИСТОРА s2a 1Н4148 СМД ЛЛ-34 ТРАНЗИСТОР SMD КОД ПАКЕТ SOT23 2н2222 сот23 ТРАНЗИСТОР S1A 64 смд 1N4148 СОД323 полупроводниковая перекрестная ссылка toshiba smd маркировка код транзистора | |
2007-DDA114TH Резюме: DCX114EH DDC114TH | Оригинал | DCS/PCN-1077 ОТ-563 150 МВт 22кОм 47кОм DDA114TH DCX114EH DDC114TH | |
Предыдущий
1
2
3
…
23
24
25
Следующий
MJE350 Цена — MJE350 в наличии
Продажи: 24
113199
5,0 из 5 звезд
1 звезда
0,2%
2 звезды
0%
3 звезды
0,2%
4 звезды
0,4%
5 звезд
99,1%
Всего продуктов: 2399931
Всего продаж: 10033604
Среднее время выполнения заказа: 0 часов
Сроки доставки (Экспресс): 0
Время доставки (Почтовое отделение): 0
Любимый
ИСПОЛЬЗОВАЛ
Бывшие в употреблении детали, сертифицированные Utsource
Бывшие в употреблении детали, сертифицированные Utsource, предоставляют следующие гарантии:
1. Utsource проверит товары, включая проверку внешнего вида (без серьезных повреждений внешнего вида), выберет квалифицированных и честных поставщиков и обеспечит 98% квалификационная ставка.
Utsource проверит товары, включая проверку внешнего вида (без серьезных повреждений внешнего вида), выберет квалифицированных и честных поставщиков и обеспечит 98% квалификационная ставка.
2. Некоторые детали проходят машинное тестирование.
3. Детали, сертифицированные Utsource, могут быть безоговорочно возвращены и возмещены в течение 60 дней.
Дополнительные кремниевые силовые транзисторы
Не найдено, рекомендуется аналогичное техническое описание
Все названия продуктов, товарные знаки, бренды и логотипы, используемые на этом сайте, являются собственностью соответствующих владельцев. Изображение, описание или продажа продуктов с этими названиями, товарными знаками, брендами и логотипами предназначены только для целей идентификации и не предназначены для указания на какую-либо принадлежность или разрешение какого-либо правообладателя.
Атрибуты продукта
Не найдены, аналогично рекомендуется
● SGS -Thomson Preferred Salestypes
● Дополнительные приложения
.
MJE340 представляет собой кремниевый эпитаксиальный планарный NPN-транзистор, предназначенный для использования в линейных и импульсных устройствах средней мощности. Он установлен в SOT-32.
Дополнительный тип PNP — MJE350.
Отзывы о товаре
Представлять на рассмотрение
1358 отзывов покупателей из США
VE366236 PEDRO PENUELA
МУР1540
Соединенные Штаты
Майами
Длина регистрации: 9 лет
0
0
Ответ 0
12/15/2021
Julio Cesar Mendoza
Julio Cesar Mendoza
.0003
IRG71C28U
Соединенные Штаты
доральный
Длина регистрации: 5 лет
0
0
Ответ 0
12/0121
HANCOCK
4.
ДМ74Л04Н
Соединенные Штаты
Сент-Хеленс
Срок регистрации:3 года
0
0
Ответ 0
9 29.11.2021
0003
IRFP9140NPBF IRFP9140 TO-247 П КАНАЛ 100В 23А
Соединенные Штаты
Майами
Длина регистрации: 1 Годы
0
0
Ответ 0
11/27/2021
Morales/Раздел 81468
.
АН28Ф512-120
Соединенные Штаты
ДОРАЛЬ
Срок регистрации: 1 год
0
0
Ответ 0
25.11.2021
Роберт Лэмб
CY7C028V-20AXI
Соединенные Штаты
Портленд
Продолжительность регистрации: 2 года
0
0
Ответ 0
11/23/2021
John Kohls
.
АТ89С52-24Ю
Соединенные Штаты
Чистая вода
Срок регистрации: 3 года
0
0
Ответ 0
04.11.2021
Мэтью Гарнер
MC33074P
Соединенные Штаты
Форт-Уолтон-Бич
Длина регистрации: 3 года
0
0
Ответ 0
09/01/2021
MAURICIO GALVEZ VE17343
MAURICIO GALVEZ VE17343
.
W25Q32FVSIG
Соединенные Штаты
Майами
Срок регистрации: 4 года
0
0
Ответить 0
29.08.2021
Томас Д. А. Лессандро
А. Лессандро
IM481H
Соединенные Штаты
Майн Хилл
Длина регистрации: 5 лет
0
0
Ответ 0
08/19/2021
. Способ оплаты для Азии
Способ оплаты для Америки
Международный способ оплаты
Процесс покупки
Путеводитель по покупкам
Связанный поиск
Связанный поставщик
Альтернативные названия
Путеводитель по магазинам
Связанный поиск
- Цена MJE350
- MJE350 PDF
- MJE350 Трудно найти
- MJE350 Распиновка
- MJE350 Устаревший
- MJE350 Изображение
- MJE350 Купить
- MJE350 Изображение
- MJE350 Продать
- MJE350 В наличии
- MJE350 Поиск
- Распределитель MJE350
- MJE350 Технический паспорт
- MJE350 Новый и оригинальный
- Приложение MJE350
- Серия MJE350
- MJE350 Замена
- MJE350 TI (ярмарка/двигатель/вкл.
 )
) - MJE350 найти
- MJE350 покупка
- MJE350 нужно
- MJE350 для покупок
- Магазин MJE350
- MJE350 Дешевые
- MJE350 транзистор
- MJE350 эквивалент
- Электронный компонент MJE350
- MJE350 Дополнительные кремниевые силовые транзисторы
Соответствующий поставщик
Альтернативные названия
MJE350
MJE350 имеет несколько брендов по всему миру, которые могут иметь альтернативные названия для MJE350 из-за региональных различий или приобретения. MJE350 также может быть известен под следующими именами:
ВАРИАНТЫ ПОКУПКИ
Статус на складе: 209874
Минимум: 16
Добавить в корзину
Общая цена:
Цена за единицу:0,20692
- ≥1:
0,20692 доллара США
0,18623 доллара США - ≥10:
0,14780 долларов США
0,13302 доллара США - ≥50:
0,11824 доллара США
0,10642 доллара США - ≥100:
0,10642 доллара США
0,09578 долларов США - ≥150:
0,10050 долларов США
0,09045 долларов США - ≥200:
0,09755 долларов США
0,08779 долларов США - ≥500:
0,09637 долларов США
0,08673 долл. США
США - ≥1000:
0,09518 долларов США
0,08566 долларов США - ≥3000:
0,09459 долларов США
0,08513 долларов США
Подробнее:
Расследование
Сравнение цен
UTSOURCE Official
Расчет фрахта
Страна:
- ДЕРЖАТЕЛЬ
Стоимость доставки
Время в пути - 0,00
3-5 дней - 0,00
3-5 дней - 0,00
3-5 дней - 7,99
8-12 дней 0,00
5-8 дней0,00
6-10 дней0,00
6-10 дней0,00
8-10 дней0,00
15-20 дней0,00
10-15 дней0,00
15-18 дней0,00
8-10 дней0,00
7-10 дней0,00
10-12 дней0,00
3-5 дней0,00
2-3 дня- 0,00
7-10 дней - 0,00
7-10 дней
Экспресс: (FEDEX, UPS, DHL, TNT) Бесплатная доставка первых 0,5 кг для заказов на сумму более 200 $, превышение веса оплачивается отдельно.
Выставочные мероприятия UtsourceGlobal
Почему стоит выбрать UTSOURCE для покупки электронных компонентов?
Цена
Цена продукта: Более конкурентоспособная по сравнению с другими платформами
Доставка
Логистика: основные страны мира, 2-5 дней
Несколько товаров
Покупка с несколькими номерами: доставка в одном месте, оплата доставки один раз
Устаревший и специалист по остановке производства
Снятая с производства продукция: предоставление электронных компонентов, производство которых прекращено
Когда заказ будет отправлен?
Почему моя кредитная карта не может оплатить?
сколько стоит?
Когда заказ будет отправлен?
STM32L162RET6TR есть в наличии?
Что делать, если возникла проблема с отображением моей страницы?
JudyCustomer Manager
(888) 766 5577
+86 15302769052
+1 (312)899-4831
(только WhatsApp)
Ваша посвященный сервис, предоставленный вам сервис. в любое время.
в любое время.
7 продавцов Выбор
ДЗЯМЭН ЭЛЕКТРОНИКА
Цена: 0,44 доллара США
Xing Sheng Electronics Co., Ltd.
Цена: 0,20 доллара США
Кокей Электроникс Ко., Лтд.
Цена: 0,40 долл. США
TSD Electronics Co., Ltd.
Цена: 0,30 долл. США
Оригинальный магазин Utsource
Цена: 0,45 долл. США
Посмотреть все
Богатый ассортимент, вы можете найти все электронные компоненты основных мировых брендов
UTSOURCE — это глобальная платформа электронных компонентов. Мы можем предоставить продукты разных марок и разных кодов даты, особенно для устаревших и труднодоступных электронных компонентов. Мы предоставляем следующие бренды: Analog Devices (ADI) MAXIM, Texas Instruments (TI), Toshiba, Xilinx, Renesas, Eltek NSC, Altera, NXP, ON, LINEAR, ALLEGRO, Diodes Incorporated, Cypress Semiconductor, AVX, IDT, Intel, Nexperia, KEMET, FAIRCHILD, ROHM, Hongfa, TE, Autonics, Honeywell, Molex, Freescale, Panasonic, OMRON, Amphenol, Murata, ST, VISHAY, MICROCHIP, FLUKE, Dallas, Yageo, Broadcom и так далее.


 5 мА/В
5 мА/В 1 мА:
1 мА: 5 мА
5 мА 03 ÷ 0.07 пФ
03 ÷ 0.07 пФ .. +85°C
.. +85°C

 Ожидается, что вероятность отказа будет уменьшена при незначительной нагрузке, если мы поддерживаем достаточно высокое напряжение «сток–исток», вынуждая неосновные носители полностью рекомбинировать перед окончанием включенного состояния транзистора. Это может быть достигнуто путем добавления схемы исключения насыщения. На рис. 22 показано упрощенное схемное решение исключения насыщения транзистора.
Ожидается, что вероятность отказа будет уменьшена при незначительной нагрузке, если мы поддерживаем достаточно высокое напряжение «сток–исток», вынуждая неосновные носители полностью рекомбинировать перед окончанием включенного состояния транзистора. Это может быть достигнуто путем добавления схемы исключения насыщения. На рис. 22 показано упрощенное схемное решение исключения насыщения транзистора. SEM-900. 1993. Unitrode Corporation.
SEM-900. 1993. Unitrode Corporation.

 .9 пФ;
.9 пФ; Предельно допустимые значения указаны для тех же условий.
Предельно допустимые значения указаны для тех же условий. Часть №:
Часть №:
